2009年晶圆级封装趋势
专家认为,受持续增长的移动设备和汽车应用需求的驱动,晶圆级封装(WLP)将向I/O数更高和引脚节距更小的方向发展。2009年其他需要关注的WLP趋势还包括大功率和高精度精密器件、穿透硅通孔(TSV)、扇出和嵌入式闪存。
本文引用地址:https://www.eepw.com.cn/article/92518.htm日月光公司(ASE,中国台湾省台北)工程部主任JohnHunt说,在日月光WLP的总体比例仍然偏低,占封装业务不到10%。但对WLP的需求却在增加。“我们看到那些从未使用过这种技术的客户正在从旧的封装形式转变到WLP,”JohnHunt说。“他们的终端客户正在这么要求,因此这种业务量是不断增长的。”
由于对高I/O数小型封装的需求增加,Hunt说WLP将会逐渐地占据传统的球栅阵列封装和引线框架的市场份额。
WLP意味着大多数封装工艺步骤将在晶圆级上进行。它被认为是芯片倒装封装的子集,只是引脚节距和焊料球稍大。它与封装内倒装芯片或板上倒装芯片的主要区别在于,WLP能够通过标准的表面贴装技术贴装到低成本基板上,而不是需要像倒装芯片封装那样使用一个插入板。
不断增长的需求
Hunt说便携式设备是WLP的市场驱动力,WLP的优点在于尺寸、重量和电气性能。“我
们也注意到,由于汽车复杂性的增加,导致WLP在汽车应用中有所增长,”他说。“但是ASE和其他公司进行大规模量产的主要用于手持设备,比如移动电话、游戏机、PDA、照相机及其他消费者希望能放入兜里、轻易携带的设备。电性能频率越高,那么噪音越小、寄生效应越低,因此电池寿命更长点。我们都希望便携设备的电池电量能够持续更长时间。”
便携式系统驱动了对晶圆级封装的需求
封装业务咨询公司TechSearchInternational(德州奥斯丁)的总裁JanVardaman说,2009年WLP的热点将会是扇出型封装。“2009年,业内将会看到这些扇出型封装在移动电话中的首次商业应用,”她表示。越来越多的移动电话使用了卡西欧微电子(东京)的贴铜WLP技术。英飞凌(德国Neubiberg)开发了一项嵌入式晶圆级球栅阵列(eWLB)封装技术,也有望被一些公司采用,Vardaman说。
高I/O引脚数
WLP技术中对高I/O数量的需求正在增长。一两年前I/O数还在40-80的范围内,但现在测试中的I/O数已经攀升至192。Hunt透露,一些ASE的客户已经达到120或144,这正在成为一项真正的技术挑战。
“我们正在提升该技术的能力,”他说。“这要求我们改进聚合物系统,其原因是在再分布和再钝化过程中,聚合物充当了软垫。它消除了焊料球的部分应力,所以它的尺寸也相当关键。材料性质、金属成分和焊料合金的结构以及RDL和UBM的组装方式也十分重要。”
有必要做进一步的改进以使I/O数量达到200。这是产品实现量产的主要挑战。“越来越多的无线设备的I/O数目变得更高,”Hunt解释说。“越来越多的无线设备的I/O数目变得更高,”Hunt解释说。“将蓝牙、FM收音机、TV调谐器和GPS单元整合到一个单独的芯片中将大大增加I/O数量,这是I/O数量增大的主要驱动因素。并且在高I/O的情况下获得相当的可靠性,这也是一项巨大的技术挑战。”



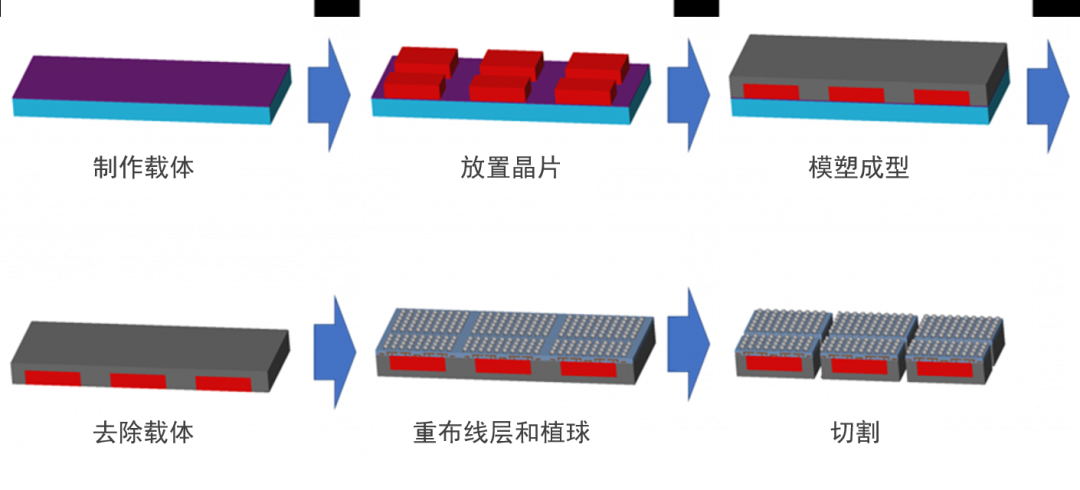

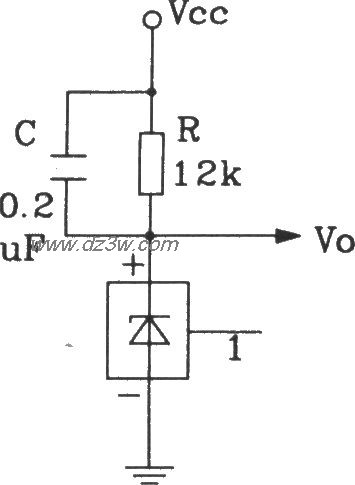
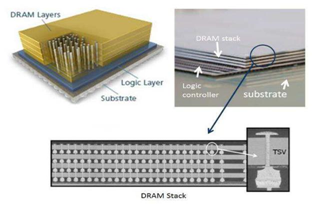



评论