- 随着从 HBM 到 3D 封装中的集成 RF、电源和 MEMS 等所有产品的需求不断增长,晶圆厂工具正在针对 TSV 工艺进行微调。
- 关键字:
TSV 封装

- 随着半导体行业的快速发展,先进封装技术成为了提升芯片性能和功能密度的关键。近年来,作为2.5D和3D封装技术之间的一种结合方案,3.5D封装技术逐渐走向前台。什么是3.5D封装技术3.5D封装技术最简单的理解就是3D+2.5D,通过将逻辑芯片堆叠并将它们分别粘合到其他组件共享的基板上,创造了一种新的架构。能够缩短信号传输的距离,大幅提升处理速度,这对于人工智能和大数据应用尤为重要。不过,既然有了全新的名称,必然要带有新的技术加持 —— 混合键和技术(Hybrid Bonding)。混合键合技术的应用为3.
- 关键字:
封装技术 TSV 中介层 3.5D
- 8月8日,江苏芯梦TSV先进封装研发中心揭牌仪式在中吴润金先进制造产业园举行。据江苏芯梦介绍,其TSV先进封装研发中心为江苏芯梦半导体设备有限公司打造,中心以水平式电化学沉积工艺为核心,以自主研发为导向,构建先进封装产业全工艺流程测试平台。该研发中心总面积1232.8㎡,拥有千级和百级两种测试洁净环境。配备自研生产的Xtrim-ECD
电镀设备及全套涂胶、曝光、显影、蚀刻等先进封装主流程工艺设备,可实现先进封装中RDL、Bumping、TSV等电镀工艺的打样测试;同时还配备了Xtrim-FC
- 关键字:
江苏芯梦 TSV 先进封装
- 前言从HBM存储器到3D NAND芯片,再到CoWoS,硬件市场上有许多芯片是用英文称为TSV构建的,TSV是首字母缩写,TSV(Through Silicon Via)中文为硅通孔技术。它是通过在芯片与芯片之间、晶圆和晶圆之间制作垂直导通;TSV技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互联,这项技术是目前唯一的垂直电互联技术,是实现3D先进封装的关键技术之一。在本文中,我们将告诉您它们是什么,它们如何工作以及它们的用途。在2000年的第一个月,Santa Clara Universi
- 关键字:
芯片 TSV HBM NAND 先进封装
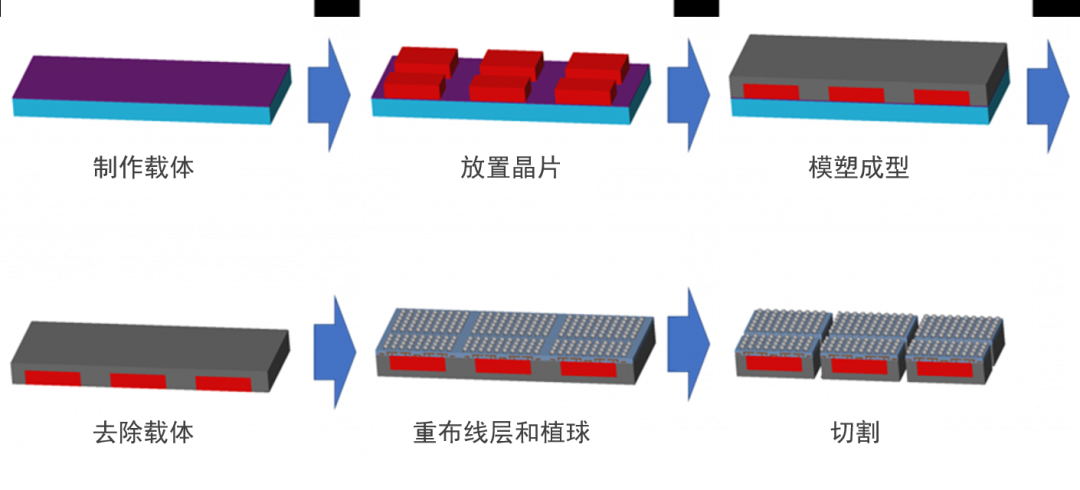
- 芯片封装早已不再仅限于传统意义上为独立芯片提供保护和I/O扩展接口,如今有越来越多的封装技术能够实现多种不同芯片之间的互联。先进封装工艺能提高器件密度并由此减小空间占用,这一点对于手机和自动驾驶汽车等电子设备的功能叠加来说至关重要。芯片封装行业的发展使国际电气电子工程师协会电子元件封装和生产技术学会(IEEE-CPMT)意识到必须要拓展自身的技术范畴,并于2017年正式更名为国际电气电子工程师协会电子封装学会(IEEE- EPS)。有一种先进封装技术被称为“晶圆级封装”(WLP),即直接在晶圆上完成集成电
- 关键字:
TSV WLP
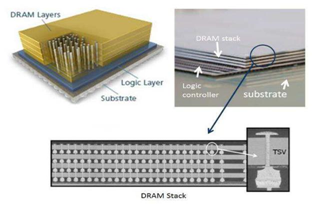
- 摘要从低密度的后通孔TSV 硅3D集成技术,到高密度的引线混合键合或3D VSLI CoolCubeTM解决方案,研究人员发现许多开发新产品的机会。本文概述了当前新兴的硅3D集成技术,讨论了图像传感器、光子器件、MEMS、Wide I/O存储器和布局先进逻辑电路的硅中介层,围绕3D平台性能评估,重点介绍硅3D封装的主要挑战和技术发展。硅的 3D应用机会从最初为图像传感器设计的硅2.5D集成技术[1],到复杂的高密度的高性能3D系统,硅3D集成是在同一芯片上集成所有功能的系统芯片(SoC)之外的另一种支持各
- 关键字:
TSV 硅3D
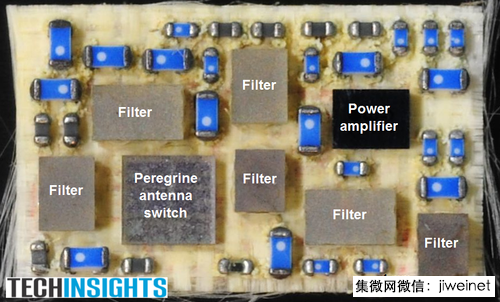
- 新兴封装技术的出现,主要的驱动力量就来自于永无止境地追求更轻薄短小的智慧型手机。
- 关键字:
封装 TSV
- 日前,Alchimer, SA 宣布与法国研究机构CEA-Leti 达成协作合约,以评估和实施Alchimer为300mm 大批量生产的湿式沉积工艺。该专案将为隔离层、阻挡层和晶种层评估Alchimer 的Electrografting (eG™) 和Chemicalgrafting (cG™) 制程。
- 关键字:
Alchimer 3D TSV
- 市调机构Yole Developpement稍早前发布了一份针对3DIC与矽穿孔 ( TSV )的调查报告,指出过去一年来,所有使用TSV封装的3DIC或3D-WLCSP平台(包括CMOS影像感测器、环境光感测器、功率放大器、射频和惯性MEMS元件)等产品产值约为27亿美元,而到了2017年,该数字还可望成长到400亿美元,占总半导体市场的9%。
Yole Developpement的先进封装部市场暨技术分析师Lionel Cadix 指出,3DIC通常使用TSV 技术来堆叠记忆体和逻辑IC,预
- 关键字:
半导体 3D TSV

- 单片型3D芯片集成技术与TSV的研究,尽管晶体管的延迟时间会随着晶体管沟道长度尺寸的缩小而缩短,但与此同时互联电路部分的延迟则会提升。举例而言,90nm制程晶体管的延迟时间大约在 1.6ps左右,而此时互联电路中每1mm长度尺寸的互联线路,其延迟时间会
- 关键字:
TSV 研究 技术 集成 3D 芯片 单片
- 3D-IC设计者希望制作出高深宽比(HAR>10:1)硅通孔(TSV),从而设计出更小尺寸的通孔,以减小TSV通孔群在硅片上的占用空间,最终改进信号的完整性。事实上,当前传统的TSV生产供应链已落后于ITRS对其的预测。以干法和湿
- 关键字:
TSV 电接枝 助力
- 通孔硅技术(TSV)代工厂商Allvia购买了位于Hillsboro Ore的一处制造工厂。
该工厂将用于基于TSV技术产品的量产。该厂房拥有178000平方英尺的大楼,60000平方英尺的净化间,并将扩展至80000片平方英尺。
该公司预计该工厂于2010年投入运营。
- 关键字:
Allvia TSV
- 经国家发改委批准,以国内集成电路封测领军企业江苏长电科技股份公司为依托,联合中科院微电子研究所、清华大学微电子所、深圳微电子所、深南电路有限公司等五家机构,共同组建的中国首家“高密度集成电路封装技术国家工程实验室”日前在位于无锡江阴的长电科技挂牌,标志着国家重点扶持的集成电路封装技术产学研相结合的工程实验平台正式启动。
近年来,国内外集成电路( IC)市场的需求不断上升,产业规模发展迅速, IC产业已成为国民经济发展的关键。旺盛的封测市场需求给国内的封测企业带来了良好的发
- 关键字:
集成电路 WLCSP SiP 封测 IC封装 FCBGA TSV MIS
tsv介绍
TSV TSV的英文全拼是“Through Silicon Vias”,中文意思为“通过硅片通道”。
英特尔公司首席技术官贾斯廷·拉特纳表示,TSV技术是英特尔公司的工程师首先为未来的80核处理器产品开发的。这项技术的实质,是每一个处理内核通过一个TSV通道直接连接一颗256KB的内存芯片(充当了缓存),随着缓存数量的增加,这些缓存将可以替代另外的内存芯片。
拉特纳指出,虽然TSV技 [
查看详细 ]
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473