LED芯片寿命试验的重要性
LED具有体积小,耗电量低、长寿命环保等优点,在实际生产研发过程中,需要通过寿命试验对LED芯片的可靠性水平进行*价,并通过质量反馈来提高LED芯片的可靠性水平,以保证LED芯片质量。
本文引用地址:https://www.eepw.com.cn/article/167820.htm
1、引言
作为电子元器件,发光二极管(Light Emitting Diode-led)已出现40多年,但长久以来,受到发光效率和亮度的限制,仅为指示灯所采用,直到上世纪末突破了技术瓶颈,生产出高亮度高效率的 LED和兰光LED,使其应用范围扩展到信号灯、城市夜景工程、全彩屏等,提供了作为照明光源的可能性。随着LED应用范围的加大,提高LED可靠性具有更加重要的意义。LED具有高可靠性和长寿命的优点,在实际生产研发过程中,需要通过寿命试验对LED芯片的可靠性水平进行*价,并通过质量反馈来提高 LED芯片的可靠性水平,以保证LED芯片质量,为此在实现全色系LED产业化的同时,开发了LED芯片寿命试验的条件、方法、手段和装置等,以提高寿命试验的科学性和结果的准确性。
2、寿命试验条件的确定
电子产品在规定的工作及环境条件下,进行的工作试验称为寿命试验,又称耐久性试验。随着LED生产技术水平的提高,产品的寿命和可靠性大为改观,LED的理论寿命为10万小时,如果仍采用常规的正常额定应力下的寿命试验,很难对产品的寿命和可靠性做出较为客观的*价,而我们试验的主要目的是,通过寿命试验掌握LED芯片光输出衰减状况,进而推断其寿命。根据LED器件的特点,经过对比试验和统计分析,最终规定了0.3×~0.3mm2以下芯片的寿命试验条件:
[1].样品随机抽取,数量为8~10粒芯片,制成ф5单灯;
[2].工作电流为30mA;
[3].环境条件为室温(25℃±5℃);
[4].试验周期为96小时、1000小时和5000小时三种;
工作电流为30mA是额定值的1.5倍,是加大电应力的寿命试验,其结果虽然不能代表真实的寿命情况,但是有很大的参考价值;寿命试验以外延片生产批为母样,随机抽取其中一片外延片中的8~10粒芯片,封装成ф5单灯器件,进行为96小时寿命试验,其结果代表本生产批的所有外延片。一般认为,试验周期为 1000小时或以上的称为长期寿命试验。生产工艺稳定时,1000小时的寿命试验频次较低,5000小时的寿命试验频次可更低。
3、过程与注意事项
对于LED芯片寿命试验样本,可以采用芯片,一般称为裸晶,也可以采用经过封装后的器件。采用裸晶形式,外界应力较小,容易散热,因此光衰小、寿命长,与实际应用情况差距较大,虽然可通过加大电流来调整,但不如直接采用单灯器件形式直观。采用单灯器件形式进行寿命试验,造成器件的光衰老化的因素复杂,可能有芯片的因素,也有封装的因素。在试验过程中,采取多种措施,降低封装的因素的影响,对可能影响寿命试验结果准确性的细节,逐一进行改善,保证了寿命试验结果的客观性和准确性。
3.1样品抽取方式
寿命试验只能采用抽样试验的*估办法,具有一定的风险性。首先,产品质量具备一定程度的均匀性和稳定性是抽样*估的前提,只有认为产品质量是均匀的,抽样才具有代表性;其次,由于实际产品质量上存在一定的离散性,我们采取分区随机抽样的办法,以提高寿命试验结果准确性。我们通过查找相关资料和进行大量的对比试验,提出了较为科学的样品抽取方式:将芯片按其在外延片的位置分为四区,分区情况参见图一所示,每区2~3粒芯片,共8~10粒芯片,对于不同器件寿命试验结果相差悬殊,甚至矛盾的情况,我们规定了加严寿命试验的办法,即每区4~6粒芯片,共16~20粒芯片,按正常条件进行寿命试验,只是数量加严,而不是试验条件加严;第三,一般地说,抽样数量越多,风险性越小,寿命试验结果的结果越准确,但是,抽样数量越多抽样数量过多,必然造成人力、物力和时间的浪费,试验成本上升。如何处理风险和成本的关系,一直是我们研究的内容,我们的目标是通过采取科学的抽样方法,在同一试验成本下,使风险性下降到最低。
3.2光电参数测试方法与器件配光曲线
在LED寿命试验中,先对试验样品进行光电参数测试筛选,淘汰光电参数超规或异常的器件,合格者进行逐一编号并投入寿命试验,完成连续试验后进行复测,以获得寿命试验结果。为了使寿命试验结果客观、准确,除做好测试仪器的计量外,还规定原则上试验前后所采用的是同一台测试仪测试,以减少不必要的误差因素,这一点对光参数尤为重要;初期我们采用测量器件光强的变化来判断光衰状况,一般测试器件的轴向光强,对于配光曲线半角较小的器件,光强值的大小随几何位置而急剧变化,测量重复性差,影响寿命试验结果的客观性和准确性,为了避免出现这种情况,采用大角度的封装形式,并选用无反射杯支架,排除反射杯配光作用,消除器件封装形式配光性能的影响,提高光参数测试的精确度,后续通过采用光通量测量得到验证。
3.3树脂劣变对寿命试验的影响
现有的环氧树脂封装材料受紫外线照射后透明度降低,是高分子材料的光老化,是紫外线和氧参与下的一系列复杂反应的结果,一般认为是光引发的自动氧化过程。树脂劣变对寿命试验结果的影响,主要体现1000小时或以上长期寿命试验,目前只能通过尽可能减少紫外线的照射,来提高寿命试验结果的果客观性和准确性。今后还可通过选择封装材料,或者检定出环氧树脂的光衰值,并将其从寿命试验中排除。
3.4封装工艺对寿命试验的影响
封装工艺对寿命试验影响较大,虽然采用透明树脂封装,可用显微镜直接观察到内部固晶、键合等情况,以便进行失效分析,但是并不是所有的封装工艺缺陷都能观察到,例如:键合焊点质量与工艺条件是温度和压力关系密切,而温度过高、压力太大则会使芯片发生形变产生应力,从而引进位错,甚至出现暗裂,影响发光效率和寿命。引线键合、树脂封装引人的应力变化,如散热、膨胀系数等都是影响寿命试验的重要因素,其寿命试验结果较裸晶寿命试验差,但是对于目前小功率芯片,加大了考核的质量范围,寿命试验结果更加接近实际使用情况,对生产控制有一定参考价值。

















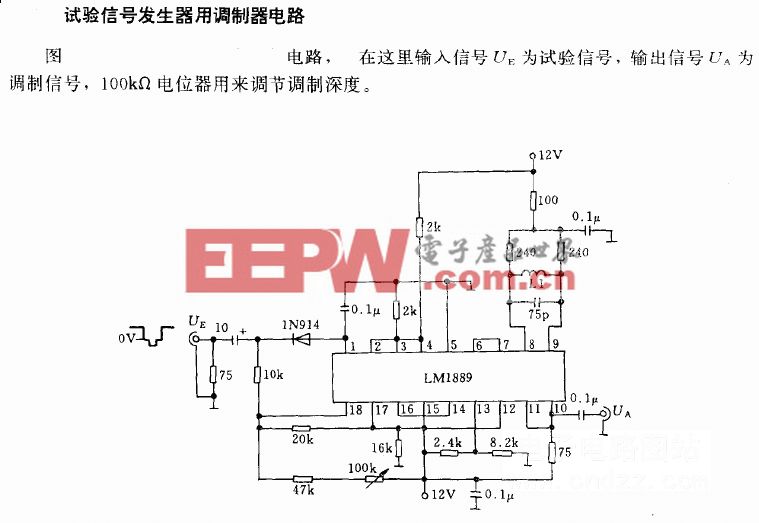
评论