日月光和台湾交大合作开发三维IC封测技术
将以最先进的三维集成电路(3D IC)封测技术为研发主题,“日月光交大联合研发中心”日前成立,日月光总经理暨研发长唐和明表示,日月光积极和半导体产业供应链进行技术整合,3D IC预计2013年导入量产,将应用在手机、PC及生医等高阶产品。
本文引用地址:https://www.eepw.com.cn/article/119786.htm日月光交大联合研发中心主任、交大电子工程系教授庄景德表示,3D IC是将芯片立体堆栈化的整合封装模式,特点在于将不同功能、性质的芯片,各自采用最合适的晶圆制程分别制作后,再利用硅穿孔(TSV)技术进行立体堆栈整合封装。
庄景德指出,3D IC具有封装微形化、高整合度、高效率、低耗电量及低成本的优势,符合数字电子产品轻、薄、短、小发展趋势的要求,是下一世代半导体芯片、消费性电子产品乃至未来的生物芯片不可缺乏的技术。
唐和明也表示,3D IC封装也会应用到SoC最先进的技术,尤其晶圆制造厂从28奈米、20奈米,甚至以下,3D IC和SoC技术更是相辅相成,系统功能整合透过3D IC,IC的密度、效率会更高,耗电量更低,符合Green的要求。
唐和明指出,3D IC的技术难度比目前产业所知至少高出10倍,除了日月光,交大已有多位教授在3D IC关键技术研发多年,双方结合后期望将3D IC封测的关键技术再加强。日月光更希望国内的半导体产业供应链也加入合作,让3D IC技术走得更快。
唐和明并表示,日月光强调对客户提供全方位的服务,自行投入研发全球最先进的3D IC封测技术,目前已经有相当多的产品进入质量及可靠度验证中,预计2013年开始量产。




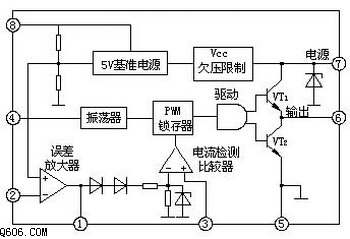



评论