半导体清洗技术
中心议题:
本文引用地址:https://www.eepw.com.cn/article/106346.htm当前与未来的挑战
解决方案:
湿法清洗
广泛使用臭氧水
晶圆清洗是半导体制造典型工序中最常应用的加工步骤。就硅来说,清洗操作的化学制品和工具已非常成熟,有多年广泛深入的研究以及重要的工业设备的支持。所以,硅清洗技术在所有具实际重要性的半导体技术中是最为成熟的。第一个完整的、基于科学意义上的清洗程序在1970年就提出了,这是专门设计用于清除Si表面的微粒、金属和有机污染物。
此后,硅清洗技术经历了持续的发展改进,包括早期用气相等效物替代在湿化学品中进行的部分清洗操作。难以置信的是,现代先进的Si清洗仍然依赖于大体上同一组化学溶液,不过它们的制备和送至晶圆的方法与最初提出的已大不相同。此外,传统上用湿清洗化学品做的表面选择清洗/修整功能现在是在气相中做的。
引入半导体器件技术的一系列新材料以及各种非平面新器件结构对清洗技术提出了重大挑战。各种硅清洗方法虽然已较为成熟,但它们不能满足正在出现的新兴需求。本文简要综述了半导体晶圆清洗技术的过去发展情况、当前趋势和未来需求。
半导体清洗技术的进展
第一个完整的、基于科学意义上的Si表面清洗方法几乎在40年前就已提出。此后,半导体清洗方法就从实验技术积累进展到对制造良率和半导体产业持续发展有极端重要意义的科学技术领域。
半导体清洗技术的关注点随时间而改变。早年关注的是大微粒和金属污染物,实际上,当时半导体器件故障常常是由于衬底晶圆中的高缺陷密度引起,而不是表面污染引起的。随着微粒和金属污染的数量级逐渐减小,以及对这方面的污染控制非常有效,现在更多注意的是有机污染和表面状态相关问题。如图1指出的,用简单的灯清洗法可以把有机污染从Si表面除去。此外,应特别注意溶解在水内和气相的臭氧在控制有机污染中的作用。另一问题是对清洗方法目标监察的多样性,因为FEOL和BEOL清洗要求不同,后者关注的是CMP后清洗。
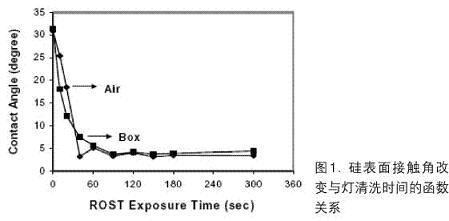
就清洗媒介来说,湿法清洗仍然是现代先进晶圆清洗工艺的主力。虽然Si技术中的清洗化学材料与最初RCA的配方相差不大,但整体工艺最明显的改变包括:采用了非常稀释的溶液;简化工艺;广泛使用臭氧水。
基于APM(NH4OH:H2O2:H2O)的化学材料在微粒去除方面仍占主宰地位,但如果没有兆频超声波强化,其作用就不是很有效。基于最初RCA(HPM:HCl:H2O2:H2O)配方的去除金属的化学材料差不多都放弃了。与洁净得多的抗蚀剂和化学材料结合在一起的创新化学是在这一领域成功的关键。此外,几何图形非常密集的器件制造的污染控制也推动了各种创新技术的研发,例如包括超临界CO2(SCCO2)清洗。
土壤湿度传感器相关文章:土壤湿度传感器原理
















评论