LPO与CPO:光互连技术的转折与协同发展
光模块、oDSP与交换机交换芯片是数据中心光互连的核心组件,而LPO(线性驱动可插拔光学)和CPO(共封装光学)的出现正推动行业向更低功耗、更高密度演进。

一、核心组件功能解析
1.光模块:光电转换的桥梁
光模块是实现电信号与光信号相互转换的关键器件,广泛应用于数据中心、电信网络等场景。其核心功能包括:
光电转换:发射端通过激光器将电信号调制为光信号,接收端通过探测器将光信号转换为电信号。
速率适配:支持从100G到1.6T的多速率标准(如QSFP-DD、OSFP等),满足不同距离(50m至2km)的传输需求。
信号处理:传统光模块依赖DSP芯片进行信号均衡、纠错和色散补偿,例如400G光模块中DSP功耗占比约50%。
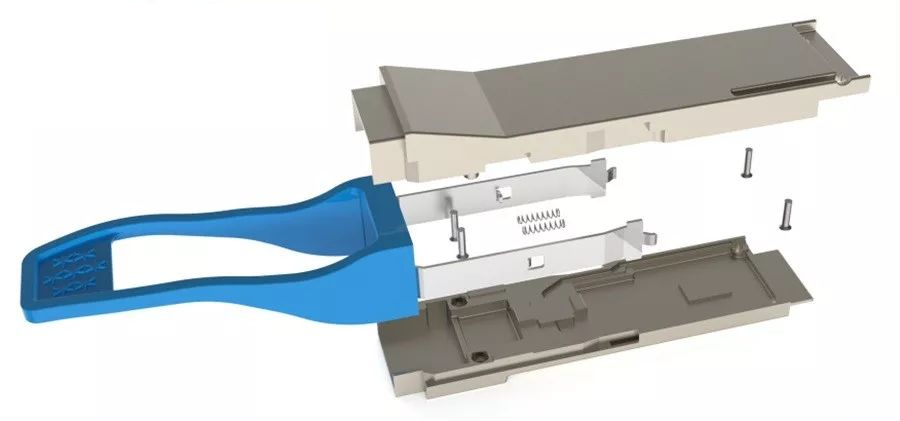
2.oDSP:光模块的“大脑”
oDSP(光数字信号处理器)是光模块内价值量最高的电芯片(占BOM成本20%-30%),其核心作用包括:
调制与解调:在数通场景中,PAM4oDSP通过4电平调制提升单通道速率(如50G/100G),并补偿信号失真;在电信长距场景中,CoherentoDSP采用相干调制(如QPSK)实现高灵敏度传输。
信号再生:通过数字信号处理(如前向纠错FEC)恢复受损信号,确保长距离传输的可靠性。
功耗痛点:800G光模块中oDSP功耗约6-8W,成为光模块功耗的主要来源。

3.交换机交换芯片:数据转发的中枢交换芯片是交换机的核心,负责高速数据帧的路由与转发,其功能包括:
端口互联:支持多端口高速连接(如112GSerDes),实现服务器、存储设备间的低延迟数据交换。
协议处理:集成PAM4调制、CDR(时钟数据恢复)和流量控制功能,确保信号完整性。
协同优化:在LPO方案中,交换芯片需承担部分原由oDSP实现的信号补偿功能,如线性均衡和时钟恢复。

二、LPO与CPO的技术突破及影响
1.LPO:可插拔架构的降本增效
技术特点:
去DSP化:通过高线性度Driver/TIA芯片替代DSP,取消CDR和复杂数字处理,使800G LPO模块功耗成本以及延迟大大降低。
兼容性:保留QSFP-DD/OSFP等可插拔封装,支持热插拔维护,适合短距(<2km)AI算力集群和成本敏感场景。
标准进展:基于OIFCEI-112G-Linear-PAM4协议,已支持800G部分产品商用,但224GSerDes仍需进一步验证和探索。
行业影响:
功耗革命:单机柜100个400GLPO模块年省电费超2000元(PUE1.5),散热成本同步降低。
供应链重构:减少对Marvell/Broadcom等DSP厂商的依赖,推动Driver/TIA芯片国产化。
场景局限:依赖交换机ASIC的信号补偿能力,适合同构网络,在异构复杂网络中竞争力较弱。
2.CPO:共封装架构的性能跃升
技术路径:
近封装演进:从NPO(光学引擎与芯片同板)到CPO(芯片与光引擎共封装),信号传输距离从10cm缩短至毫米级,功耗降低30%-50%。
集成形态:分为A型(2.5D封装)、B型(Chiplet封装)和C型(3D封装),逐步实现硅光芯片与交换ASIC的深度融合。
硅光核心:CPO依赖硅光技术实现高密度光器件集成,预计2030年硅光市场份额将达60%。
行业影响:
性能提升:1.6TCPO系统可支持51.2T总带宽,延迟降至亚纳秒级,满足AI训练集群的超高带宽需求。
生态挑战:初期依赖专有设计(如NVIDIAQuantum-X),缺乏统一标准,且光引擎故障需整机更换,运维成本高。
市场分化:CPO主要用于纵向扩展(scale-up)网络(如多机柜AI集群),而横向扩展(scale-out)仍依赖可插拔模块。
三、未来趋势与技术博弈
1.多技术共存:
LPO主导中短期:2025-2027年,LPO在AI算力集群和中小数据中心快速渗透,预计2027年新增超800万个1.6TLPO端口。
CPO长期潜力:2030年后,随着硅光工艺成熟和生态完善,CPO在超大规模数据中心逐步商用,尤其在100T+速率场景。
传统模块延续:DSP方案仍将在长距、异构网络中占据主流,且通过Link Optimized-DSP优化功耗。
2.技术协同创新:
硅光融合:硅光技术同时支撑LPO(降低Driver/TIA成本)和CPO(实现高密度集成),成为两者的底层技术基础。
封装突破:3D封装和TSV(硅通孔)技术推动CPO向C型演进,进一步缩小体积并提升散热效率。
标准统一:IEEE802.3和OIF的推进,将加速LPO的互联互通;而CPO需建立开放生态以解决兼容性问题。
3.产业链重构:
芯片厂商:Marvell/Broadcom在DSP领域仍具优势,但需应对LPO的冲击;NVIDIA/Intel通过CPO整合硅光与ASIC,强化系统级竞争力。
光模块厂商:中际旭创、新易盛等积极布局LPO/CPO,但需平衡技术投入与市场需求,避免过早押注单一方案。
代工厂:台积电、意法半导体等加大硅光产能,推动CPO规模化生产。
四、总结
LPO和CPO的出现标志着光互连技术从“可插拔主导”向“集成化演进”的转折。LPO以低功耗、易部署的特点成为中短期主流,而CPO凭借极致性能代表长期方向。两者的博弈将推动数据中心架构向更高效、更智能的方向发展,同时也为硅光、先进封装等底层技术带来新的机遇与挑战。未来,多技术路线的协同发展将成为行业常态,而标准统一与生态合作将是决定技术落地速度的关键。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。

相关推荐
NVIDIA GTC 2026定调「光铜并行」 长期铺路CPO光互联
光互连光交换CPO是本土超节点集群“以量补质”的破局机遇
股市里面爆红的“CPO”,与“CPC”技术对比与展望
英伟达或于3月推出CPO交换机新品
CPO成为新宠,长电科技与联电率先卡位
日月光CPO装置 抢数据中心商机
数据中心的黑科技——到底什么是NPO/CPO?
英伟达——推理王国持续扩张
CPO量产瓶颈成2026年现实考验 光电异质整合检测难度高
龙芯产品技术资料UserGuide英文版
联发科、NVIDIA双双重金加码投资 CPO备受青睐
AI算力爆发驱动光互连革命 CPO渗透率2030拼35%
科普:到底什么是LPO?