- 当半导体业准备进入14/15nm节点时,将面临众多的技术挑战
对于逻辑电路,STMicro的Thomas Skotnicki认为传统的CMOS制造工艺方法己不再适用。因为当器件的尺寸持续缩小时,由于己达极限许多缺陷显现。按IBM技术经理Mukesh Khare看法,如栅氧化层的厚度Tox再缩小有困难。另外,除非采用其它方法,因为随着互连铜线的尺寸缩小铜线的电阻增大及通孔的电阻增大也是另一个挑战。
- 关键字:
EUV 节点技术
- 目前次世代微影技术发展仍尚未有主流出现,而身为深紫外光 (EUV)阵营主要推手之一的比利时微电子研究中心(IMEC)总裁Luc Van den hove指出,EUV技术最快于2014年可望进入量产,而应用存储器制程又将早于逻辑制程,他也指出,无光罩多重电子束恐怕来不及进入量产。
- 关键字:
微影技术 EUV
- 继晶圆代工大厂台积电宣布跨入深紫外光(EUV)微影技术后,全球晶圆(Global Foundries)也在美国时间14日于SEMICON West展会中宣布,投入EUV微影技术,预计于2012年下半将机台导入位于美国纽约的12寸晶圆厂(Fab 8),将于2014~2015年间正式量产。
由于浸润式微影(Immersion Lithography)机台与双重曝光(double-patterning)技术,让微影技术得以发展至2x奈米,不过浸润式微影机台采用的是 193nm波长的光源,走到22奈米已
- 关键字:
台积电 EUV 晶圆代工
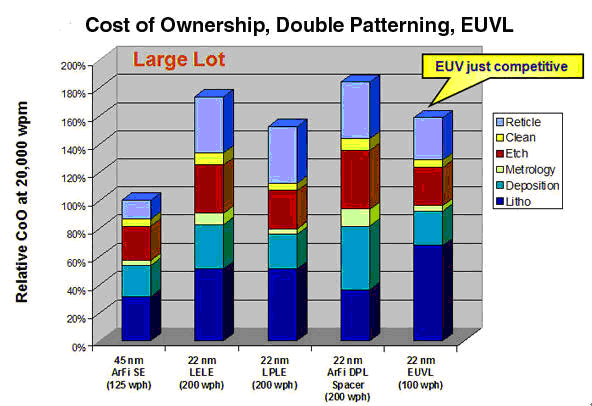
- 英特尔的先进光刻和制造部的Yan Borodovsky表明,英特尔希望EUV或者无掩模电子束光刻能作为193纳米浸入式光刻在11纳米的后补者,并声称11纳米可能发生在2015年。
Borodovsky表示193nm浸入式光刻技术可能延伸到分别在2011和2013年的22nm及16nm 中。
在Nikon的年会上许多其它的专家似乎对于EUV光刻也有相似的看法。如Nikon的光刻机设计部总经理Masato Hamatani认为,当EUV达到所有的预定目标时,进入量产
- 关键字:
英特尔 11纳米 EUV
- 相比于2009年今年全球半导体业的态势好了许多,但是仍有少部分人提出质疑,2010年有那么好吗?即具备条件了吗?
在今年1月由SEMI主办的工业策略年会上(ISS),有些演讲者表示一些担忧,认为虽然半导体业正在复苏的路上,但是制造商们仍缺少激情,不肯继续大幅的投资,以及不太愿意重新扩大招慕员工。
恐怕更大的担心来自全球半导体业间的兼并与重组到来,以及产业能否支持得起22纳米及以下技术的进步。
IBS的CEO Handle Jones认为,虽然工业正在复苏,但是在半导体业运营中仍面临成
- 关键字:
ASML 半导体 EUV
- TSMC与荷兰艾司摩尔(ASML)公司今日共同宣布,TSMC将取得ASML公司TWINSCAN™ NXE:3100 - 超紫外光(Extreme Ultra-violet,EUV)微影设备,是全球六个取得这项设备的客户伙伴之一。
这项设备将安装于TSMC的超大晶圆厂(GigaFab™)-台积十二厂,用以发展新世代的工艺技术。TSMC也将成为全球第一个可以在自身晶圆厂发展超紫外光微影技术的专业集成电路制造服务业者。
相较于现行浸润式微影技术以193纳米波长当作光源,超
- 关键字:
台积电 EUV 微影设备 ASML
- 半导体技术市场权威分析公司IC Insights近日发布的报告显示,按照他们的估计,450mm技术以及极紫外光刻技术(EUV)投入实用的时间点将再度后延。
据IC Insights预计,基于450mm技术的芯片厂需要到2015-2016年左右才有望开始实用化建设--比预期的时间点后延了两年左右。另外,预计16nm级别制程技术中也不会应用EUV光刻技术,这项技术会被后延到2015年,在13nm级别的工艺制程中投入实用。
另外一项较新的半导体制造技术,可用于制造3D堆叠式芯片的硅通孔技术(TS
- 关键字:
EUV 光刻 450mm
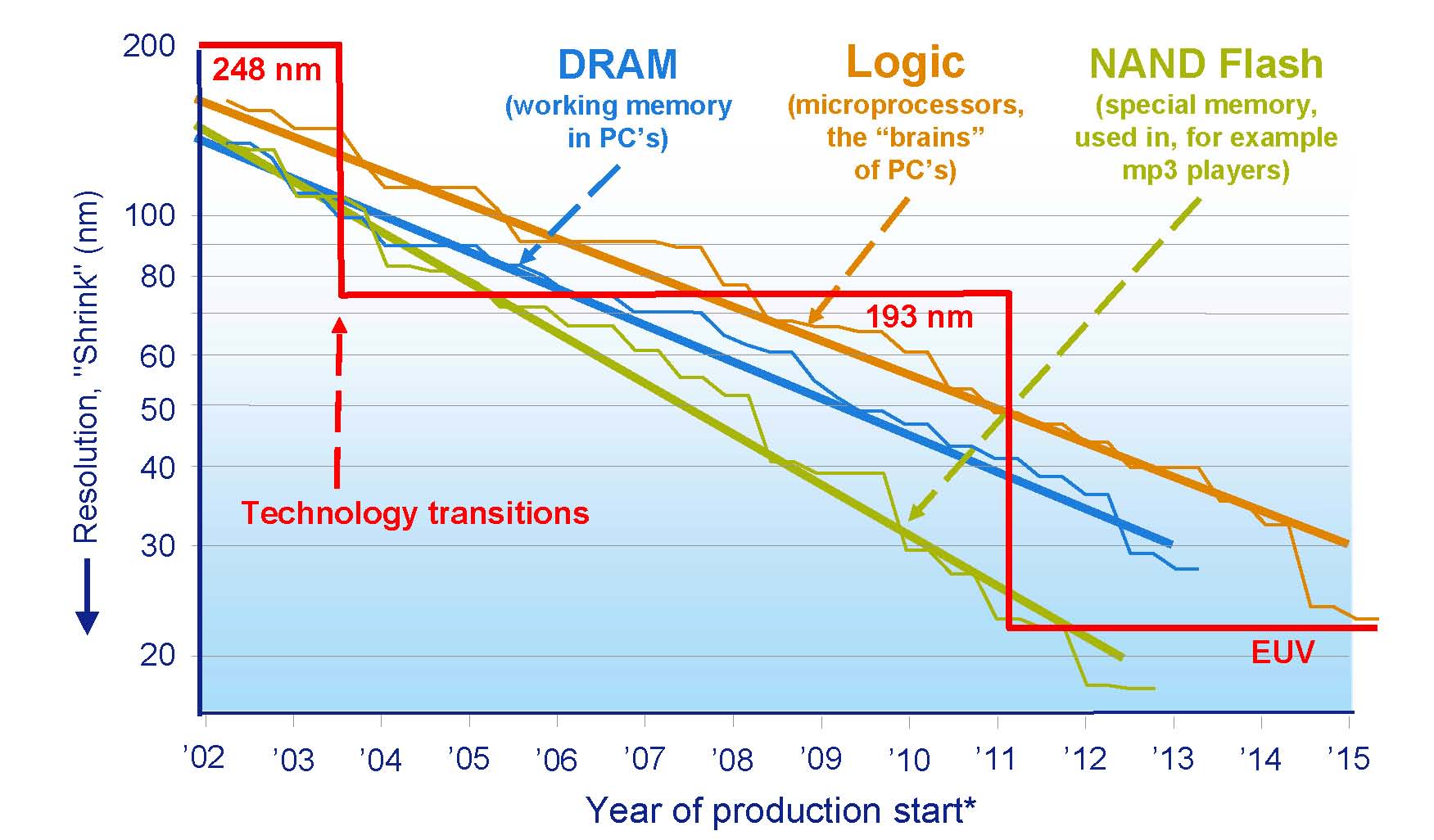
- 2010年, ASML将有5台最先进的EUV设备整装发往全球的5家客户。业界传言,最新的NXE3100系统将发送给3家顶级存储器厂商和2家顶级逻辑厂商。EUV胜利的曙光正在向我们招手,虽然目前工程师们还在荷兰Veldhoven专为EUV新建的大楼中忙碌,在设备出厂前,解决正在发生的问题,并预测着各种可能发生的问题及解决方案。
人们谈论EUV的各种技术问题已历时数年,因为其波长较目前的193nm缩短10倍以上,EUV一直是通往22nm的实力派参赛选手之一。与此同时,延伸immersion技术,用其
- 关键字:
ASML EUV 22nm
- 不知是否是因为Global Foundries的步步威胁,台积电28日宣布,延聘3年前离职的蒋尚义博士担任研究发展资深副总经理,他将直接对张忠谋董事长负责。
这是继张忠谋6月重新执政台积电以来,又一次重大的人事调整。蒋尚义博士早在1997年即加入台积电担任研究发展副总经理,带领研发团队一路顺利开发完成0.25微米、0.18微米、0.13微米、90纳米、65纳米等各个世代的先进工艺技术,成果斐然。但是三年多前因为要照顾年迈生病的父亲而暂时离开,如今因父亲仙逝而能再度回到台积,相信蒋资深副总的回任,
- 关键字:
台积电 40纳米 HKMG EUV
- 德国Carl Zeiss SMT AG已向半导体设备商ASML出货首台EUV光学系统。该公司已使EUV光学系统达到了生产要求。
光学系统是EUV设备的核心模块,首台EUV设备预计将在2010年出货。几周前,美国公司Cymer完成了EUV光源的开发,EUV光源是EUV光刻设备另一个关键模块。该技术将使芯片制造商进一步缩小芯片的特征尺寸,提高生产效率。
据Carl Zeiss 介绍,目前出货的光学系统已经研发了约15年。
- 关键字:
ASML EUV 光刻设备
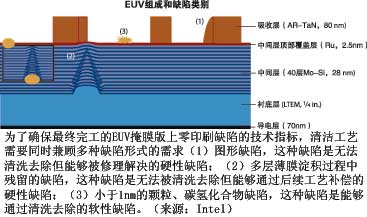
- 对于极紫外(EUV)光刻技术而言,掩膜版相关的一系列问题是其发展道路上必须跨越的鸿沟,而在这些之中又以如何解决掩膜版表面多层抗反射膜的污染问题最为关键。自然界中普遍存在的碳和氧元素对于EUV光线具有极强的吸收能力。在Texas州Austin召开的表面预处理和清洗会议上,针对EUV掩膜版清洗方面遇到的问题和挑战,Intel Corp. (Santa Clara, Calif.)的Ted Liang主持召开了一次内部讨论,并在会上向与会的同仁报告了在这一领域Intel和Dai Nippon Printin
- 关键字:
光刻 EUV 掩膜 CMOS
- 浸润式微显影双重曝光能进一步延伸摩尔定律的寿命至32纳米,不过,22纳米以下究竟哪种技术得以出头,争议不断。据了解,台积电目前正积极研发22纳米以下直写式多重电子束(MEBDW)方案,并已有具体成果,但积极推动深紫外光(EUV)的ASML则表示,目前已有数家客户下单,最快2009年便可出货,但哪种技术最终将「一统江湖」,尚未有定论。 ASML表示,目前深紫外光EUV的光波波长可达13.5纳米,约是248波长的KrF显影设备的15分之1,尽管浸润式显
- 关键字:
消费电子 EUV 电子束 消费电子
- 尼康日前正式宣布,2006年1月已向大型半导体厂商供应用于55nm工艺(hp55)芯片制造、开口数(NA)为1.07的液浸ArF曝光设备“NSR-S609B”。这是全球首次供应NA超过1的液浸ArF曝光设备。 这家大型半导体厂商的名字,尼康没有公布,估计是过去在技术方面与之开展合作的东芝。 作为全折射型液浸曝光设备,NSR-S609B具有全球最大的NA,配合偏光照明技术,能够实现很高的分辨率。对于液浸产生的缺陷和重合不稳定性的问题,据称利用名为“Local-fill(局部
- 关键字:
NA 尼康 嵌入式系统
na euv介绍
您好,目前还没有人创建词条na euv!
欢迎您创建该词条,阐述对na euv的理解,并与今后在此搜索na euv的朋友们分享。
创建词条
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473