智能手机应用处理器封装的下一站:从PoP到Fan-Out与面板级封装
摘要
应用处理器(APU)长期以PoP(Package-on-Package)形态与DRAM竖向堆叠,是智能手机主板的“面积预算中心”。2025年约65%的APU仍采用PoP,其余为单芯片封装;到2030年,基于Fan-Out(如TSMC InFO-PoP)的PoP将从2025年的约18%提升至约三分之二,传统FC-BGA/MCeP类PoP与单芯片形态占比同步下降。在材料与结构层面,Fan-Out以RDL取代层压基板,配合TIV实现更薄、更短互连路径;而MCeP通过铜芯焊球与模封树脂控制翘曲与层间距,在安卓阵营广泛落地。面板级Fan-Out(FO-PLP)正由多家OSAT推向量产,成本优势显著,但仍面临翘曲、线宽线距与RDL层数等工艺挑战。
1. 市场与系统背景
APU通常集成CPU/GPU/AI引擎等,是高集成SoC;约85%的APU与基带(BB)同芯集成,另有约15%(以Apple与Google为主)仍采用离散APU与基带芯片,导致器件在封装与系统布局上呈现不同演化路径。PoP流行的根因在于:在主板面积与高度受限的前提下,通过垂直堆叠缩短APU至DRAM的链路并为其他器件释放布板空间,但同时把散热难题直接“压在”APU之上,提升了对封装热设计与装联良率的要求。
从数量结构看,2025年PoP约占65%,单芯片APU约占35%(多见于不与DRAM同封的方案或系统层面采用MCP/NAND-DRAM组合)。
2. PoP是什么:从材料栈到装联流程
典型PoP包含:层压基板(substrate)、RDL、BGA焊球、贯穿结构(TMV/TIV)、底部填充、引线、贴片胶与EMC封料等;上层DRAM通常以错位堆叠并以金/铜引线键合至下层基板。两层可在主板上进行一次或两次回流实现互连;也可先将上层记忆体回流到APU封装后再与主板二次回流装联。
优点:节省主板面积、缩短APU-DRAM路径;缺点:散热路径受限、互连复杂度与装联容差变小,易引入错位与焊接缺陷。
3. 主流PoP技术谱系
3.1 FC-BGA / FC-CSP PoP
在2016年前,Apple以FC-BGA PoP为主;自A10(iPhone 7)起转向TSMC InFO,2017年A11以铜柱TIV取代TMV。安卓阵营在2019年前后开始在PoP中引入互连中介层(以Exynos 9810为例),截至2025年FC-BGA/FC-CSP PoP仍广泛存在,同时相当比例APU并不堆叠DRAM而是单芯片形态。
工程要点:为控制大面积翻晶裸片导致的翘曲,多采用更厚基板与更大上球尺寸作为上下层间距与可靠性的“稳定器”。
3.2 MCeP(Molded-Core Embedded Package)
MCeP由Shinko开发,通过铜芯焊球连接上下基板,抑制焊球塌陷、精确控制层间距,随后以模封树脂填充空隙,因此可配用更薄的基板并降低整体厚度;该方案已被海思、联发科与高通用于APU PoP量产。
工程意义:以结构刚度与封装材料体系协同来替代“加厚基板/加大焊球”的传统思路,取得厚度与翘曲的兼容平衡。
3.3 Fan-Out / InFO-PoP(TSMC)
Fan-Out以已测良裸片(KGD)在载板上模封形成“再构晶圆”,随后加工RDL并在其上形成凸点;由于RDL取代层压基板,封装更薄、I/O扇出范围扩展到裸片以外的模封区,电/热性能与封装面积效率显著改善。除APU外,Fan-Out WLP也被用于PMIC等器件。
量产进展与风向:
Samsung于Exynos 2400在S24/S24+上采用FOWLP;高通与联发科在2025年被传将加入该趋势。
Google正从三星工艺/Exynos系设计转向TSMC,并在Tensor G5上采用InFO(与Apple同路)。
对比一览(节选自报告表格):
| 方案 | SoC基底 | DRAM→SoC互连 | 结构要点 |
|---|---|---|---|
| InFO-PoP | RDL | TIV | 封装更薄、扇出至模封区 |
| FC-BGA PoP | 厚基板 | 大上球 | 厚基板抑制翘曲、满足翻晶高度 |
| MCeP | 基板 | 铜芯焊球 | 控间距、模封填充、薄基板可行 |
| (来源:TechInsights) |
4. 面板级Fan-Out(FO-PLP):成本曲线的潜在“新拐点”
2025–2026年,Amkor、ASE、PTI、nepes等多家OSAT推进FO-PLP;2027–2028年起,PLP有望在手机APU的WLP市场份额上“可见”增长。面板相较晶圆的单位面积成本优势适合智能手机这类高出货场景,但产线设备更替与工艺开发投入导致导入节奏偏稳健;当前主要挑战包括翘曲控制、线宽/线距收敛与RDL层数提升。
值得注意的是,Google曾在Tensor G3(2023)试水三星FO-PLP,随后在2024年回到标准PoP,显示PLP在APU上的量产成熟度尚需时间;传闻其将在2025年Q4的G5转向InFO-PoP。PLP已在PMIC等器件先行落地。
5. 系统架构联动:基带整合、热设计与装联工艺
基带整合:在非集成BB场景(Apple等),基带通常与自身DRAM组成FC-BGA PoP;2024年Q4 Apple发布自研5G调制解调器C1(4nm),与DRAM同侧封装,RF收发器为7nm置于另一面。高通预计至2027年逐步失去苹果基带订单,这为后续APU-BB单芯集成打开想象空间。
热问题:DRAM直接置于APU上方,热流出路径受阻,封装/系统需在材料(EMC、底填、TIM)、结构(TIV/TMV、球栅布置)与系统级散热(均热片/石墨片/VC)上协同优化。
装联工艺:PoP可一次或两次回流实现堆叠与主板互连;在倒装SoC的高度限制下,上层球尺寸与共面性控制是装联良率关键点之一。
6. 工艺/成本前瞻:2nm、芯粒与经济性
随着制程推进,裸片面积与成本上升、基板翘曲风险加剧。高端APU在2026年将进入2nm时代;芯粒(chiplet)化可将部分IP迁移至成熟节点以缓解成本与良率,但在智能手机SoC上的经济性窗口仍需数年。Fan-Out本身具备对芯粒的良好支撑性,但业内判断若要在智能手机APU落地,时间窗口大概率不早于2027–2028年。
7. 工程清单:为下一代APU封装做设计预案
封装选型矩阵:以系统厚度目标/主板层数/AI算力热设计作为一阶约束,评估InFO-PoP、MCeP与FC-BGA PoP在厚度、翘曲、I/O密度与良率上的权衡。
互连/材料:在Fan-Out中优化RDL层数与L/S,验证TIV直通路径的SI/PI窗口;在MCeP/FC-BGA中,建立上球塌陷/共面性窗口与基板厚度的DOE。
热-机械协同:建立热-机械共仿真(APDL/Ansys)评估模封系数、底填模量、TIV/TMV热阻与DRAM上方散热构件的匹配策略,避免早期疲劳失效。
装联工艺:对“一次回流叠堆+二次主板回流”和“先Top-On再与主板回流”两种流程做SPC控制与失效归因(头顶/侧壁偏移、桥连、空洞),并纳入板级再加工窗口。
供应链与良率:PLP导入需与OSAT就面板翘曲、RDL多层对准、再构面板缺陷密度建立共同KPI;以PMIC/射频前端等“先行器件”验证工艺成熟度,再迁移至APU。
8. 结论与行业展望
技术主线:从FC-BGA/MCeP向Fan-Out(InFO-PoP)迁移,是厚度、I/O密度与热/电性能的合力结果;到2030年Fan-Out类PoP将成为智能手机APU封装主流。
成本与量产:PLP具备成本曲线优势,但短期内APU仍以晶圆级Fan-Out与成熟PoP并行;PLP更多在辅助器件先行试产,等待工艺窗收敛。
系统协同:BB整合路线、多层系统热设计与板级装联良率,是评估封装路线时必须同步优化的三个维度。
时间轴:高端APU 2nm时代在即(~2026),芯粒化短期内技术可行、但经济性未必成立,真正产业化窗口预计在2027–2028年后。
附:术语与对照
PoP:上下两层封装垂直堆叠;下层为APU,上层为DRAM。
FC-BGA/FC-CSP:翻晶+层压基板方案,依赖较厚基板与大上球控制翘曲与间隙。
MCeP:上下基板以铜芯焊球连接并模封填充,兼顾薄型与可靠性。
Fan-Out / InFO-PoP:以RDL取代层压基板,TIV实现上下层互连,薄型与I/O扇出能力强。
FO-PLP:在面板上实现Fan-Out,目标是显著降低单位面积成本并提升产能。



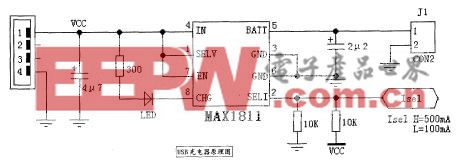



评论