ASML研发5纳米分辨率Hyper NA光刻机
据外媒报道,ASML正与蔡司(Carl Zeiss)合作,启动研发分辨率可达5纳米的Hyper NA光刻机设备。ASML技术执行副总裁Jos Benschop表示,这种新型光刻机将满足2035年及之后的芯片制造需求。
目前,ASML刚刚开始出货最先进的光刻机,其单次曝光分辨率可达8纳米,相比旧款设备需要多次曝光才能实现类似效果。
Benschop还提到,ASML正与蔡司进行设计研究,目标是开发数值孔径(NA)达到0.7或更高的系统。数值孔径是衡量光学系统聚焦能力的重要指标,直接影响光刻分辨率。NA越高,光波长越短,投影精度也越高。目前主流EUV设备的NA为0.33,而最新一代High NA EUV设备已提升至0.55。ASML正迈向NA 0.7或更高的Hyper NA阶段,这需要重新设计多个关键系统。
据悉,ASML已向英特尔和台积电交付了首批High NA EUV设备。Benschop指出,这类设备的大规模应用仍需时日。客户需要验证新系统的性能,并开发配套材料与工具,这一过程通常需要数年时间。他补充道:“客户需要适应新设备的操作方式,但我相信它很快会被广泛用于高产能芯片制造。”




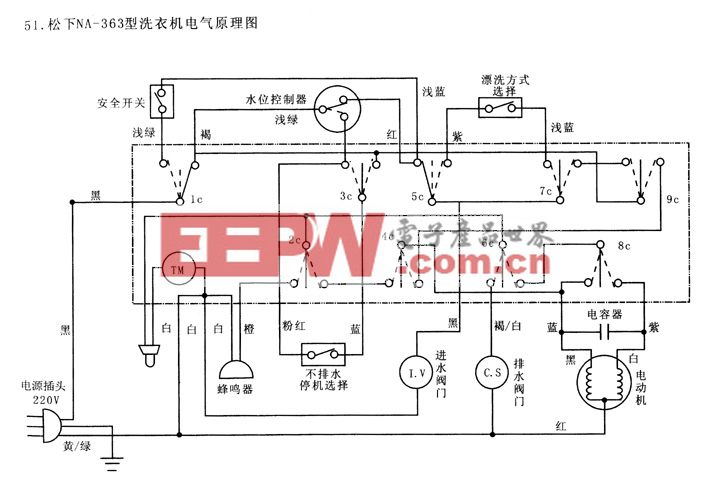
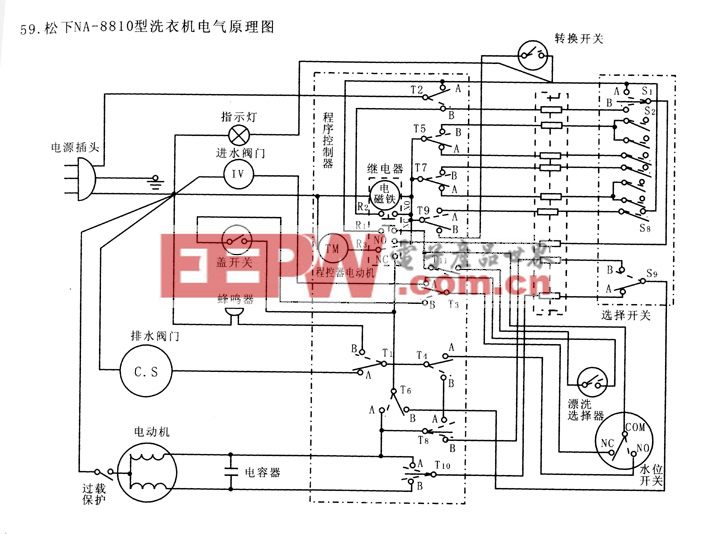
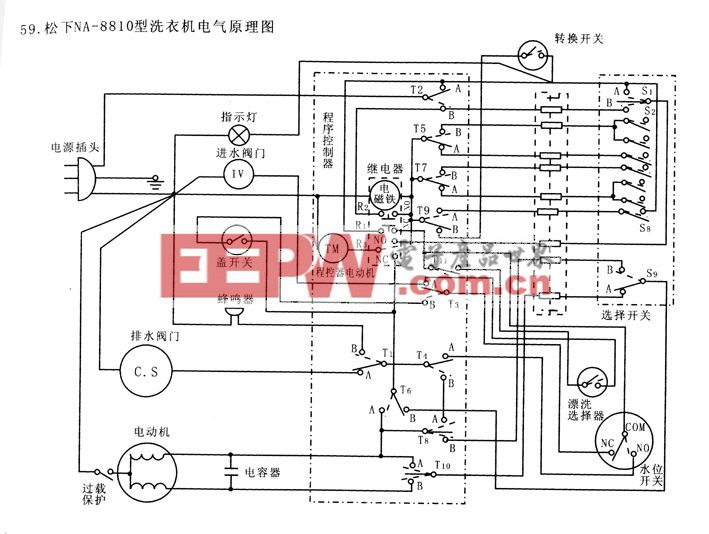
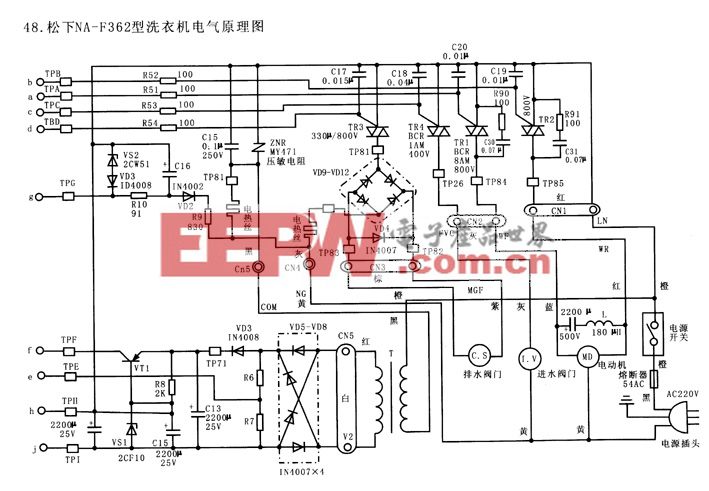
评论