功率MOSFET雪崩击穿问题分析
摘要:分析了功率MOSFET雪崩击穿的原因,以及MOSFET故障时能量耗散与器件温升的关系。和传统的双极性晶体管相比,反向偏置时MOSFET雪崩击穿过程不存在“热点”的作用,而电气量变化却十分复杂。寄生器件在MOSFET的雪崩击穿中起着决定性的作用,寄生晶体管的激活导通是其雪崩击穿的主要原因。在MOSFET发生雪崩击穿时,器件内部能量的耗散会使器件温度急剧升高。
本文引用地址:https://www.eepw.com.cn/article/179394.htm关键词:双极性晶体管;功率MOSFET;雪崩击穿;寄生晶体管;能量耗散
1 引言
功率MOSFET在电力电子设备中应用十分广泛,因其故障而引起的电子设备损坏也比较常见。分析研究功率MOSFET故障的原因、后果,对于MOSFET的进一步推广应用具有重要意义。
在正向偏置工作时,由于功率MOSFET是多数载流子导电,通常被看成是不存在二次击穿的器件。但事实上,当功率MOSFET反向偏置时,受电气量变化(如漏源极电压、电流变化)的作用,功率MOSFET内部载流子容易发生雪崩式倍增,因而发生雪崩击穿现象。与双极性晶体管的二次击穿不同,MOSFET的雪崩击穿常在高压、大电流时发生,不存在局部热点的作用;其安全工作范围也不受脉冲宽度的影响。
目前,功率器件的故障研究已经从单纯的物理结构分析过渡到了器件建模理论仿真模拟层面。因此,本文将从理论上推导MOSFET故障时漏极电流的构成,并从微观电子角度对MOSFET雪崩击穿现象作详细分析。同时,还将对故障时器件的能量、温度变化关系作一定的分析。
2 功率MOSFET雪崩击穿理论分析
图1(a)为MOSFET的体内等效电路,其中含有一个寄生的双极性晶体管V2,它的集电极、发射极同时也是MOSFET的漏极和源极。当MOSFET漏极存在大电流Id,高电压Vd时,器件内电离作用加剧,出现大量的空穴电流,经Rb流入源极,导致寄生三极管基极电势Vb升高,出现所谓的“快回(Snap-back)”现象,即在Vb升高到一定程度时,寄生三极管V2导通,集电极(即漏极)电压快速返回达到晶体管基极开路时的击穿电压(增益很高的晶体管中该值相对较低),从而发生雪崩击穿,如图2所示。

(a) 体内等效电路
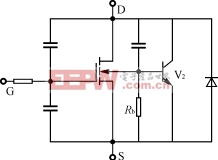
(b) 外部分析电路
图1 MOSFET等效电路

图2 雪崩击穿时I-V曲线
下面利用图1的等效电路来分析MOSFET的雪崩击穿。
假设三极管Vb≈0.6V,Vb=IbRb,则可得MOSFET源极电流
Is=Ido+γVb=Ido+γRbIb(1)
式中:Ido为漏极电压较低时的饱和漏极电流;
γ为大信号体偏置系数(Large Signal Body-bias Coefficient),定义为
γ=ΔId/ΔVb(2)
当Vb很高时,漏极的强电场引起电子沟道电流的雪崩式倍增,产生的空穴向基极流动。
如果增益为M,则基极电流为
Ib=Id-Is=MIs-Is=(M-1)(Ido+γRbIb)(3)
可得
Ib=![]() (4a)
(4a)
Is=![]() (4b)
(4b)
Id=![]() (4c)
(4c)
当发生击穿时,有
IbRb≈0.6V(5)
由式(4)及式(5)可得击穿时的关系式(下标SB为雪崩击穿标志)为
1-![]() (6)
(6)
电子镇流器相关文章:电子镇流器工作原理














评论