光学光刻和EUV光刻中的掩膜与晶圆形貌效应
时域有限差分法(FDTD)将离散积分格式用于微分形式麦克斯韦方程。此方法非常灵活,易于适应各种不同的几何形状和入射场条件。这一方法的计算结果和精确度主要取决于依据每波长网格点数(GPW) 的空间离散化程度。计算时间和存储要求与模拟体中网格点总数是线性比例关系。很多情况下,为了得到某些现象的直观近场分布图和定性研究,15-25 GPW就足够了。光刻模拟的典型准确度要求多半需要100GPW以上。FDTD已被应用于解决先进光刻中的许多典型问题。
像波导法(WGM)和严格耦合波分析(RCWA)一样,模态法也是用切割模拟体、切片内电磁场和光学材料特性的Fourier展开式,以及它们之间Fourier系数的耦合解麦克斯韦方程。散射场是以产生的代数方程式的解获得的。WGM(及类似方法)的计算结果和准确度主要决定于Fourier展开式的阶数(WG阶)和切片数。计算时间和存储要求随WG阶的三次方增加。一般说来,对于求解具有矩形块结构几何形状(如垂直吸收侧壁)的2D问题(线条和隔离),这些模态法是非常准确而有效的。这些方法缩微化能力差使其难以应用到更大的3D问题(如接触孔的半密矩阵)。已开发了特殊的分解方法解决这一问题。有效执行WGM目前已用于光学和EUV掩膜及晶圆形貌效应的高效模拟。
其它EMF模拟方法基于麦克斯韦方程的积分表达式。最近的论文证明,对于模拟形状复杂的掩膜几何图形的光衍射,有限元方法(FEM)和有限积分技术(FIT)具有极高的准确度。这使得这些方法对于标定其它方法和一些特殊场合的模拟非常有用。详细了解和精确模拟从光刻掩膜和晶圆上的(亚)波长尺寸特征图形产生的光衍射,对于开发和优化先进光刻工艺是不可或缺的。
掩膜形貌的影响
掩膜模型
图1是光透射通过光掩膜用的二种本质上不同的模拟方法。在Kirchhoff方法中(左图),透射光的幅值及相位直接由掩膜版图确定。对于所示的二元掩膜,在铬覆盖的区域内,透射光的幅值为0.0,其余地方为1.0。透射光的相位是常数。精密掩膜模型(右图)用麦克斯韦方程的数值解法计算透射光的幅值和相位。通过近场Fourier变换得到掩膜远场内的衍射谱,示于图1的下半部分。光刻成像系统的投影光瞳覆盖一部分衍射谱,并将其转换为晶圆一侧的图形。通常,掩膜是由不同方向照明的。特定照明方向的衍射光可以用二种方法得到:用精密EMF模拟相关的入射光方向;或对于计算前入射光方向的衍射谱进行角度偏移(旋转)(Hopkins法)。对所有相关入射光方向的精密EMF模拟(不用Hopkins法)是最准确而又耗时的。
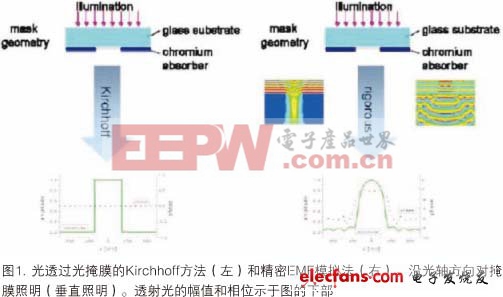
掩膜衍射分析
直接分析掩膜衍射谱或掩膜衍射分析可用来识别最重要的掩膜侧散射效应的成像结果,即所谓的掩膜形貌效应。图2显示垂直入射光零级和一级衍射光的模拟衍射效率及这些衍射级间的相位差。
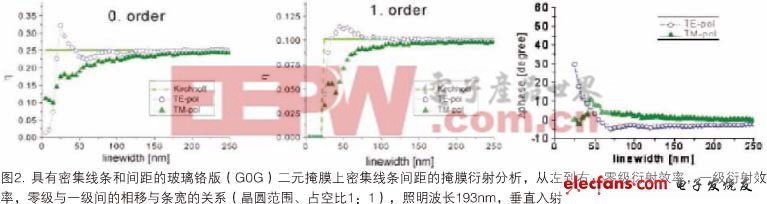
对比所谓的薄掩膜或Kirchhoff 法,EMF模拟结果证明掩膜特征尺寸和入射光的极化对衍射光的强度及相位有显著影响。特征尺寸和极化的影响随条宽的减小而增加。对于80nm以下的特征尺寸,可以观察到显著的掩膜引起的相位效应。这些相位效应产生像差一类的结果。
光学掩膜OPC效果
衍射效率变化与掩膜特征尺寸的关系在掩膜的光学邻近修正(OPC)中是一定要考虑的。图3比较了标准的衰减型移相掩模(AttPSM)上线条和间距的OPC曲线,它们是分别就不同的掩膜模型和特征尺寸计算出来的。模拟是对典型的晶圆堆叠进行的,采用与光刻胶全物理模型结合的矢量成像模拟。首先,计算产生有特定目标线宽的密集图形的曝光剂量。然后改变节距。对每一节距计算掩膜特征尺寸(晶圆范围),产生有特定剂量和目标的半密集图形。特征尺寸和数值孔径(NA)成比例产生约为0.31的恒定k1成像因子。
根据图3,掩膜模型特定OPC曲线间的差异随特征尺寸的减小而增加。对于90nm或更大的特征尺寸,有和没有Hopkins法的精密模拟产生的结果几乎是一样的。此外,Kirchhoff模型与精密模型间的差异在节距上显不出太多变化。有关影响很容易用OPC模型的光刻胶内核补偿。对于45nm的特征尺寸,情况就不是这样,此时可看到节距上模型差异有显著变化。图4说明了照明形状对45nm线条OPC曲线的影响。依据这些结果,更为局部的(特定特征)照明设置(如偶极照明)提高了没有Hopkins法的高精度精密EMF模拟的重要性。



EUV掩膜的OPC和其他结果
图5左是目标尺寸22nm EUV工艺的模拟OPC曲线。由于波长降低及k1成像因子增加,邻近效应和掩膜模型的绝对影响比高NA光学情况时小得多。剩余的模型差异很容易用OPC模型的光刻胶内核补偿。但是,尚有另一个对于光学掩膜不大明显而又很重要的效应。EUV掩膜上的吸光体厚度很大,会产生显著的相变及像差一类的效应。图5右说明了节距上最佳聚焦位置的明显变化。有关效应难以用掩膜几何图形的修改补偿。这些效应对EUV光刻性能的全部影响仍需进一步研究。
晶圆形貌效应
对有图形晶圆曝光会产生晶圆形貌效应,例如反射V型槽口、光刻胶footing、底部抗反射涂层(BARC)的效率降低,以及其它曝光副产品。不过,晶圆上各种形貌特征光衍射的精密EMF模拟在过去受到的关注还比较少。BARC的应用减少了从晶圆图形上散射光对光刻曝光的影响。随着对二次图形和双重曝光技术兴趣的增加,这种情况已完全改变。在标准的光刻-刻蚀-光刻-刻蚀(LELE)二次图形曝光工艺中,用有图形的硬掩膜进行第二次光刻曝光。采用不同形式的光刻胶冻结技术,不同光刻胶光学性质的差异和BARC的光引起的折射率改变能修改光刻-冻结-光刻-刻蚀 (LFLE)工艺的光刻结果。
图6是LFLE工艺的模拟光刻胶轨迹。第一次光刻工艺用来产生y轴平行的密集(左)或半密集(右)线条,这些用浅蓝色图形显示。得到的光刻胶图形冻结后,旋转涂敷第二次光刻胶,并以密集的x轴平行线条和间距图形曝光。模拟中假定第一次(冻结)和第二次(没冻结)光刻胶之间的折射率差为0.03。因此,光刻胶内的强度分布用精密EMF模拟法计算。
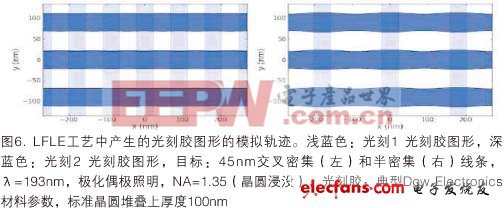
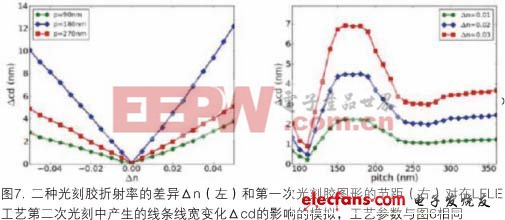
根据图6,第一次光刻-冻结-旋涂后,不同质光刻胶的光衍射导致第二次光刻工艺中产生的线条线宽变化。线宽变化量Δcd取决于第一次和第二次光刻胶间折射率的差异,及第一次光刻中产生的图形的节距。定量分析示于图7。图7的结果可用来确定合适的光刻胶材料性能指标。
总结与展望
对先进光刻掩膜光衍射的精密EMF模拟已成为预知光刻模拟的必做工作。未来的研究将包括深入探讨晶圆形貌影响和亚波长特征图形的光学计量技术模拟,特别是开发从散射光提取轮廓和材料信息的逆向方法。
透射电镜相关文章:透射电镜原理 全息投影相关文章:全息投影原理


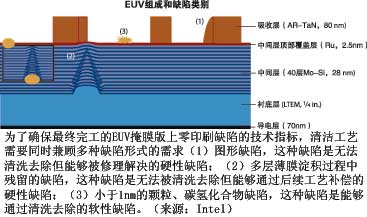
评论