又一存储大厂DRAM考虑采用MUF技术
韩国媒体 TheElec报道,三星正在考虑在其下一代 DRAM 中应用模压填充(MUF)技术。三星最近测试了一种用于 3D 堆栈 (3DS) 存储器的MUF 技术,与 TC NCF 相较其传输量有所提升。
本文引用地址:https://www.eepw.com.cn/article/202403/455990.htm据悉,MUF 是一种在半导体上打上数千个微小的孔,然后将上下层半导体连接的硅穿孔 (TSV) 技术后,注入到半导体之间的材料,它的作用是将垂直堆栈的多个半导体牢固地固定并连接起来。而经过测试后获得的结论,MUF 不适用于高频宽存储器 (HBM),但非常适合 3DS RDIMM,而目前 3DS RDIMM 使用硅通孔 (TSV) 技术制造,主要应用于服务器上。
在此之前,三星已经在其现有的双列直插式存储器模块(RDIMM)中使用了热压非导电膜(TC NCF)技术。而 MUF 是另一家存储大厂用于制造高频宽存储器(HBM)的技术,其所用的技术为 Mass Re-flow Molded Underfill,简称 MR-MUF。事实上,MUF 是一种环氧树脂模塑化合物,自从该大厂成功将其应用于 HBM 生产后,便在半导体产业中受到关注,业界认为该材料被认为在避免晶圆翘曲方面更有优势。
消息人士称三星计划与三星 SDI 合作开发自己的 MUF 化合物,目前已经订购了 MUF 应用所需的模压设备。而因为三星是世界最大的存储器龙头企业,所以若三星也导入 MUF,那么 MUF 可能会成为主流技术,半导体材料市场也会发生巨大的变化。








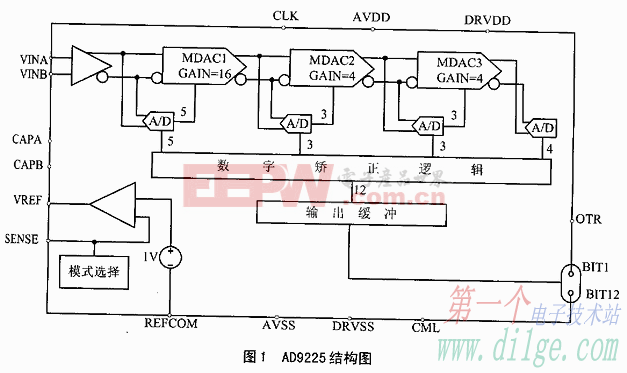



评论