氮化镓集成方案如何提高功率密度
氮化镓(GaN)是电力电子行业的热门话题,因为它可以使得80Plus钛电源、3.8 kW/L电动汽车(EV)车载充电器和电动汽车(EV)充电站等设计得以实施。在许多具体应用中,由于GaN能够驱动更高的功率密度和具有更高的效率,因此它取代了传统的MOSFET晶体管。但由于GaN的电气特性和它所能实现的性能,使得使用GaN元件进行设计时,要面临与硅元件截然不同的一系列挑战。
本文引用地址:https://www.eepw.com.cn/article/202204/432827.htmGaN场效应晶体管包括耗尽型(d-mode)、增强型(e-mode)、共源共栅型(cascode)等三种类型,并且每种都具有各自的栅极驱动和系统要求。
GaN FET的内部结构
每种GaN电源开关都需要适当的栅极驱动,否则在测试时就可能发生事故。GaN器件具有极度敏感的栅极,因为它们不是传统意义上的MOSFET,而是高电子迁移率晶体管(HEMTs)。高电子迁移率晶体管的截面如图1所示,类似于MOSFET。GaN FET的电流不会流过整个衬底或缓冲层,而是流过一个二维的电子气层。

图1.GaN FET横向结构截面图
不当的栅极控制可能会导致GaN FET的绝缘层、势垒或其他的结构性部分被击穿。这不仅会造成GaN FET在对应系统条件下无法工作,还会对器件本身造成永久性损坏。这种灵敏度水平就需要用户认真考察不同类型GaN器件的特性及其广泛需求。HEMT也不具有传统掺杂的FET结构,该结构会形成PN结,进而产生体二极管。这也意味着没有内部二极管会在运行过程中被击穿或产生如反向恢复等的不必要的过程。
栅极驱动和偏置电源
增强型GaN FET在外观上与增强型硅FET极为类似。在栅极阈值电压为6V的大多数工作条件下,1.5 V至1.8 V的正电压为开启电压。但是大多增强型GaN器件的最大栅极阈值电压为7V,一旦超过就会造成永久性伤害。
传统的硅栅极驱动器可能无法提供适当的电压稳定度或无法解决高共模瞬态抗扰度问题,因此许多设计人员选择了诸如专为GaN FET设计的LMG1210-Q1的栅极驱动器。无论电源电压如何,LMG1210-Q1只提供5V的栅极驱动电压。传统的栅极驱动器需要对栅极偏置电源进行非常严格的控制才能不会在GaN FET的栅极产生过压。相比于增强型GaN FET,共源共栅型GaN FET则是一种在易用上的折衷方案,结构如图2所示。

图2.增强型与共源共栅耗尽型GaN FET示意图
GaN FET是一种耗尽型器件,意味着该器件在通常情况下导通,关闭时需要在栅极施加一个负的阈值电压。这对于电源开关来说是一个很大的问题,为此许多制造商在GaN FET封装中串接一个MOSFET。GaN FET的栅极与硅FET的源极相连,在硅FET的栅极施加开启与关闭栅极脉冲。
封装内串接硅FET的优势在于使用传统的隔离式栅极驱动器(如UCC5350-Q1)驱动硅FET可以解决许多栅极驱动和电源偏置问题。共源共栅型GaN FET的最大缺点是FET的输出电容较高,并且由于体二极管的存在,易受反向恢复的影响。硅FET的输出电容在GaN FET的基础上增加了20%,这意味着与其他GaN解决方案相比,开关损耗增加了20%以上。而在反向导通过程中,硅场效应管的体二极管会导通电流,并在电压极性翻转时进行反向恢复。
硅FET的输出电容在GaN FET原有的基础上增加了20%,这意味着与其他GaN解决方案相比,开关损耗增加了20%以上。此外在反向导通过程中,硅FET的体二极管会导通电流,并在电压极性翻转时进行反向恢复。
为防止硅FET的雪崩击穿,共源共栅型GaN FET需以70V/ns的转换速率工作,这也增加了开关交叠损耗。尽管共源共栅型GaN FET可以简化设计流程,但也限制了设计的可实现性。
通过集成可以得到更简单的解决方案
将耗尽型GaN FET与栅极驱动器和内置偏置电源控制进行整合,可以解决增强型和共源共栅型GaN FET在设计上许多问题。例如,LMG3522R030-Q1是一款650V 30mΩ的GaN器件,集成了栅极驱动器和电源管理功能,可实现更高的功率密度和效率,同时降低相关风险和工程工作量。耗尽型GaN FET需要在封装内串接硅FET,但与共源共栅型GaN FET的最大区别在于所集成的栅极驱动器可以直接驱动GaN FET的栅极,而硅FET则在上电时保持常闭状态启动开关。这种直接驱动可以解决共源共栅型GaN FET的主要问题,例如更高的输出电容,反向恢复敏感性和串联硅FET的雪崩击穿。LMG3522R030-Q1中集成的栅极驱动器可实现很低的开关交叠损耗,使GaN FET能够在高达2.2 MHz的开关频率下工作,并消除使用错误栅极驱动器的风险。图3显示了使用集成了LMG3522R030-Q1的GaN FET的半桥设置。

图3.使用UCC25800-Q1变压器驱动器和两个LMG3522R030-Q1 GaN FET的简化GaN半桥配置
驱动器的集成可以缩小方案尺寸,实现功率密集型系统。集成降压-升压转换器还意味着LMG3522R030-Q1可以使用9V至18V非稳压电源,从而显着降低对偏置电源的要求。为实现系统解决方案的紧凑性且经济性,可以将LMG3522R030-Q1与UCC25800-Q1等超低电磁干扰变压器驱动器配合使用,可通过多个二次绕组实现开环的电感-电感-电容控制。使用高度集成的紧凑型偏置电源(如UCC14240-Q1 DC/DC模块)也可实现印制电路板内的超薄设计。
总结
结合适合栅极驱动器和偏执电源,GaN器件可以获得150V/ns的开关速度,极小的开关损耗和更小的高功率系统磁性尺寸。集成化的GaN解决方案可以解决很多器件级的问题,从而使用户可以专注于更广泛的系统级的考量。



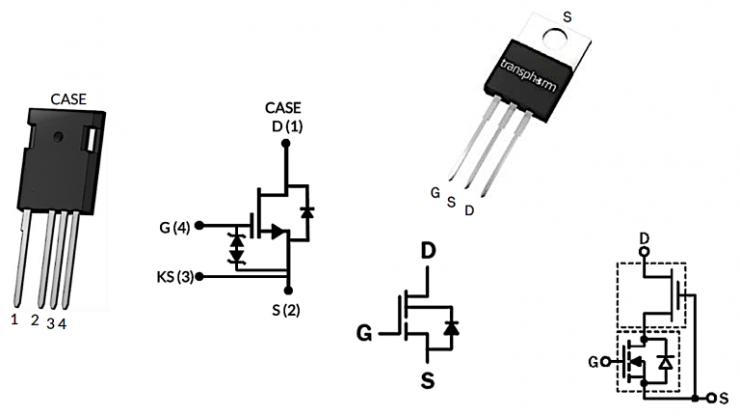
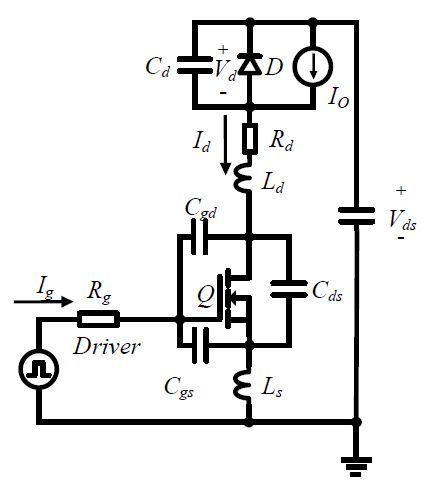



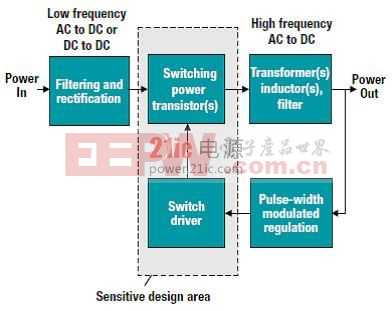



评论