IC 的热特性-热阻
摘要
本文引用地址:https://www.eepw.com.cn/article/201610/308163.htmIC 封装的热特性对IC 应用和可靠性是非常重要的参数。本文详细描述了标准封装的热特性主要参数:热阻(ΘJA、ΘJC、ΘCA)等参数。本文就热阻相关标准的发展、物理意义及测量方式等相关问题作详细介绍,并提出了在实际系统中热计算和热管理的一些经验方法。希望使电子器件及系统设计工程师能明了热阻值的相关原理及应用,以解决器件及系统过热问题。
1 引言
半导体技术按照摩尔定理不断的发展,集成电路的密度越来越高,尺寸越来越小。所有集成电路在工作时都会发热,热量的累积必定导致半导体结点温度的升高,随着结点温度的提高,半导体元器件性能将会下降,甚至造成芯片损害。因此每个芯片厂家都会规定其半导元体器件的最大结点温度。为了保证元器件的结温低于最大允许温度,经由封装进行的从IC 自身到周围环境的有效散热就至关重要。在普通数字电路中,由于低速电路的功耗较小,在正常的散热条件下,芯片的温升不会太大,所以不用考虑芯片的散热问题。而在高速电路中,芯片的功耗较大,在自然条件下的散热已经不能保证芯片的结点温度不超过允许工作温度,因此就需要考虑芯片的散热问题,使芯片可以工作在正常的温度范围之内。
2 热特性基础
在通常条件下,热量的传递通过传导、对流、辐射三种方式进行。传导是通过物体的接触,将热流从高温向低温传递,导热率越好的物体则导热性能越好,一般来说金属导热性能最好;对流是通过物体的流动将热流带走,液体和气体的流速越快,则带走的热量越多;辐射不需要具体的中间媒介,直接将热量发送出去,真空中效果更好。

3 热阻
半导体器件热量主要是通过三个路径散发出去:封装顶部到空气,封装底部到电路板和封装引脚到电路板。
电子器件散热中最常用的,也是最重要的一个参数就是热阻(Thermal Resistance)。热阻是描述物质热传导特性的一个重要指标。以集成电路为例,热阻是衡量封装将管芯产生的热量传导至电路板或周围环境的能力的一个标准和能力。定义如下:
热阻值一般常用表示,其中Tj为芯片Die 表面的温度(结温),Tx为热传导到某目标点位置的温度,P 为输入的发热功率。电子设计中,如果电流流过电阻就会产生压差。同理,如果热量流经热阻就会产生温差。热阻大表示热不容易传导,因此器件所产生的温度就比较高,由热阻可以判断及预测器件的发热状况。通常情况下,芯片的结温升高,芯片的寿命会减少,故障率也增高。在温度超过芯片给定的额定最高结温时,芯片就可能会损坏。

图1. 芯片热阻示意图
ΘJA 是芯片Die 表面到周围环境的热阻,单位是℃/W。周围环境通常被看作热“地”点。JA取决于IC 封装、电路板、空气流通、辐射和系统特性,通常辐射的影响可以忽略。ΘJA专指自然条件下 (没有加通风措施)的数值。由于测量是在标准规范的条件下测试,因此对于不同的基板设计以及环境条件就会有不同的结果,因此此值可以用于比较封装散热的容易与否,用于定性的比较。
ΘJC 是芯片Die 表面到封装外壳的热阻,外壳可以看作是封装外表面的一个特定点。ΘJC 取决于封装材料(引线框架、模塑材料、管芯粘接材料)和特定的封装设计(管芯厚度、裸焊盘、内部散热过孔、所用金属材料的热传导率)。对带有引脚的封装来说,ΘJC在外壳上的参考点位于塑料外壳延伸出来的1 管脚,在标准的塑料封装中,ΘJC的测量位置在1 管脚处。该值主要是用于评估散热片的性能。
注意ΘJC 表示的仅仅是散热通路到封装表面的电阻,因此ΘJC 总是小于ΘJA。ΘJC 表示是特定的、通过传导方式进行热传递的散热通路的热阻,而ΘJA则表示的是通过传导、对流、辐射等方式进行热传递的散热通路的热阻。
ΘCA 是指从芯片管壳到周围环境的热阻。ΘCA 包括从封装外表面到周围环境的所有散热通路的热阻。根据上面给出的定义,我们可以知道:ΘJA =ΘJC+ΘCA
ΘJB是指从芯片表面到电路板的热阻,它对芯片Die 表面到电路板的热通路进行了量化,可用于评估PCB 的传热效能。ΘJB包括来自两个方面的热阻:从芯片Die 表面到封装底部参考点的热阻,以及贯穿封装底部的电路板的热阻。该值可用于评估PCB 的热传效能。
从这里,我们可以看出,热量的传递主要有三条路径,第一:芯片Die 表面的热量通过封装材料(Mold Compound)传导到器件表面然后通过对流散热/辐射散到周围,第二:是从芯片Die 表面到焊盘,然后由连接到焊盘的印刷电路板进行对流/辐射散。第三:芯片表面热量通过Lead Frame传递到PCB 上散热。显然ΘJA 的值与外部环境密切相关。
Ψ 和θ 之定义类似,但不同之处是Ψ 是指在大部分的热量传递的状况下,而θ 是指全部的热量传递。在实际的电子系统散热时,热会由封装的上下甚至周围传出,而不一定会由单一方向传递,因此Ψ 之定义比较符合实际系统的量测状况。![]() JB是芯片Die 表面到电路板的热特性参数,单位是℃/W,热特性参数与热阻是不同的。相对于热阻
JB是芯片Die 表面到电路板的热特性参数,单位是℃/W,热特性参数与热阻是不同的。相对于热阻![]() JB 测量时的直接单通路不同,
JB 测量时的直接单通路不同,![]() JB测量的元件功率通量是基于多条热通路的。由于这些JB的热通路中包括封装顶部的热对流,因此更加便于用户的应用。
JB测量的元件功率通量是基于多条热通路的。由于这些JB的热通路中包括封装顶部的热对流,因此更加便于用户的应用。
热阻的测量是以JESD51 标准给出的,JEDEC 中定义的结构配置不是实际应用中的典型系统反映,而是为了保持一致性和标准性,采用标准化的热分析和热测量方法。这有助于对比不同封装变化的热性能指标。其标准环境是指将器件安装在较大的印刷电路板上,并置于1 立方英尺的静止空气中。因此说明书中的数值实际上是一个系统级别的参数。

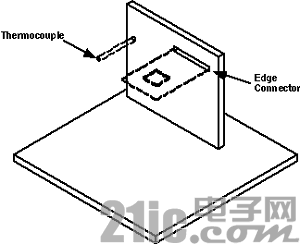
图2. JESD51 标准芯片热阻测量环境示意图
以TO263 为例,它包括一个标准的JEDEC 高K 板(2S2P)与1 盎司内部铜平面和接地平面。该封装是焊接到一个2 盎司铜焊盘上。这个底盘是通过导热孔联到1 盎司接地层。下图的侧视图中显示出的计算机模型中使用的操作环境。

图3. TO-263 热阻模型图
JESD 是一套完整的标准。具体的标准可以参见相关网站。
JESD51: Methodology for the Thermal Measurement of Component Packages (Single Semiconductor
Device)
JESD51-1: Integrated Circuit Thermal Measurement Method—Electrical Test Method (Single Semiconductor Device)
JESD51-2: Integrated Circuit Thermal Test Method Environmental Conditions—Natural Convection (StillAir)
JESD51-3: Low Effective Thermal Conductivity Test Board for Leaded Surface Mount Packages
JESD51-4: Thermal Test Chip Guideline (Wire Bond Type Chip)
JESD51-5: Extension of Thermal Test Board Standards for Packages with Direct Thermal Attachment Mechanisms
JESD51-6: Integrated Circuit Thermal Test Method Environmental Conditions—Forced Convection
(Moving Air)
JESD51-7: High Effective Thermal Conductivity Test Board for Leaded Surface Mount Packages
JESD51-8: Integrated Circuit Thermal Test Method Environmental Conditions—Junction-to-Board
JESD51-9: Test Boards for Area Array Surface Mount Package Thermal Measurements
JESD51-10: Test Boards for Through-Hole Perimeter Leaded Package Thermal Measurements.
JEDEC51-12: Guidelines for Reporting and Using Electronic Package Thermal Information.
4 常用热阻值¹
为了更好的计算和理解ΘJA ,一些新的参数不断被引入,ΘCU 是PCB 板上铜的热阻,ΘFR4 是典型FR4 板材PCB 的热阻,ΘVIA 是PCB 板上过孔的热阻,ΘSA 是PCB 板表面到周围空气的热阻。下图是一个典型的PCB 扩展热阻模型。
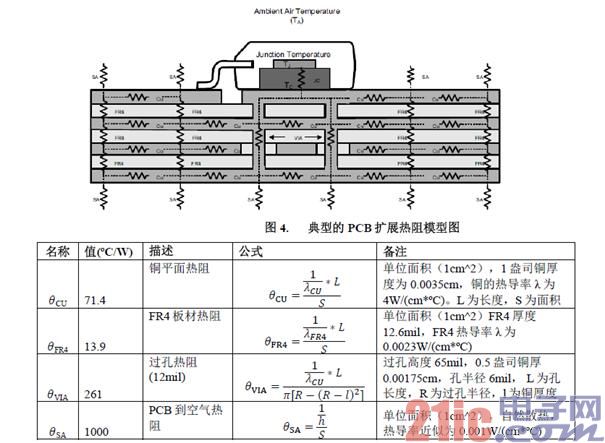
5 有效散热的经验法则
散热对芯片而言是非常重要的,下图以ADS58C48 为例,说明了在不同的温度下,芯片(高速ADC 为例)的性能会有不同的表现,在高温下性能往往恶化。因此在设计系统时必须高度关注芯片的工作温度,轻者会影响系统的性能,重者可能会造成芯片损坏。

图5. ADS58C48 在不同温度和工作电压下的特性
5.1 选择合适的封装
从芯片手册上可以知道封装的热阻,然后可根据给定的耗散功率和环境温度估算芯片的工作结温。我们可以考虑一个简单例子(以ADS58C48 为例),器件的AVDD 和DRVDD 均为1.8V,典型供电电流分别为:290mA 和207mA。最大容许结温为125℃。
功耗可以表示为:P=V*I=AVDD*Iavdd+DRVDD*Idrvdd=0.522+0.373=0.895W
结温JA=24℃/W,设备工作在散热不良的密闭空间,环境温度为75℃。估算结温如下:
Tj=75+0.895*24=75+21.8=96.8℃
这个估算温度远远小于最大的结温温度,所以器件不会出现过热问题。
过程看上去很简单,但实际上很复杂。对于具体的IC,ΘJA 值与PCB 板的尺寸、散热方式(风冷还是自然冷却)、板的层数、每层板的铜的厚度以及芯片周边是否存在别的发热量很高的器件相关。通常我们可以根据热成像图片做实际热阻计算:比如根据热成像图片得到该器件的最高发热区域并且读出温度变化,然后根据在该芯片上的电流电压得到它的功耗即可得出实际的热阻参数。
5.2 尽可能大面积的PCB 覆铜
对提高散热性能来说,PCB 的表层和底层是理想的散热空间。更大的PCB,其可用于热传导的面积也就越大,同时也拥有更大灵活性,应在高功耗器件之间留有充分的空间。一般情况下,接地层铜的面积较大,能为PCB 散热提供极好的热通路。使用宽的导线甚至铜平面,在远离高功耗器件的地方布线,可以为散热提供高效的热通路。
为了进一步说明,我们选TPS75825(TO-263)作为例子。其中,平均输入电压是3.3V 下,平均输出电压为2.5V,平均输出电流为3A,环境温度55℃,空气流量为150 LFM和操作环境是相同的,如下文所述。忽略静态电流后,最大的平均功率:PDmax = (3.3 -2.5) V * 3A =2.4W
根据公式1 可知,ΘJA=(125-55)/2.4W=29℃/W
从下图可知,ΘJA 与铜散热面积对比,接地层需要2 平方厘米的面积去消散2.4W 的能量。
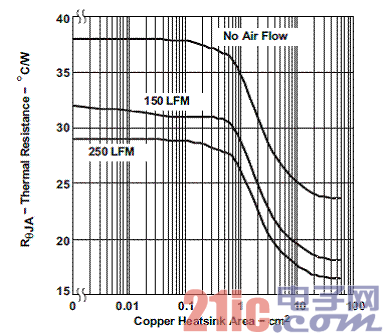
图6. 热阻和铜散热区面积的关系
如果已知ΘJA,则从公式1 中可以推出,该ΘJA 值下,不同PCB 面积对应的不同最大耗散功率。
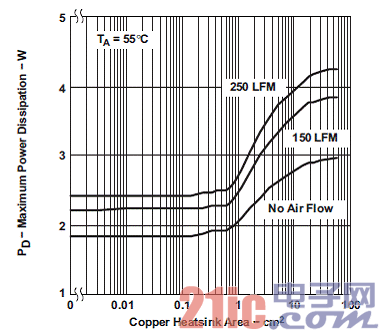
图7. 功耗和铜散热区面积的关系
5.3 增加铜厚度
PCB 的铜厚度增加,系统组件的热性能也就越高。铜平面,典型1 盎司铜的单位面积(1cm2)热阻![]() =71.4 ºC/W。在允许的范围内,建议使用更重的铜平面,可以有效的降低热阻。当采用2 盎司铜的时候,单位面积的热阻就降低为:
=71.4 ºC/W。在允许的范围内,建议使用更重的铜平面,可以有效的降低热阻。当采用2 盎司铜的时候,单位面积的热阻就降低为: =35ºC/W
=35ºC/W
5.4 用散热焊盘和过孔将多层PCB 连接
合理安排PCB 多层的堆叠关系和布线,也会增加用于热传导的铜的总比重。芯片下方的PCB 上的散热过孔有助于热量进入到PCB 内部各层,并传导至电路板的背部。
一般情况下,热焊盘都是接地焊盘,因此内部接地层和表面接地层是最常用的最方便的散热平面。典型的半盎司铜厚的12mil 的过孔的热阻是261ºC/W。因此在热焊盘下面用尽可能多的过孔形成矩阵。这些过孔尽可能的连接多的PCB 铜层,可以有效的进行散热,将大大提高散热效率。
以ADS62C17 为例,手册上为大家提供了参考的过孔设计方案。允许在热焊盘下面以1mm为间隔,铺设49 个过孔,通过过孔和接地层连接在一起。7*7 的矩阵的过孔的热阻约为:261/49=5.33 ºC/W。
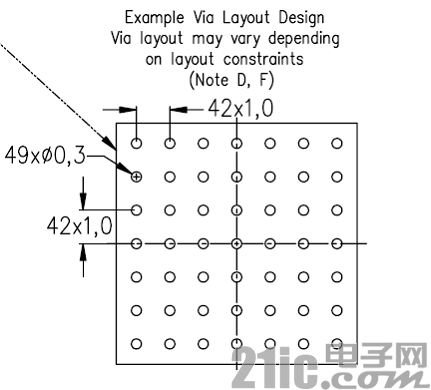
图8. ADS62C17 建议过孔方案
5.5 合理的散热结构,不影响散热路径,便于热能的扩散
合理的PCB 散热布局可以有效的促进散热效率。PCB 板上的高散热器件应彼此分开,这种高散热器件的物理间隔可让每个器件的PCB 散热面积最大化,从而加快散热。发散元件周围尽量不要放高大元件,影响散热;从散热的角度,PCB 垂直放置时,散热的效果更好。此时建议将高散热器件放到PCB 的上端。
5.6 散热片的合理使用
专用导热散热片是芯片散热的一种极好方法。散热片一般位于与芯片相连的PCB 背部或芯片的顶部,并通过合适的界面导热材料与散热源连接。为了实现最优的性能,散热片最好连接到热阻阻抗低的路径上。
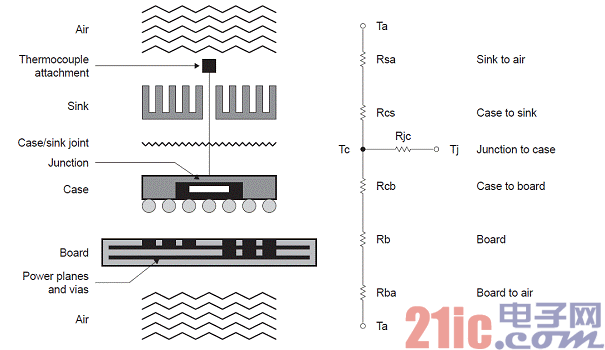
图9. BGA 芯片加散热片后热阻示意图
5.7 选取合适的截面导热材料
芯片和散热器间的热界面材料层是高功耗器件封装中热流的最大障碍。选择合适的材料来填充芯片和散热器间的界面对半导体器件的性能和可靠性都十分重要。界面材料通过填充气孔和密贴接合面不光滑表面形貌来降低发热和散热单元间接合面的接触热阻。

5.8 机箱散热
条件允许情况下,利用机箱散热是很好的方案。可以在机箱的底部,顶部开窗,充分利用烟囱效应形成气流散热;利用机箱内部风扇散热也是很好的方法。
5.9 不要在散热走线上覆阻焊层
阻焊层的作用是避免在焊接过程中焊料无序流动而导致焊盘引线之间桥接短路。在设计中有大功率器件需要通过电路板散热时也可以在阻焊层上开窗,以增加散热PCB 的面积。
6 总结
对于任何一个有效的设计,热设计都是必须要考虑的,应该在出现问题之前就充分考虑,减少出错的可能性。本文详细描述了标准封装的热特性的一些主要参数:热阻(ΘJA、ΘJC、ΘCA)等参数,并提出了在实际系统中热计算和热管理的一些经验方法。希望使电子器件及系统设计工程师能明了热阻的相关原理及应用,以解决器件及系统过热问题。
如需更多产品信息,请点击链接:
ADS58C48
www.ti.com.cn/hpa-hsp-dc-ads58c48-china001-contrib-pf1-cn
ADS62C17
www.ti.com.cn/hpa-hsp-dc-ads62c17-china001-contrib-pf3-cn














评论