半导体制造晶圆检测技术分析
中心议题:
本文引用地址:https://www.eepw.com.cn/article/193617.htm晶圆自动检测方法
缺陷检测管理的趋势
在线监测方法的技术优势
自从1980年代起,半导体制造业广泛采用了晶圆自动检测方法在制造过程中检测缺陷,以缓解工况偏差和减低总缺陷密度。尽管早期良率管理的重点是检测可能的最小缺陷,目前的环境则要求改变检测和后处理技术,这将导致以有效方式识别与良率相关的缺陷。制造业要求高灵敏度检测器件上最关键区域及后检测技术的智能途径,它利用领先技术产生突出缺陷数据中大多数重要问题的缺陷pareto图。需要这些方法来满足半导体公司的技术和财务目标。
新环境中的老方法
半导体制造中广泛采用晶圆自动检测系统已逾30年。在线晶圆检测有助于推进制造技术的发展,它能早期检测到工艺中的缺陷,从而减少开发时间并防止产出超时。过去,检测缺陷的能力是主要关注点之一,但现在的要求改变了。近几年来,每一晶圆的缺陷计数迅速增长至每一晶圆多达100万个缺陷,这是因为晶圆尺寸变大,同时检测技术灵敏度更高了(图1)。虽然总检测计数增加及关键缺陷尺寸变得更小,这一时期缺陷检查的典型策略并未改变,尤其是在随机取样占主导的缺陷检查区域。这种情况能产生常与干扰缺陷在一起的缺陷pareto图(图2)。
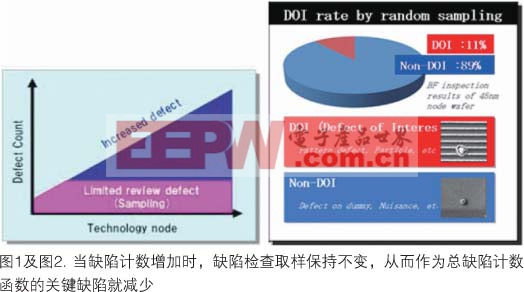
缺陷检测管理的趋势
传统的在线监控策略主要关注像随机微粒这样的随机缺陷。尽管检测随机微粒很重要,但更先进的技术节点出现了很难检测的系统缺陷(图3)。即使检测后,从大量缺陷计数中识别这些缺陷也颇具挑战性,每晶圆50个缺陷的取样率仅是105个缺陷数据的0.05%。随着系统缺陷的增加,人们更多关注识别工艺开发早期的作图问题以减少产品推出周期。

一些方法,包括焦点曝光矩阵(FEM)或PWQ(工艺窗口限定)等,正被用于识别系统性作图问题。同样,器件开发过程中发现的边际图形也要求受监控,以检测可能引起工艺变化和交互作用的失效。为达到这一目标,采用部分设计夹作为库来有效地监控关键图形类型。这一方法中,每个边际图形的设计夹可以注册在库中,任何这种图形失效的发生可有效地被捕捉和分类。
方法:思路的重大改变
为了提高监测和识别关键缺陷的效率,必须采用新方法。依赖简单的缺陷过滤和基于大小的缺陷次序是不够的。为了取得最佳的检测和鉴评预算,必须对检测设置与鉴评策略二者使用新的知识信息。从设计和模拟得到的关键区域和热点这样一些知识信息可以插入检测方略中,优化可用的检测容量。在完成检测过程中和完成后,基于多重检测结果的缺陷过滤和分类使用户能快速识别新缺陷,有效地量化已知的缺陷类型。利用设计空间中缺陷邻近位置的信息(此处,设计的复杂组成是了解的),可以较好地评估每一缺陷的良率相关性,提供缺陷的排序(图4)。
![]()
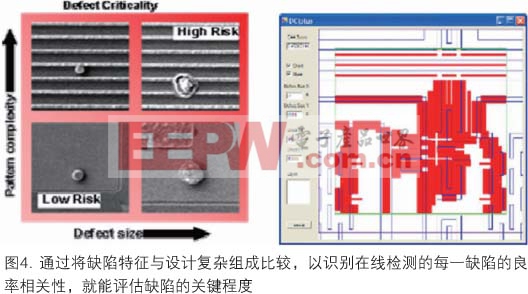
用与设计相关的检测设置,现在可以产生更智能化的检测菜单,注意力集中在最重要的芯片区域。这一技术已成功地在开发和生产工厂中进行了试验。引入新方法后,缺陷识别更有效,因而能通过分析实验结果减少工艺开发时间(图5)。由于能方便地监控关键结构,就可以评估每一组实验,以便选择刻印图形结果最好的工艺条件。
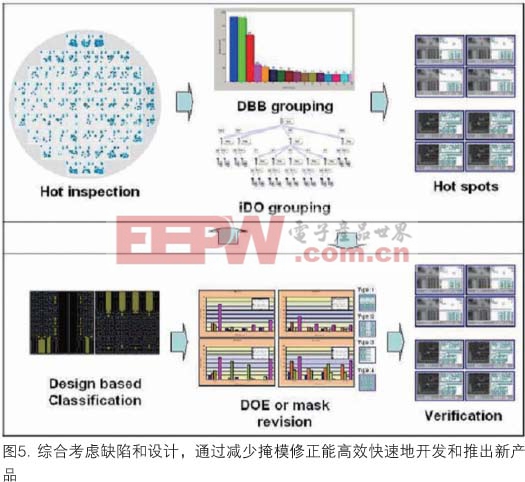
采用在线检测新方法,现在已能以系统性方法识别缺陷问题。在要求技术优势和运作效率二者均有竞争力的环境下,必须实施新方法使可用于缺陷管理的资源最大化。缺陷检测不再需要处于单独在工厂中的封闭模式(silomode),设计人员、光刻和缺陷工程师也必须利用新提供的技术来有效地识别随机缺陷和图形缺陷。进而,在线检测现在已与设计相关联,能优化检测预算,从而检测最至关重要的区域。当半导体制造在竞争中继续向前推进时,综合考虑缺陷和设计将是缺陷管理的大趋势。






评论