典型工艺介绍
光刻技术类似于照片的印相技术,所不同的是,相纸上有感光材料,而硅片上的感光材料——光刻胶是通过旋涂技术在工艺中后加工的。光刻掩模相当于照相底片,一定的波长的光线通过这个“底片”,在光刻胶上形成与掩模版(光罩)图形相反的感光区,然后进行显影、定影、坚膜等步骤,在光刻胶膜上有的区域被溶解掉,有的区域保留下来,形成了构成电路版图的图形。
本文引用地址:https://www.eepw.com.cn/article/168108.htm光刻是制造集成电路的关键工艺技木。通常,光刻次数越多,就意味着工艺越复杂。另一方面,光刻线条越细,意味着工艺线水平越高。在集成电路生产过程中光刻工艺是完成在整个硅片上进行开窗、制作元器件图形的工作,如对各层薄膜的图形及掺杂区域等进行开窗,光刻都起着决定性的作用。通常可用光刻加工的特征线宽、光刻次数及所需掩模的个数来表示某类集成电路生产工艺的难易程度。
光刻是集成电路制造过程中最复杂和最关键的工艺之一。光刻工艺利用光敏的抗蚀涂层(光刻胶)发生光化学反应,结合刻蚀的方法把掩模版图形复制到圆硅片上,为后序的掺杂、薄膜等工艺做好准备。在芯片的制造过程中,会多次使用RH-IX2135SCZZ光刻工艺。现在,为了制造集成电路要采用多达20~30次光刻和多至几百道工艺、工序步骤,使得芯片生产周期长达一个月甚至更久。目前光刻已占到集成电路总的制造成本的1/3以上,并且还在继续提高。特征尺寸越精细,集成电路水平越高,工艺技术的难度也越高。例如90nm或65nm集成电路,其特征线宽仅相当于人的头发丝的千分之一,在相应集成电路的制造的近30次光刻中,大约会有十几次光刻需要在硅片上准确地以特征线宽的精度完成器件图形的复制和套刻,光刻设备不仅要有极高的精度,同时还要以几乎是100%的成品率实现快速、有效的规模生产。一台90nm的步进投影光刻机价值1000万~2000万美元,同时还要求具有相应特定技术水平的显影、刻蚀、表面处理的设备和在线检测仪器,对厂房的温、湿度,空气中的尘埃颗粒度和密度,水的纯度等都有十分严格的规定和明确的标准。
扩散与离子注入
半导体是一种导电能力介于导体与绝缘体之间的一种材料,它对杂质非常敏感,1015个原子/cm3浓度的杂质就可以明显地改变半导体的导电类型和电阻率,这意味着在几百万个硅原子中掺人一个奈质原子,硅的导电能力就会有明显的变化。体硅CMOS集成电路技术在很大程度上可以被看作是掺杂半导体技术。扩散与离子注入是硅半导体技术中最重要的掺杂技术。
MOS场效应晶体管是集成电路中最基本的元件。在一个N阱CMOS的制作过程里,除了构成P型硅的杂质是在晶圆片的制作时所加入的之外,所有其他的P型或N型半导体区域,如用来建立PMOS的N阱,PMOS与NMOS的源极与漏极和位于场氧化层(Fieldoxide,简称为Fox)下方的“隔离带”等,都需要采用掺杂工艺来加工。在现在的超大规模集成电路工艺中,最主要的掺杂技术,有传统式的“扩散法”和较先进的“离子注入法”等。前者是利用杂质在高温下(约800℃以上)从高浓度区往低浓度区的扩散,来进行硅掺杂的,而后者则是将杂质以高能离子的形式,直接注入硅中的方式来进行的。虽然两者的掺杂方式并不完全相同,但目的则是一致的——对半导体进行杂质的掺入,以形成各种N型或P型的半导体区域。
扩散是一种十分重要的掺杂技术,它是在800~1250℃(甚至更宽)的高温下,在专用的扩散炉中完成的。它的特点是掺杂浓度、掺杂深度分布范围广,特别是掺杂深度可以实现0.1~lOOμm.甚至更深,批量生产能力大,设备成本相对较低。但是要实现o1μm以下的浅结扩散十分困难,现在较多使用在0.35μm以上的集成电路、半导体分立器件特别是半导体功率器件的生产中。在先进集成电路,特别是纳米尺度集成电路的生产中,主要使用离子注入技术。
离子注入是另一种掺杂技术,离子注入掺杂也分为两个步骤:离子注入和退火再分布。离子注入是通过高能离子束轰击硅片表面,在掺杂窗口处,杂质离子被注入硅本体,在其他部位,杂质离子被硅表面的保护层屏蔽,完成选择掺杂的过程。进入硅中的杂质离子在一定的位置形成特定的分布。掺杂深度由注入杂质离子的能量和质量决定,掺杂浓度由注入杂质离子的数目(取决于注入剂量和时间)决定。同时,由于高能粒子的撞击,导致硅结构的晶格发生损伤。为恢复品格损伤,在离子注入后要进行退火处理。根据注入的杂质数量不同,退火温度在450—9500C之间,掺杂浓度大则退火温度高,反之则低。在退火的同时,掺入的杂质同时向硅体内进行再分布,如果需要,还可进行后续的高温处理以获得所需的结深和分布。
离子注入技术主要有以下几方面的特点。
(1)注入的离子是通过质量分析器选取出来的,选取的离子纯度高,能量单一,从而保证了掺杂纯度不受杂质源纯度的影响。
(2)注入剂量在1011~10l-离子/cm2的较宽范围内,同一平面内的杂质均匀度可保证在±1%的精度,比扩散好得多,离子注入技术的这一优点在超大规模集成电路制造中尤其重要。
(3)离子注入时,衬底一般是保持在室温或低于400℃。因此,像二氧化硅、氮化硅、铝和光刻胶等都可以用来作为选择掺杂的掩蔽膜。
(4)离子注入深度是随离子能量的增加而增加。因此,可以通过控制注入离子的能量和剂量,以及采用多次注入相同或不同杂质,得到各种形式的杂质分布。
(5)离子注入时的衬底温度较低,这样就可以避免高温扩散所引起的热缺陷。另外,由于注入的直进性,注入杂质是按掩模的图形近于垂直入射,这样的掺杂方法,横向效应比热扩散小得多。
(6)化合物半导体是两种或多种元素按一定组分构成的,它们不宜高温娃理,组分可能发生变化。采用离子注入技术,基本不存在上述同题,因此容易实现化合物半导体的掺杂。
在集成电路芯片生产制造过程中,还包括氧化、蒸发、溅射、化学汽相淀积、刻蚀、化学机械抛光等一系列基本工艺技术,它们都与光刻、扩散、离子注入相类似,具有高精度高难度的技术特点,相关的设备仪器,厂房设施,配套材料都有很高的要求。



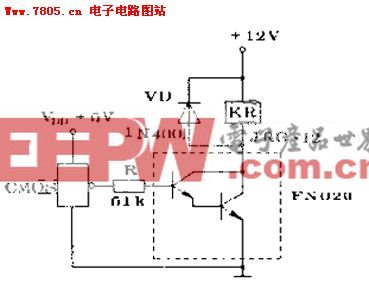




评论