SIP立体封装技术在嵌入式计算机系统中的应用
1 概述
本文引用地址:https://www.eepw.com.cn/article/139100.htm 目前大部分集成电路均采用平面封装形式,即在同一个平面内集成单个芯片的封装技术。由于受到面积的限制难以在同一平面上集成多个芯片。所谓立体封装是一项近几年来新兴的一种集成电路封装技术,突破了传统的平面封装的概念;它是在三维立体空间内实现单个封装体内堆叠多个芯片(已封装芯片或裸片)的封装技术(如图1所示)。近些年来随着微电子技术、计算机技术的迅猛发展,嵌入式计算机系统在各类系统级电子产品中得以广泛应用。各类移动设备、手持设备、民用电子产品的操作和控制越来越依赖于嵌入式计算机系统,而且要求系统不仅具有较高的性能,而且还要具有占用空间小、低功耗等特点。这就给嵌入式计算机系统提出了更高的要求。SIP立体封装芯片由于其集成度高,占用空间小,功耗低等特点,在未来的电子设备中将得到越来越广泛的应用。

图1 立体封装示意图
2 立体封装芯片的主要特点
(1) 集成密度高,可实现存储容量的倍增,组装效率可达200%以上;它使单个封装体内可以堆叠多个芯片,可以实现存储容量的倍增,比如对SRAM、SDRAM、FLASH、EEPROM进行堆叠,可以使存储容量提高8~10倍;
(2) 单体内可实现不同类型的芯片堆叠,从而形成具有不同功能的高性能系统级芯片,比如将CPU、SRAM、FLASH等芯片经立体封装后,形成一个小型计算机机系统,从而形成系统芯片(SIP)封装新思路;
(3) 芯片间的互连线路显著缩短,信号传输得更快且所受干扰更小;提高了芯片的性能,并降低了功耗;
(4) 大幅度的节省PCB占用面积,可以使产品体积大幅度缩小;
(5) 该技术可以对基于晶圆级立体封装的芯片进行再一次立体封装,其组装效率可随着被封装芯片的密度增长而增长,因此是一项极具发展潜力而且似乎不会过时的技术。
3 立体封装芯片技术发展状况
随着IC器件尺寸不断缩小和运算速度的不断提高,封装技术已成为极为关键的技术。封装形式的优劣已影响到IC器件的频率、功耗、复杂性、可靠性和单位成本。集成电路封装的发展,一直是伴随着封装芯片的功能和元件数的增加而呈递进式发展。封装技术已经经历了多次变迁,从DIP、SOP、QFP、MLF、MCM、BGA到CSP、SIP,技术指标越来越先进。封装技术的发展已从连接、组装等一般性生产技术逐步演变为实现高度多样化电子信息设备的一个关键技术。目前封装的热点技术为高功率发光器件封装技术、低成本高效率图像芯片封装技术、芯片凸点和倒装技术、高可靠低成本封装技术、BGA基板封装技术、MCM多芯片组件封装技术、四边无引脚封装技术、CSP封装技术、SIP封装技术等。
立体封装被业界普遍看好,立体封装的代表产品是系统级封装(SIP)。SIP实际上就是一系统级的多芯片封装,它是将多个芯片和可能的无源元件集成在同一封装内,形成具有系统功能的模块,因而可以实现较高的性能密度、更高的集成度、更低的成本和更大的灵活性。立体封装技术是目前封装业的热点和发展趋势。
控制系统的设计人员所面临的挑战是如何能实现高性能、高可靠、小型化,希望所采用的新一代器件能比前一代产品的尺寸更小、同时拥有更多、更强的功能。半导体业界正在这一领域努力,希望在进一步提高器件功能的同时,获得更小尺寸的器件封装结构,同时又能维持、甚至降低器件的整体成本。实践证明,三维集成的成本要比对芯片进行持续缩小的工程成本要低,因此,立体封装是实现设备小型化的理想技术途径,这是驱动立体封装技术发展的主要因素。
立体封装主要有三种类型,即埋置型立体封装、有源基板型立体封装、和叠层型立体封装。当前,实现这三类立体封装主要有三种途径:一种是在各类基板内或多层布线介质层中“埋置”R、C 或IC 等元器件,最上层再贴装SMC 和SMD 来实现立体封装,这种结构称为埋置型立体封装;第二种是在硅圆片规模集成(WSI)后的有源基板上再实行多层布线,最上层再贴装SMC 和SMD,从而构成立体封装,这种结构称为有源基板型立体封装;第三种是在平面封装的基础上,把多个裸芯片、封装芯片、多芯片组件甚至圆片进行叠层互连,构成立体封装,这种结构称作叠层型立体封装。目前只有第三种方式进入了实用阶段,而且掌握第三种立体封装技术的公司很有限,国外主要是法国3D PLUS公司、美国VCI公司,国内仅有江苏长电公司和珠海欧比特公司。
立体封装技术其核心是要在有限的空间内合理解决芯片之间的互连问题,目前叠层型立体封装的主要互连技术有以下三种方式:
(1) 在采用晶圆(裸片)堆叠放置的封装方式时,目前所用的互连技术是在焊区间使用引线键合的方法。随着芯片尺寸的缩小,引线键合方法受到了空间的限制,这主要是由于键合引线数量和密度,或是重叠式芯片制造而引起的。而键合引线的密度也会导致传输上的干扰和电子寄生。
(2) 作为引线键合的一种替代技术,形成穿透硅圆片的通孔结构可以大大缩短互连的距离,从而消除了芯片叠层在数量上的限制。这种采用直接互连的方法能提高器件的工作速度,该技术方法通常被称作为硅片贯穿孔(TSV)技术,但目前由于采用该项技术的工程成本很高,还不能利用该技术进行大批量生产。
(3) 标准封装堆叠(TSOP堆叠)和柔性PCB混合堆叠封装技术是三维立体封装是一种近些年来新兴的立体封装技术,其特色是将已封装的芯片(例如TSOP芯片)通过堆叠或柔性PCB堆叠后进行灌封,在经过切割成型、表面处理、激光雕刻实现芯片之间的互连;该技术具有很高的灵活性和适应性。值得一提的是,该技术可以对基于晶圆级立体封装的芯片进行再一次立体封装,因此是一项极具发展潜力而且似乎不会过时的技术。
4 SIP立体封装技术在嵌入式计算机系统中的应用
嵌入式计算机系统已广泛应用于航空、航天、工业控制、消费类电子等领域。
在航空、航天领域的箭载、船载、机载电子系统中,目前均采用开放式分布计算机系统,大部分的节点计算机为嵌入式计算机。随着箭载、船载、机载电子系统功能越来越强大,系统更复杂,节点计算机的数量也在逐步增加,势必造成电子系统的重量增加,从而导致动力系统的负荷增加,而需大幅度提升发动机的推力,使火箭、飞船、飞机的整体重量增加。最终将导致成本大幅度提升。因此,有效降低航空、航天领域的箭载、船载、机载电子系统中的嵌入式计算机系统的重量尤为重要,如何减小嵌入式计算机的体积和重量也越来越受到航空、航天领域设计人员的关注。
在工业控制及民用消费类电子领域,各种手持设备如掌上电脑、移动通信设备、各类手持机等都依赖于嵌入式计算机系统。如何较小嵌入式计算机的体积,是手持设备提升性能,降低成本,提高产品的市场竞争力的关键。
近些年来,随着集成电路的集成度越来越高,嵌入式计算机芯片的功能越来越强大,可集成存储器、串口、网口、USB、SPI、I2C等多种外设及接口,但由于嵌入式计算机芯片本身难以实现功率器件及大容量数据存储器的集成,因此在使用过程中外围接口的功率驱动电路以及大容量数据存储还需依赖平面板级设计来实现,这就给进一步提高嵌入式计算机系统的集成度,降低体积带来一定的限制。随着SIP立体封装技术的出现,为嵌入式计算机系统的进一步集成创造了条件。SIP立体封装技术可改变嵌入式计算机系统传统的平面板级设计模式,将嵌入式计算机系统的处理器、存储器、外围功率驱动接口等在三维空间内进行集成,可有效降低器件对PCB板的占用面积,从而大幅度降低嵌入式计算机系统的体积,减轻电子系统的整体重量,降低整体设备的成本。
5 SIP立体封装嵌入式计算机模块简介
SiP微型计算机系统芯片是一种具有大容量存储及多种外设接口的计算机系统芯片;其内部不仅可集成微处理器、大容量的SRAM、FLASH或SDRAM,而且还可集成UART、GPIO、I2C、SPI、网络等多种外围接口,使之构成一个功能强大的计算机系统。
在芯片设计时,一般情况下按照系统各部分的功能,将系统划分为处理器层、存储器层、外设接口层等。各层在垂直方向上进行堆叠,再将各层之间需要连接的信号互连起来,最终构成一个完整的计算机系统模块(如图2所示)。采用SIP立体封装技术构成的嵌入式计算机系统模块,和传统的平面板级系统节省PCB占用面积达80%以上,可大幅度缩小嵌入式计算机系统的体积和重量。而且由于系统各部分之间的连接线路大幅缩短,从而系统的运行速度、抗干扰特性、功耗等均有显著改善,可靠性大幅度提升。
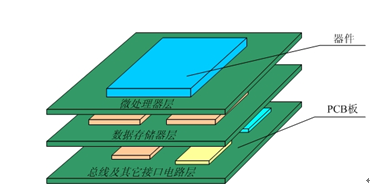
图2 SIP立体封装嵌入式计算机模块堆叠示意图
珠海欧比特公司根据航空、航天领域的需求,开发了基于SIP立体封装技术的嵌入式计算机系统模块。该模块集成了SPARC V8架构的S698-T SOC芯片、SRAM、FLASH ROM、1553B总线接口、ARINC429总线接口、RS232接口、GPIO、AD转换接口等。用户仅需要很少的外部元件(电源、接插件)即可作为1553B总线节点计算机使用(其结构如图3所示)。该计算机系统模块预留了外部总线接口,用户可方便地进行系统扩展设计。该模块可以替代原来的一块或数块电路板,甚至可以替代原来的一台计算机。
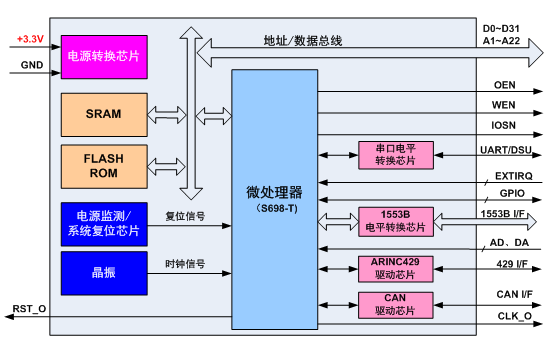
图3 总线型SIP立体封装微型计算机系统芯片构成框图
该计算机系统模块采用四层堆叠结构,采用144脚QFP封装,外形尺寸如图4所示。
(1) 第一层主要包括:处理器、晶振、内核电源转换芯片等;
(2) 第二层主要包括:2片1M×16bit 数据SRAM;
(3) 第三层主要包括:1片2M×16bit程序FLASH;
(4) 第四层主要包括:1553B电平转换、RS232电平转换、系统复位电路等。

图4 SIP立体封装微型计算机系统芯片外形尺寸图
6 结束语
综上所述,SIP立体封装是一项新兴的立体封装技术,虽然目前该技术还处于初期发展阶段,其产品应用还局限于航空、航天、军事及高端工业控制领域,但随着技术的进步,材料成本和生产效率的逐步提高,未来几年内,将广泛应用于各类嵌入式计算机系统中,具有非常广阔的市场前景。
参考文献:
[1] 珠海欧比特控制工程股份有限公司. VDS25632VQ12使用说明书. 2011.
[2] 珠海欧比特控制工程股份有限公司. VDSD51208VQ133使用说明书. 2011.
[3] 珠海欧比特控制工程股份有限公司. S698-T芯片用户手册. 2011.



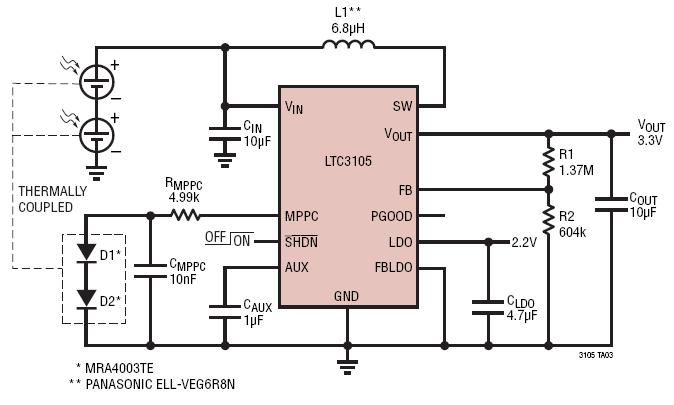




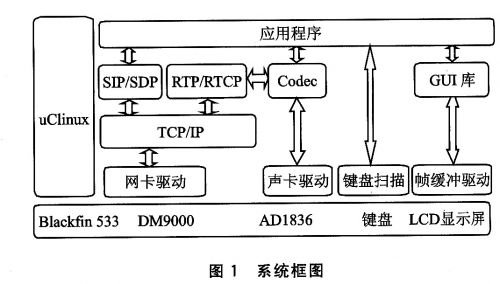

评论