新一代0.30毫米间距芯片级封装(CSP)面临的组装和设计挑战
在证明印刷电路板设计和流程设置可以实现可接受的Cp和Cpk数字以带来良好的良率之后,在不同模板和印刷参数和最佳的组合上进一步的研究。在研究(图6)中显示超高的Cp和Cpk数字和100%的组装良率。所有Cp和Cpk使用Minitab软件计算,使用Minitab的真正Cp和Cpk是Pp和PpK,因为这是整体计算功能。
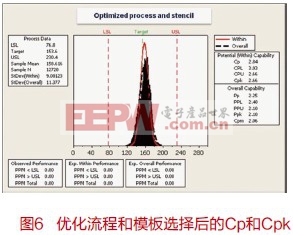
组装
所有组装在标准的小间距安装机器上进行,在3西格玛时精度为40微米。0.30毫米间距CSP中未检测到组装相关的缺陷,0.30毫米间距CSP在空气和氮气中进行了处理,良率相当,但使用浸润流程时,需要氮气以确保全面的浸润和坍塌。
回流焊
使用了标准的无铅回流焊温度曲线,回流焊在空气和氮气中完成,65次在217ºC和245ºC峰值温度之上。之前在0.40毫米间距的研究表明,180-217ºC之间快速的1.0ºC/s和更高的温度提升呈现更好的浸润效果,这在0.3毫米间距CSP上也得到了验证。在横截面,可以注意到一些互联出现枕头形焊接的倾向,而焊接连接没有浸润整个焊盘(图7)。这是在仅使用空气回流焊时担心的地方。根据这个结果,很明显0.30毫米间距CSP在焊液/焊膏浸润流程中需要氮气。如果0.30毫米间距CSP使用丝网印刷,空气回流焊可以完成,但流程窗口非常小,回流焊温度需要仔细的优化。尽管出现枕头形焊接,0.30毫米间距组装显示了良好的金属间(IMC)成型,厚度为2-4微米(图8)。

结论
有很多方式可以实现小型化,关键是有一套技术能够满足这些需求。根据产品的不同,可以考虑几个选项,而选择应基于数据而不是假设。0.30毫米间距CSP是可行的选择,但需要密切地控制设计指南、材料和组装流程。当在0.30毫米间距CSP上使用浸润流程时,目前需要氮气回流焊以实现高良率和高质量的焊接连接。 如果在0.30毫米间距CSP中使用丝网印刷,可以避免使用氮气,但模板厚度不能超过0.080毫米。包括模板选择、板托和板夹、焊膏选择和回流焊温度的丝网印刷流程需要优化和密切的流程控制。
参考文献:
[1]Geiger D A,Sjoberg J,Wong P,etal.FR-4基底上焊接倒装芯片的组装流程研究.APEX 2003会刊[C].加州Anaheim,2003
[2]Shangguan D.封装与板组装技术趋势及其对供应链的影响.第六届IEEECPMT大会的主题演讲论文[C].中国上海:2004
[3]Arra M,Geiger D,Shangguan D,etal.小间距CSP封装的SMT组装流程研究.焊接与表面安装技术[J].2004,16(3):16-21
[4]Geiger D A,Sjoberg J,Wong P,etal.基底上倒装芯片的组装流程研究.Advanced Packaging[J].2003(11)
[5]Geiger D A,Sjoberg J,Shangguan D,etal.FR-4基底上拥有不同PCB表面处理、底部充胶和焊液的无铅焊接倒装芯片.Semicon West 2004会刊[C].加州San Jose
pic相关文章:pic是什么
回流焊相关文章:回流焊原理 绝缘电阻测试仪相关文章:绝缘电阻测试仪原理





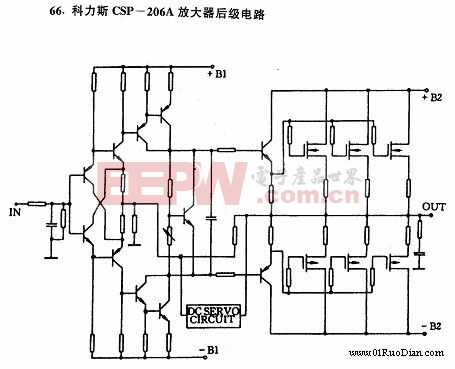
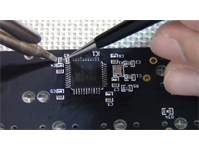
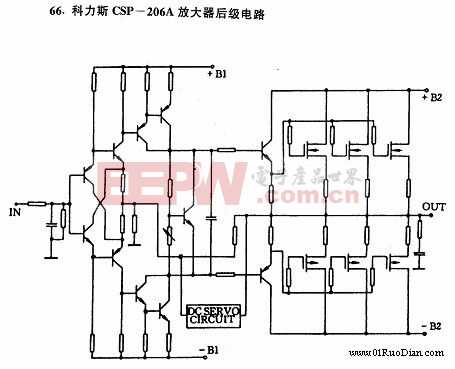




评论