新一代0.30毫米间距芯片级封装(CSP)面临的组装和设计挑战
浸液/膏选择
0.30毫米间距CSP的浸液选择是基于0.40毫米间距穿透模塑通孔(TMV)堆叠组装元件的开发活动。
在这些开发活动时,测试了15种不同的浸液/膏材料,主要聚焦浸润和消除氮回流焊的需求。如表1所示,不同材料之间存在重大差异,但它们在0.40毫米间距穿透模塑通孔(TMV)堆叠组装中都需要氮气回流焊。在评估时,顶端和低端零部件都进行了浸润,以评估流程的稳健性,但在常规生产中,只有顶端元件会浸润,而真正的良率会更高,但在空气回流焊下还不够高。

表1表明0.4/0.4毫米间距PoP需要氮气,材料A、G、H和N在氮气回流焊下显示出100%的良率。材料A、G、H和N被用于0.30毫米间距浸润流程,但浸润效果不可接受,即使电气良率在空气回流焊中达到100%。
底部充胶选择
0.3毫米间距CSP的底部充胶材料从流程和可靠性的角度来说很复杂。通常,CSP采用所谓的无充填材料,这从机械角度来说很好,但不适合热循环。另一方面,倒装芯片通常使用所谓的底部充胶,从散热角度来说更好一些,但更加昂贵且不可返工。
流程细节
在组装痕迹期间,我们使用了两种不同的0.30毫米间距CSP组装方法:丝网印刷和浸润。回流焊在空气和氮气中完成。
0.40毫米间距CSP的标准焊膏印刷流程最初使用了标准的电解抛光0.080毫米厚激光切割模板。在所有地方进行了自动焊膏检查(表2和图4、5),而自动模板清洁在每次印刷后进行。


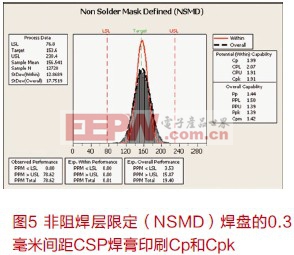
可以看到,阻焊层限定(SMD)和非阻焊层限定(NSMD)焊盘之间存在微小的差异。尽管我们希望获得更高的Cp和Cpk,结果仍令人乐观,为我们进一步的开发给出了很好的基线。阻焊层限定(SMD)的Cp和Cpk较低表明,包含所谓的窗口开口的NSMD焊盘的丝网印刷效果更高。对于未来的0.30毫米间距CSP印刷,我们决定使用所谓窗口设计的NSMD焊盘。在仅使用丝网印刷流程的0.30毫米间距CSP的大约400个完整组件的最初测试中,发现了一个问题,在SMD设计焊盘的焊桥上。
pic相关文章:pic是什么
回流焊相关文章:回流焊原理 绝缘电阻测试仪相关文章:绝缘电阻测试仪原理






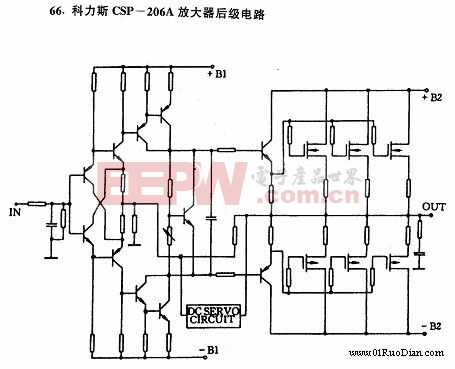
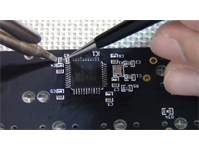


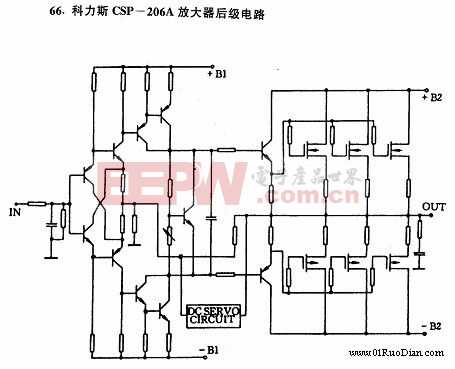

评论