High-NA不是通往2纳米时代的唯一道路
半导体行业正在重新评估其制造最先进芯片的长期路线图。高数字光圈(High-NA)光刻技术,曾被视为2 nm以下节点小型化的明确路径,现在正在与其他选项进行权衡。
尽管在光学领域取得了里程碑式的成就,但高NA所需的重大挑战和巨大的资本投资刺激了互补模式技术的平行发展。事实上,这些技术作为竞争和实用的替代品正在获得牵引力。
这不是对光学进步的拒绝。这是一个多方面工具包的务实拥抱,其中材料科学,物理学和创新过程的进步融合在一起,以克服强大的障碍。
High-NA拥有4亿美元的未来节点生产价格标签,代表了世界上最先进和最昂贵的芯片制造机器。它由ASML构建,承诺压缩波长,更宽的镜头和8纳米分辨率。较高的NA聚集更多的光线以实现更精细的图案化,但它并没有扩大镜头,而是减少了成像场。
220 wafers per hour最新的高NA扫描仪每小时可处理220个晶圆。英特尔公司是第一家运行High-NA扩展逻辑和内存设备的公司,但许多其他公司可能会来。
除了追求尖端的光学工具,一个务实的焦点正在出现。工程师们现在正在倡导优先考虑成本效益和可制造性的替代方案。这包括消除过高的洁净室改造,增强结构稳定性,推进花粉设计以更好地透光,并减少对复杂晶圆缝合的依赖。替代方法越来越被认为是现代芯片设计异构集成环境中针对目标应用的重要实用解决方案。
深紫外不太可能的复兴
也许最令人惊讶的发展是深紫(DUV)浸入式光刻术的重新相关性。曾经被认为是一种接近过时的技术,DUV已被证明是不可或缺的。这种长寿证明了其过程成熟度以及支持它的庞大现有基础设施。
通过改进多模式技术,使用顺序的石刻循环,工程师现在可以实现远低于光学分辨率极限的俯仰。该工艺从193 nm光学器件中提取前所未有的容量和性能,通过重复和精确的曝光实现更精细的性能。
基于空间的流,如自对齐双图案(SADP)和自对齐四重图案(SAQP),将结构细分为越来越紧密的几何形状。根据半导体工程公司的一份报告,这些方法将DUV推到了其标称的40 nm半间距极限之外,通过精确的覆盖控制和严格的检查提供20 nm及以下。
在更广泛的蚀刻工艺系列中,间隔技术补充了像litho-etch-litho-etch(LELE)这样的间距分裂方法,但设计侧并发症较少,并且在扩展NAND闪存和finFET结构方面取得了成功。通过使用沉积和蚀刻循环来形成侧壁间隔器,SADP和SAQP允许芯片制造商在不依赖更昂贵的曝光步骤的情况下复制几何形状。
在半导体制造国际公司(SMIC),对7纳米器件的独立审计证实,仅使用DUV策略,使用积极的多模式而不是高NA可以提供功能齐全的芯片。TechInsights对华为麒麟9000S处理器的拆解清楚地表明,reserved exclusively for High-NADUV仍然能够生产被认为专门用于High-NA的先进节点。
纳米印迹:机械范式转变
纳米印迹光刻(NIL)采用与传统光刻术截然不同的方法。与使用光投射图像相比,NIL使用主模板将图案物理地标记为低粘度电阻,并通过UV光和热固化来硬化。这种直接的机械传输完全避开了光的衍射极限,以及光子拍摄噪声等光学方法所固有的相关问题,以及越来越复杂的光学接近校正需求。
最近的进步推动了NIL从实验室的好奇心转向生产就绪的制造技术。佳能(Canon),尤其是中国公司Prinano等公司,已经开发出了值得生产的工具。Prinano 的 PL-SR 系统适用于 300 mm 晶圆,其性能可打印 10 nm 以下,覆盖精度小于 2 nm。固有的优势,包括大大降低刀具成本,最低能耗和缺乏繁琐的激光和光学系统,使其对高容量,重复的光刻技术具有吸引力。
在特定领域,NIL的价值主张最引人注目。
Memory:内存:NAND闪存和DRAM的常规密集阵列是单步印记过程的理想选择。
Photonics and silicon interposers:光子学和硅中间体:为波导和通过硅通孔(TSV)制造图案。
Compound semiconductors and novel substrates:复合半导体和新型基板:与光学光刻不同,NIL与基材的材料或地形无关,可在曲面、柔性或非硅表面上进行制造。
虽然模板缺陷,主耐久性和复杂逻辑层的叠加方面仍然存在挑战,但NIL已经成功地开辟了一个重要的利基市场。NIL不太可能在5纳米以下节点上取代高NA逻辑,它在相邻应用程序中的上升创建了一个并行缩放路线图。
图案塑造技术
承认高NA光刻是不完美的,有一类新的过程在曝光后纠正和完善元素。其中,应用材料的Centura Sculpta引入了几何形状,这是一种数字雕刻技术,可以减轻高NA光刻术固有的随机效应,同时减少对昂贵的多图案的依赖。Sculpta使用定向带状梁来拉长印刷功能,使尖端到尖端的间距比单个通过可以实现的更近。此外,它消除了桥梁缺陷,否则会降低产量。
Tokyo Electron’s Acrevia东京电子的Acrevia系统应用气体团束(GCB)技术来重塑和完善光刻后的模式。在初始曝光和干蚀刻之后,Acrevia以受控晶圆角度引导高能气体原子簇,以调整侧壁尺寸,平滑粗糙边缘并减少随机效应。通过降低线缘粗糙度和校正晶圆内变化,该工具减少了对双曝光层的需求。
光刻后优化功能作为纠正阶段,在曝光后改进配置文件,而不是重复它们。此类系统可无缝集成到当前的高NA流中,同时充当屈服和覆盖缓冲器。both yield savers and overlay buffers此外,它们提供了至关重要的平衡,减少了行业对光谱扩展的战略依赖。
混合剧本
高NA本质上是选择性的,由物理限制和经济权衡决定。其部署是战略工程选择,专注于非凡解决方案。其结果是一个范例,其中混合模式优化了整个平版印刷堆栈的成本,吞吐量和能力。
在混合模型中,每个工具都有自己的作用。High-NA 用于最关键的前端层,如鳍、门和触点。替代方案成为主力,定义关键互连和逻辑级别。DUV浸入用于密集的常规结构,如SRAM位细胞和选定的金属层。NIL在光子学和微电子机械系统中找到了自己的利基市场,其中成本和独特的材料多功能性具有变革性。至关重要的是,整个多工具流由后图案特征整流技术支撑。
这些系统共同作为通用的纠正措施,以提高关键维度的均匀性,并放宽性能要求和成本负担。混合方法展示了工程哲学的基本演变,拥抱系统级视角。
结论
几十年来,摩尔定律以可预测的公式指导行业:更小的晶体管,更快的芯片和更便宜的性能。High-NA作为其预期的延续,光学奇迹旨在将缩放扩展到2纳米以下的时代。今天,这种愿景仍然存在,但背景发生了变化。
成熟的技术可以重塑自己。摩尔定律弯曲。工程师仍然追求密度,但通过光学,机械和化学过程的马赛克。高NA可能会保持其在顶部的位置,但其主导地位受到芯片制造中同等重量的替代品的缓和。
这一战略扩张开启了半导体小型化的新时代。即将到来的创新将不依赖于单一的突破,而更多地取决于多种方法的战略协调,每种方法都适合特定需求。接下来是一个更全面的框架,其中经济可行性,可制造性和基础物理学在指导半导体工程进步方面具有同等的权威。



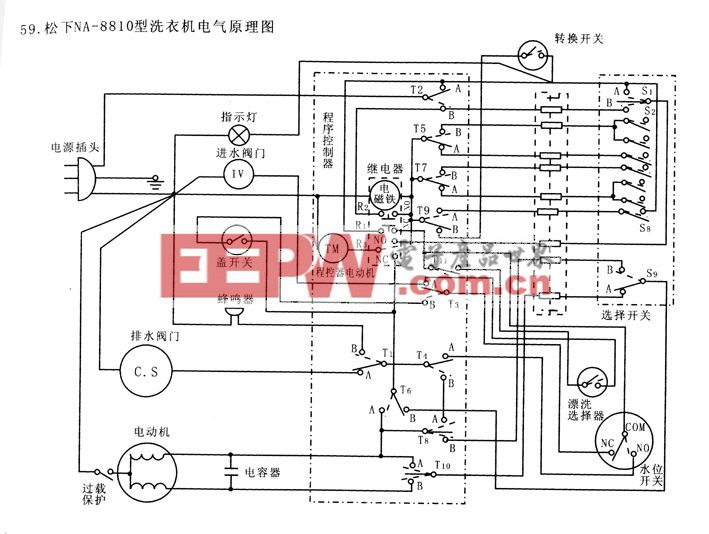
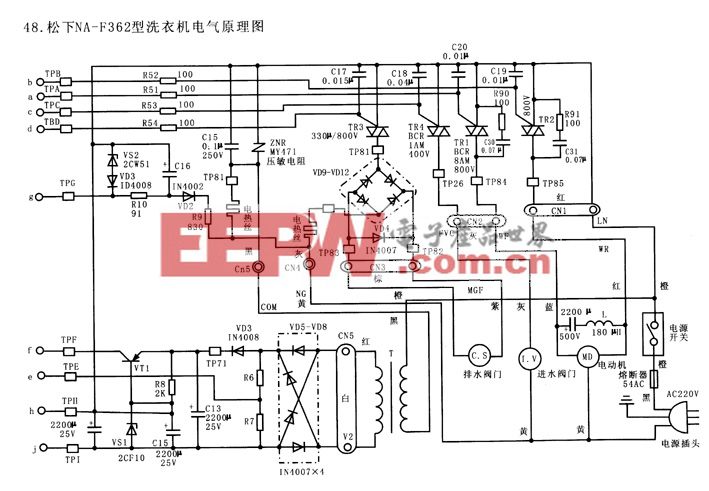
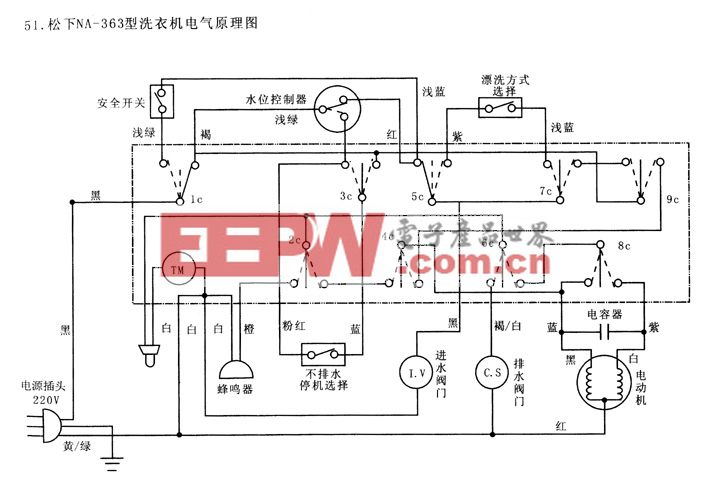
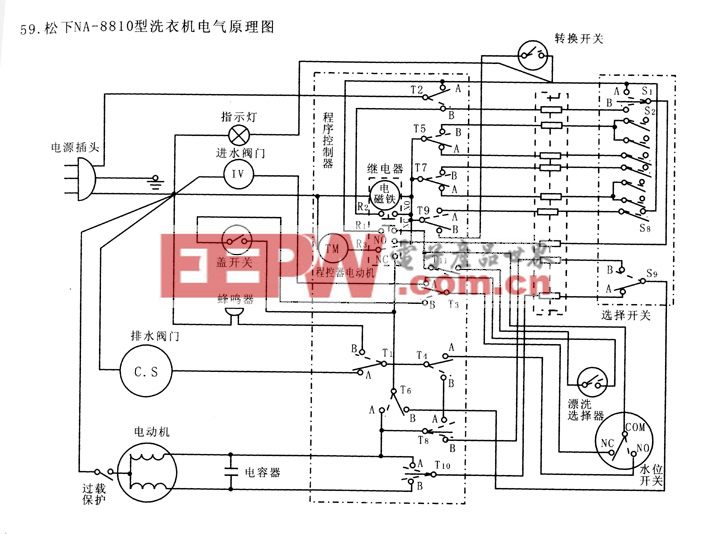

评论