CoWoS,是一门好生意
积电正在考虑涨价。
涨价的对象除了 3nm 先进工艺,还有 CoWoS 先进封装。明年 3nm 涨约 5%,而CoWoS 则高涨 10%~20%。
「不是 AI 芯片短缺,而是我们的 CoWoS 产能短缺。」这是台积电刘德音在接受采访时的回答。这项台积电默默培育十多年的技术,成为全球瞩目的焦点。
CoWoS 的巨大需求
凭借着 CoWoS 台积电几乎要成为全球最大的封装厂了。
先进封装占台积电整体业绩的比重逐步增高,相关毛利率也逐步提升。有分析师预计,台积电今年先进封装营收可以超越 70 亿美元,挑战 80 亿美元。先进封装目前约占台积电营收的 7%~9%,预计未来五年该部门的增长将超过台积电的平均水平。
这与台积电 CoWoS 封装技术不无关系。不少 AI 芯片都需要采用 CoWoS 的封装技术。

我们可以看下 CoWoS 的市场需求。打头阵的是英伟达,英伟达占整体供应量比重超过 50%。之前的 A100 和 H100 等用的都是 CoWoS 封装。之后的 Blackwell Ultra 产品,也是使用的台积电 CoWoS 封装工艺。而到了明年,英伟达将会推广采用 CoWoS-L 技术的 B300 和 GB300 系列。
AMD 的 MI300 用的是台积电 SoIC(3D)和 CoWoS(2.5D)两种封装技术。此外,博通、微软、亚马逊、谷歌对于 CoWoS 的也有一定的需求。据机构统计,AMD 和博通对 CoWoS 产能需求,合计的占比超过 27.7%。
目前,AI 芯片虽然没有采用最先进的制造工艺,但高度依赖先进的封装技术。全球半导体公司能否从台积电获得更先进的封装产能,将决定其市场渗透率和控制力。
因此有消息称,英伟达为了获得更多 CoWoS 产能,甚至表示愿意涨价,从而拉开与竞争对手的距离。不过这一消息也不算空穴来风,因为黄仁勋真的在公开场合强调:「台积电不只是生产晶圆,还处理着众多供应链问题。」他也认同目前定价过低,支持台积电涨价的举措。
从目前的 CoWoS 需求来看,即使到了明年,英伟达 50% 占比仍然不会变,而 AMD 在台积电的 CoWoS 封装订单量将小幅增加。据预估,英伟达对 CoWoS-L 工艺的需求可能会从 2024 年的 3.2 万片晶圆大幅增加至 2025 年的 38 万片晶圆,同比增长 1018%。
如此巨大的 CoWoS 需求,使得台积电频频提及扩产。
CoWoS 怎么走到这一步?
CoWoS 并非一飞冲天,而是默默前行。
先进封装不是一个新概念,追溯历史,2000 年是先进封装的转折点。从这一年开始,封装从传统的引线接合、倒装芯片方式,转向「晶圆级封装」。
早在 2008 年,台积电便成立集成互连与封装技术整合部门(IIPD)入局先进封装。
当时的台积电在金融危机的影响下,陷入了经营亏损。内忧外患下,张忠谋重新出山执掌台积电,同时请回已经退休的蒋尚义掌舵研发,开发先进封装技术进行差异化竞争。据蒋尚义回忆,最初提出先进封装而被公司(台积电)内部视为「笑话」。
2011 年,台积电开发出了第一代 CoWoS 封装技术,这是最初的起源。当时,CoWoS 使用硅(Si)衬底作为中间衬底(中介层),将多个芯片集成在一个封装体内,实现了更高的互连密度和更好的性能。

来源:台积电 CoWoS 纪事表
此时,人们对于 CoWoS 还是缺乏兴趣。第一个愿意采用成本高昂 CoWoS 技术的公司还是华为。台积电 CoWoS 的记事表中显示,在 2014 年海思 Hi1616 芯片采用了 CoWoS 工艺。
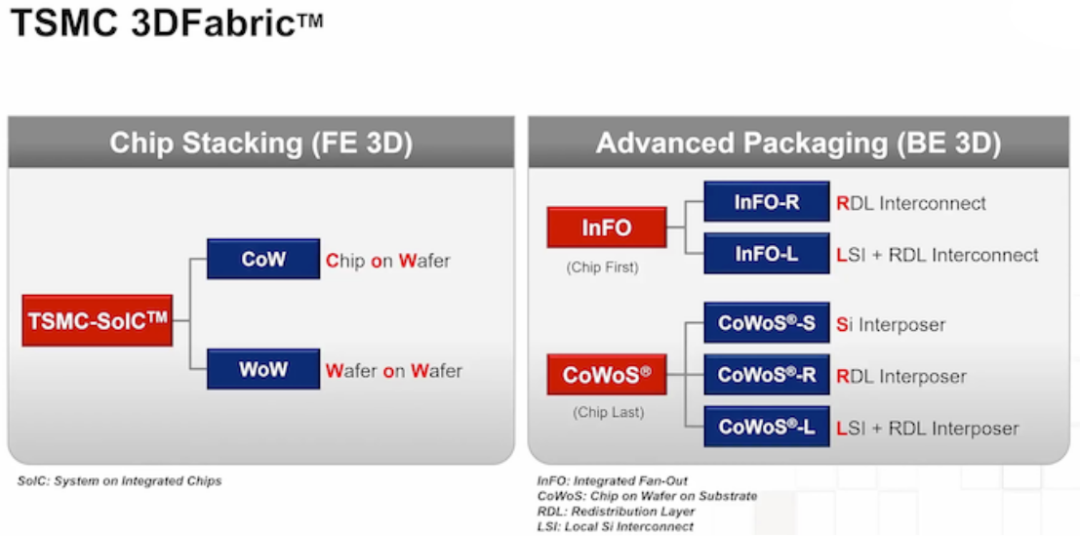
之后,CoWoS 封装不断改进发展。现在 CoWoS 是一种 2.5D 的整合生产技术,由 CoW 和 WoS 组合而来:CoW 就是将芯片堆叠在晶圆上(Chip-on-Wafer),而 WoS 就是基板上的晶圆(Wafer-on-Substrate),整合成 CoWoS。
据不同的中介层,台积电将 CoWoS 封装技术分为了三类:第一类,CoWoS-S,使用 Si 衬底作为中介层;第二类 CoWoS-R,使用重新布线层(RDL)作为中介层;第三类 CoWoS-L,使用小芯片(Chiplet)和 RDL 作为中介层。
在最新的演讲中,台积电高效能封装整合处处长侯上勇表示,作为能满足所有条件的最佳解决方案,台积电的先进封装重点会从 CoWoS-S 逐步转移至 CoWoS-L,并称 CoWoS-L 是未来蓝图关键技术。
侯上勇认为,由于顶部晶片(Top Die)成本非常高,CoWoS-L 是比 CoWoS-R、CoWoS-S 更能满足所有条件的最佳解决方案,且因为具有灵活性,可在其中介层实现异质整合,会有其专精的尺寸与功能。CoWoS-L 可兼容于各式各样的高效能顶级芯片,例如先进逻辑、SoIC 和 HBM。
都在眼馋 CoWoS 产能
台积电「吃肉」
台积电 CoWoS 产能全部在中国台湾,共有五座先进封测厂,分别位于龙潭、竹科、竹南、中科、南科。
南科嘉义园区第一座 P1 厂已于 5 月动工,不过在施工的过程中挖到了疑似遗址,现依据文资法进行相关处理。官方的回答是相关清理工作会在今年 10 月完成,台积电嘉科先进封装厂规划明年第 3 季装机不受影响。根据先前规划,台积电会在嘉义建设 2 座 CoWoS 先进封装厂,原计划 2028 年量产。
竹南先进封装厂(AP6)已经在 2023 年 6 月正式启用,经过了一年的运营,随着设备移至 AP6C 厂,已成为台积电最大的 CoWoS 基地,第三季 CoWoS 月产能翻倍,由 1.7 万片增至 3.3 万片。
除了竹南厂区 AP6C 外,原本仅承接 OS 后期制程的中科厂区也将逐步转为 CoW 制程,而嘉义厂区则正处于土地整备阶段,预计进度将比铜锣厂更快。
三季度,台积电还新增了 CoWoS 相关机台,并已要求设备厂商增派工程师,以充实龙潭 AP3 厂、中部科学园区 AP5 厂的产能。
在财报会议上,台积电已经明确表示了,其 CoWoS 产能会在 2024 年和 2025 年每年翻一番,但需求仍将超过供应。
现在,台积电先进封装产能在 2022 至 2026 年,年复合成长率达到 50%以上。台积电营运、先进封装技术暨服务副总何军表示:「以往 3 至 5 年盖一个厂,现在已缩短到 2 年内就要盖好,以满足客户需求。」
不过,台积电的 CoWoS 具体的产能在财报中并没有披露。
何军曾在秀出简报数据时,幽默提到:「现在简报都不敢放(先进封装产能)数字,因为客人都一直说(产能)不够,所以干脆不放具体数字了」。
目前台积电的 CoWoS 多是机构预测。具体来看,投行评估,到今年底,台积电 CoWoS 月产能可超过 3.2 万片,到 2025 年底月产能约在 7 万片上下。Digitiems 预测,到 2025 年第四季度末,台积电的月产能预计将增至 6.5 万片以上 12 英寸晶圆当量。花旗证券预估,台积电今年底的 CoWoS 产能为每月 3 万~4 万片,在买下群创南科四厂之后,到 2025 年底的 CoWoS 产能从 6 万~7 万片上调到每月 9 万~10 万片。
业内人士表示,台积电向设备制造商提供了 2026 年的机台需求并下了订单。明年的交货计划基本上已经排满了,目前台积电正在与设备供应商合作,敲定 2026 年的出货和安装计划。
日月光「喝汤」
作为真正的全球的第一大封测厂商,日月光接到了台积电溢出的 CoWoS 需求。
日月光也掌握了先进封装技术,成为台积电解决 CoWoS 封装产能紧张的最佳伙伴。其中,在 CoWoS-S 先进封装后段制程中,更是与台积电密切合作。
业内人士分析,到 2025 年,台积电在 CoWoS-S 后段的 oS 封装制程,可能外包其中 40% 至 50% 比重给日月光投控,可增加相关业绩规模约 1.5 亿美元至 2 亿美元。
为了 CoWoS 的生意,日月光最近开出了大笔的支出。
10 月份,日月光斥资近 200 亿新台币(约为 44.56 亿人民币)购买厂务与设备。今年下半年日月光累计投资超过了 470 亿新台币(约为 104.72 亿人民币),全年资本支出相对预测增加 30 亿美元。这么来推算的话,明年日月光的资本支持有望接近 40 亿美元。对于自身的斥资,日月光表示:「好戏在后头。」
日月光的豪掷巨资主要用来购买,CoW 所需的成熟制程曝光机设备机台,加上旗下矽品彰化二林厂及中科厂等据点都开始扩增无尘室及进驻设备机台。
要知道,日月光旗下矽品前段时间宣布,投资新台币 4.19 亿元,取得中科彰化二林园区土地使用权,扩充 CoWoS 先进封装。同时,矽品也进一步投资 37.02 亿元,向明徽能源取得云林斗六厂房土地,也是扩大 CoWoS 先进封装产能。
不止如此,日月光在 10 月上旬宣布,高雄市大社区 K28 厂预计 2026 年完工,主要目的就是要扩充 CoWoS 先进封测产能。
安靠「啃骨头」
一个月前,安靠和台积电一起宣布,双方已签署谅解备忘录,将携手合作为亚利桑那州引入先进封装与测试能力,进一步拓展该地区的半导体生态系统。
按照协议,台积电在亚利桑那州皮奥里亚计划建的工厂,会和 Amkor 签一个一站式的先进封装和测试服务合同。台积电会靠这些服务好好地支持自家客户,特别是那些用 台积电在凤凰城先进晶圆制造设备的客户。其中,涉及到的封装技术包括台积电的集成扇出型技术(InFO)和基板上晶圆上芯片技术(CoWoS)。
实际上,台积电在亚利桑那州规划 3 座厂的先进晶圆制程,结合安靠的先进封装产线,有助提升台积电当地厂区的附加价值,也可稳定接单。
结语
台积电吃肉、日月光喝汤、安靠啃骨头。
根据 Yole 最新发布的《2024 年先进封装状况》报告,预计 2023—2029 年先进封装市场的复合年增长率将达到 11%,市场规模将扩大至 695 亿美元。
DIGITIMES Research 称,受云端 AI 加速器需求旺盛推动,2025 年全球对 CoWoS 及类似封装产能的需求或将增长 113%。
从当下的需求来看,明年的 CoWoS 封装,也还是一门好生意。




评论