手机制造格局大变,本土厂商引领技术风潮
为了将手机制造提升到更高的水平,产业急需进行与传统工艺截然不同的技术革新。香港科技大学先进微系统封装中心主任李世玮博士以“未来手机与便携设备所需的革新封装技术”为题,详细介绍了新兴的封装技术,例如嵌入式器件和光波导传输。他表示,这些革新技术将来会在高密度有机机板上实现,它们将会为未来手机与便携设备的产品微型化和系统整合打开全新的局面。
本文引用地址:https://www.eepw.com.cn/article/100248.htm
IC封装技术发展五十年
香港科技大学机械学院刘汉诚博士在第二天的工作坊中为大家带来了3D IC、SIP、TSV等最新技术,并从诺基亚、三星、intel等厂商的案例分析这些技术的应用与前景。美国铟科技公司副总裁李宁成博士以及罗德威博士分别领衔也分别就小型化进程面临的挑战、手机制造的关键驱动技术、可制造性设计--创新性手机组装技术、便携设备中无铅焊点可靠性面临问题等具体问题与手机制造工程师进行了深入交流与探讨。
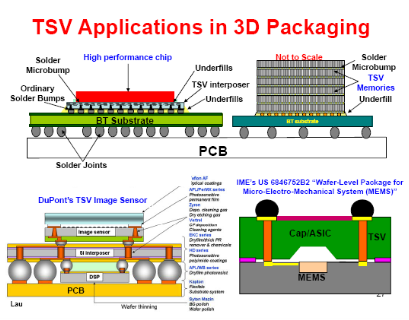
3D封装中的TSV技术
中国手机制造技术论坛由高交会电子展组委会和创意时代共同举办,是高交会电子展期间的重磅会议之一,自首次举办至今接待了近三千名手机制造行业管理人员及技术人员,已经成为中国手机制造行业的技术风向标。





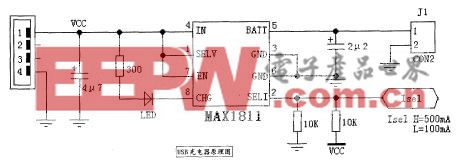



评论