混合集成电路步入SOP阶段 我国应加快研发
现在,国际上混合集成电路正在步入将系统级芯片、微传感器、微执行器和外围薄膜无源元件集成在一起,集微电子技术、光电子技术、MEMS(微电机系统)技术和纳米技术于一体的系统封装(SoP)阶段。
本文引用地址:https://www.eepw.com.cn/article/95586.htm电子产品的发展大趋势是高集成、高性能和高可靠性,而随着技术的提高将产品的“轻、薄、短,小”不断推向新的水平。有源器件经历了由电子管、晶体管、小规模集成电路、中规模集成电路、大规模集成电路和超大规模集成电路阶段,现在实现了系统级芯片(SoC),验证了摩尔定律“每18个月集成电路芯片上的晶体管数目增加1倍”的预言。无源元件也正在实现从有引线插装元件的形式向无引线表面贴装的小型化形式发展。
系统封装实现真正小型化
混合集成电路是一种小型化、高性能和高可靠的互连封装手段。我们国内将其称为二次集成,意指在半导体单片集成电路的基础上,实现包括外围无源元件在内的混合集成。混合集成电路是随着半导体和集成电路的发展而发展起来的。它经历了和半导体类似的发展历程。随着半导体集成电路规模的扩大,混合集成电路经历集成了中小规模IC(集成电路)的混合电路、集成了大规模和超大规模集成电路的多芯片组件(MCM)、集成了系统级芯片实现3D堆叠组装的封装内系统(SIP)等阶段。现在,国际上混合集成电路正在步入将系统级芯片、微传感器、微执行器和外围薄膜无源元件集成在一起,集微电子技术、光电子技术、MEMS(微机电系统)技术和纳米技术于一体的系统封装(SoP)阶段。
在许多情况下,遵循摩尔定律发展的IC仅占一个系统的10%,其余90%是组装在一两个印制电路板上的诸如电阻、电容、电感、天线、滤波器和开关这类分立无源元件,它们仍旧留在那里。要实现真正的小型化需要再前进一步,即用系统封装(SoP)来实现真正意义上的小型化。SoP超越了摩尔定律,它将IC与微米量级的薄膜型分立元件结合,将各种元器件内埋在一种非常小的新型封装里,以至于使手持系统成为具有从多功能到兆功能的设备。SoP不仅被开发用于无线通信、计算和娱乐装置,配上传感器,它还可以用来检测各种物质(有毒的和无毒的),包括周围环境中、食物里以及人体内的化学物质。该技术解决了系统中90%没有被集成化部分的体积问题(即所谓的90%问题)。
SoP技术代表了一种截然不同的系统构建方法。它缩小了笨拙的印制电路板体积并节省了许多元件,使它们几乎消失。实际上,SoP建立了系统集成的新定律。有人将其称为电子学第二定律。这个新定律是:随着元件尺寸缩小和印制电路板的消失,在一个SoP里元件密度每年大约增加1倍,而封装内系统功能的数量将以同样的比例增加。这样,SoP技术在系统小型化方面将比仅仅处理IC芯片上晶体管数目的摩尔定律产生更大的作用和影响。
自从1993年美国佐治亚理工学院提出SoP的概念后,他们与美国、日本、韩国和欧洲的100多家电子公司在这方面开展合作,包括AMD、Asahi、爱立信、Ford、日立、IBM,英特尔、Matsushita、摩托罗拉、NEC、诺基亚、三星、索尼和TI等公司。此外,70多位研究人员作为访问工程师来到他们的封装研究中心研究SoP及其应用。
迄今为止,至少有50家公司参与了SoP技术研究,将其应用到汽车、计算机、消费电子、军事电子和无线通信领域。该研究中心还为许多公司建造许多试验样机,将模拟、数字、射频、光学和传感元件做进单一封装,形成不同的组合。







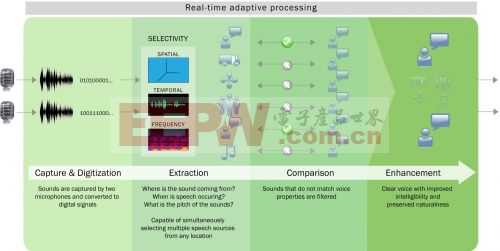


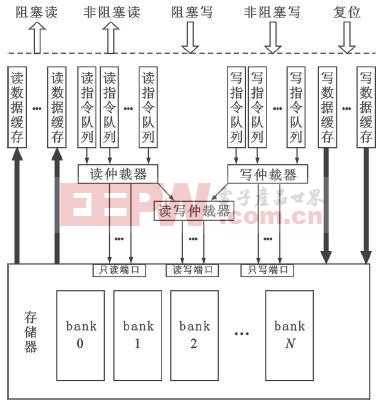



评论