多芯片组件技术
关键词:微电子封装,多芯片组件技术
1 引言
在某种意义上,电子学近几十年的历史可以看作是逐渐小型化的历史,推动电子产品朝小型化过渡的主要动力是元器件和集成电路IC的微型化。随着微电子技术的发展,器件的速度和延迟时间等性能对器件之间的互连提出了更高的要求,由于互连信号延迟、串扰噪声、电感电容耦合以及电磁辐射等影响越来越大,由高密度封装的IC和其他电路元件构成的功能电路已不能满足高性能的要求。人们已深刻认识到,无论是分立元件还是IC,封装已成为限制其性能提高的主要因素之一。目前电子封装的趋势正朝着小尺寸、高性能、高可靠性和低成本方面发展。
所谓封装是指将半导体集成电路芯片可靠地安装到一定的外壳上,封装用的外壳不仅起着安放、固定、密封、保护芯片和增强电热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁,即芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。因此,封装对集成电路和整个电路系统都起着重要的作用。芯片的封装技术已经历了几代的变迁,从双列直插式封装(DIP)、塑料方型扁平式封装(POFP)、插针网格阵列封装(PGA)、球栅阵列封装(BGA)、芯片尺寸封装(CSP)到多芯片组件(MCM),技术更先进,芯片面积与封装面积之比越来越趋近于1,适用频率更高,耐温性能更好,引脚数增多, 引脚间距减小,可靠性提高,使用更加方便。
80年代被誉为“电子组装技术革命”的表面安装技术SMT改变了电子产品的组装方式。SMT已经成为一种日益流行的印制电路板元件贴装技术,其具有接触面积大、组装密度高、体积小、重量轻、可靠性高等优点,既吸收了混合IC的先进微组装工艺,又以价格便宜的PCB代替了常规混合IC的多层陶瓷基板,许多混合IC市场已被SMT占领。随着IC的飞速发展,I/O数急剧增加,要求封装的引脚数相应增多, 出现了“高密度封装”。90年代,在高密度、单芯片封装的基础上,将高集成度、高性能、高可靠的通用集成电路芯片和专用集成电路芯片ASIC在高密度多层互连基板上用表面安装技术组装成为多种多样的电子组件、子系统或系统,由此而产生了多芯片组件MCM[1]。在通常的芯片印刷电路板PCB和SMT中,芯片工艺要求过高,影响其成品率和成本;印刷电路板尺寸偏大,不符合当今功能强、尺寸小的要求,并且其互连和封装的效应明显,影响了系统的特性;多芯片组件将多块未封装的裸芯片通过多层介质、高密度布线进行互连和封装,尺寸远比印刷电路板紧凑,工艺难度又比芯片小,成本适中。因此,MCM是现今较有发展前途的系统实现方式,是微电子学领域的一项重大变革技术,对现代化的计算机、自动化、通讯业等领域将产生重大影响。
2 基本特点
多芯片组件是在高密度多层互连基板上,采用微焊接、封装工艺将构成电子电路的各种微型元器件(IC裸芯片及片式元器件)组装起来,形成高密度、高性能、高可靠性的微电子产品(包括组件、部件、子系统、系统)。它是为适应现代电子系统短、小、轻、薄和高速、高性能、高可靠、低成本的发展方向而在PCB和SMT的基础上发展起来的新一代微电子封装与组装技术,是实现系统集成的有力手段。
多芯片组件已有十几年的历史,MCM组装的是超大规模集成电路和专用集成电路的裸片,而不是中小规模的集成电路,技术上MCM追求高速度、高性能、高可靠和多功能,而不像一般混合IC技术以缩小体积重量为主。
典型的MCM应至少具有以下特点[2]:
(1)MCM是将多块未封装的IC芯片高密度安装在同一基板上构成的部件,省去了IC的封装材料和工艺,节约了原材料,减少了制造工艺,缩小了整机/组件封装尺寸和重量。
(2)MCM是高密度组装产品,芯片面积占基板面积至少20%以上,互连线长度极大缩短,封装延迟时间缩小,易于实现组件高速化。
(3)MCM的多层布线基板导体层数应不少于4层,能把模拟电路、数字电路、功率器件、光电器件、微波器件及各类片式化元器件合理而有效地组装在封装体内,形成单一半导体集成电路不可能完成的多功能部件、子系统或系统。使线路之间的串扰噪声减少,阻抗易控,电路性能提高。
(4)MCM避免了单块IC封装的热阻、引线及焊接等一系列问题,使产品的可靠性获得极大提高。
(5)MCM集中了先进的半导体IC的微细加工技术,厚、薄膜混合集成材料与工艺技术,厚膜、陶瓷与PCB的多层基板技术以及MCM电路的模拟、仿真、优化设计、散热和可靠性设计、芯片的高密度互连与封装等一系列新技术,因此,有人称其为混合形式的全片规模集成WSI技术。
3 基本类型
根据多层互连基板的结构和工艺技术的不同,MCM大体上可分为三类:层压介质MCM(MCML),陶瓷或玻璃瓷MCM(MCM-C),硅或介质材料上的淀积布线MCM(MCM-D)。表1给出MCM三种基本类型的结构、材料和性能[3,4]。
MCM-L是采用多层印制电路板做成的MCM,制造工艺较成熟,生产成本较低,但因芯片的安装方式和基板的结构所限,高密度布线困难,因此电性能较差,主要用于30MHz以下的产品。MCMC是采用高密度多层布线陶瓷基板制成的MCM,结构和制造工艺都与先进IC极为相似。其优点是布线层数多,布线密度、封装效率和性能均较高,主要用于工作频率30~50MHz的高可靠产品。它的制造过程可分为高温共烧陶瓷法HTCC和低温共烧陶瓷法LTCC。由于低温下可采用Ag、Au、Cu等金属和一些特殊的非传导性的材料,近年来,低温共烧陶瓷法占主导地位。MCM-D是采用薄膜多层布线基板制成的MCM,其基体材料又分为MCM-D/C(陶瓷基体薄膜多层布线基板的MCM)、MCM-D/M(金属基体薄膜多层布线基板的MCM)、MCM-D/Si(硅基薄膜多层布线基板的MCM)等三种,MCM-D的组装密度很高,主要用于500MHz以上的产品。
4 三维多芯片组件
通常所说的多芯片组件都是指二维的(2D-MCM),它的所有元器件都布置在一个平面上,不过它的基板内互连线的布置已是三维。随着微电子技术的进一步发展,芯片的集成度大幅度提高,对封装的要求也越严格,2D-MCM的缺点也逐渐暴露出来。目前,2D-MCM组装效率最高可达85%,接近二维组装所能达到的最大理论极限,已成为混合集成电路持续发展的障碍。为了改变这种状况,三维多芯片组件(3D-MCM)应运而生,其最高组装密度可达200%。3D-MCM是指元器件除了在x-y平面上展开以外,还在垂直方向(z方向)上排列,与2D-MCM相比,3D-MCM具有以下的优越性[5]:
(1)相对于2D-MCM而言,3D-MCM可使系统的体积缩小到1/10,重量减轻到1/6。
(2)芯片之间的互连长度比2D-MCM短得多,因此可进一步减小信号传输延迟时间和信号噪声,降低功耗,信号传输(处理)速度增加。
(3)组装效率已高达200%,进一步增大了组装效率和互连效率,因此可集成更多的功能,实现多功能的部件以至系统(整机)。
(4)互连带宽,特别是存储器带宽往往是影响计算机和通信系统性能的重要因素。降低延迟时间和增大总线宽度是增大信号宽度的重要方法,3D-MCM正好具有实现此特性的突出优点。
(5)由于3D-MCM内部单位面积的互连点数大大增加,具有更高的集成度,使其整机(或系统)的外部连接点数和插板大大减少,因此可靠性得到进一步提高。
3D-MCM虽然具有以上所述的优点,但仍然有一些困难需要克服。封装密度的增加,必然导致单位基板面积上的发热量增大,因此散热是关键问题。一般如金刚石或化学汽相淀积(CVO)金刚石薄膜、水冷或强制空冷、导热粘胶或散热通孔。另外,作为一项新技术,3D-MCM还需进一步完善,更新设备,开发新的软件。
5 应用及发展趋势
MCM在组装密度(封装效率)、信号传输速度、电性能以及可靠性等方面独具优势,是目前能最大限度地提高集成度、提高高速单片IC性能,制作高速电子系统,实现整机小型化、多功能化、高可靠、高性能的最有效途径。MCM早在80年代初期就曾以多种形式存在,但由于成本昂贵,大都只用于军事、航天及大型计算机上。随着技术的进步及成本的降低,近年来,MCM在计算机、通信、雷达、数据处理、汽车行业、工业设备、仪器与医疗等电子系统产品上得到越来越广泛的应用,已成为最有发展前途的高级微组装技术。例如利用MCM制成的微波和毫米波SOP,为集成不同材料系统的部件提供了一项新技术,使得将数字专用集成电路、射频集成电路和微机电器件封装在一起成为可能[6]。3D-MCM是为适应军事宇航、卫星、计算机、通信的迫切需求而迅速发展的高新技术,具有降低功耗、减轻重量、缩小体积、减弱噪声、降低成本等优点。电子系统(整机)向小型化、高性能化、多功能化、高可靠和低成本发展已成为目前的主要趋势,从而对系统集成的要求也越来越迫切。实现系统集成的技术途径主要有两个:一是半导体单片集成技术;二是MCM技术。前者是通过晶片规模的集成技术(WSI),将高性能数字集成电路(含存储器、微处理器、图像和信号处理器等)和模拟集成电路(含各种放大器、变换器等)集成为单片集成系统;后者是通过三维多芯片组件技术实现WSI的功能。
三维多芯片组件技术是现代微组装技术发展的重要方向,是新世纪微电子技术领域的一项关键技术。近年来在国外得到迅速发展。因此,我国也应该尽快高度重视该项新技术的研究和开发。









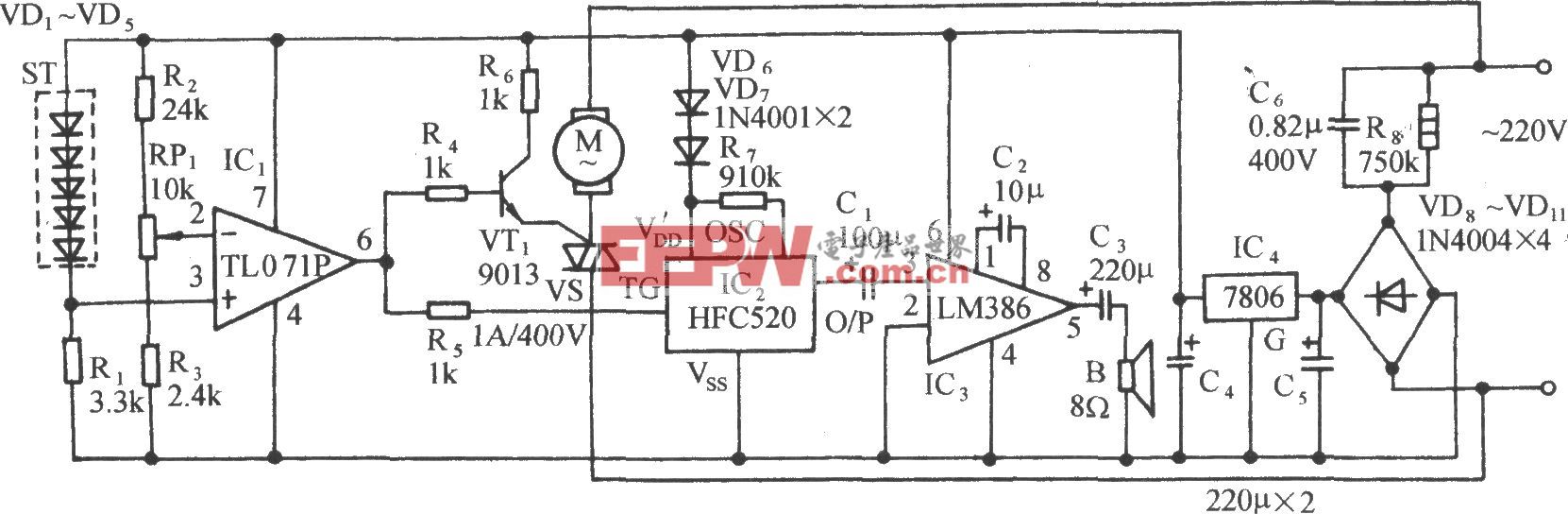
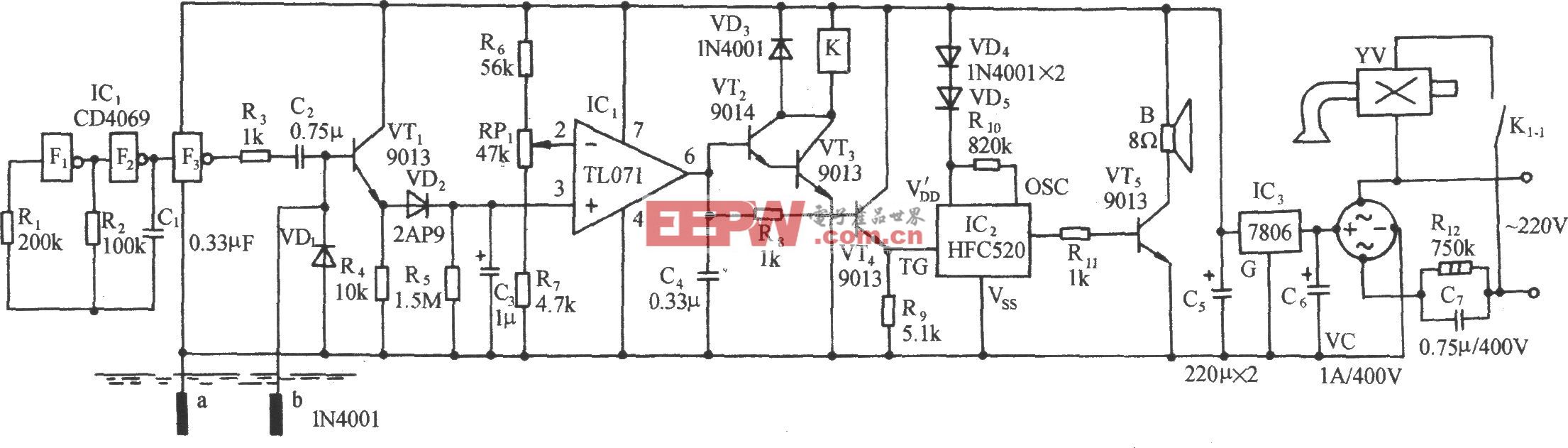
评论