得益于晶圆减薄工艺与创新的封装,功率MOSFET在不断进步
1.导通电阻与栅极电荷规格的改善正在变得更难以实现和更昂贵。
2.作为功率开关器件的选择,硅远未到死亡尽头,仍然还有发展余地。
3.对性能增强的探索来自于晶圆减薄和封装创新。
SiC(碳化硅)和GaN(氮化镓)是使用宽带隙半导体的新型开关功率晶体管,它们很可能会持续显著地增加功率转换效率(参考文献1)。但是,一直表现良好的硅功率MOSFET现在占市场统治地位,未来很多年,这种现状仍将持续下去。今年2月5日~9日在佛罗里达州奥兰多召开的APEC(实用功率电子大会),传统上一直是最大的功率开关器件展示会,也是检验功率MOSFET技术的一个好场所。
功率MOSFET通常会按其阻断电压(VB)范围,划分为多个区间,常见区间有小于40V、小于100V和小于600V。功率MOSFET的最大市场是消费市场和服务器/笔记本市场,因此小于100V阻断电压的MOSFET通常是该器件性能趋势的领头羊。
过去,硅功率MOSFET的发展可以搭数字硅工艺的顺风车。数字IC受益于摩尔定律所预测的晶体管密度增长,规模经济性意味着价格的下跌会伴随性能的增加,功率MOSFET也有类似的特性。不过好时光已一去不复返,硅MOSFET似乎正在达到硅技术的性能极限。
国际整流器公司电源管理器件业务部门总监Stéphane Ernoux表示:“趋势是花费越来越多,而性能的提高越来越小。‘花费多’是指开发更复杂的硅技术。这种状况的一个连锁反应是,当硅片进步了,封装就成为一个限制因素。如果回头看5年、10年或15年前,所有关注点都在硅片上,而封装对MOSFET性能的贡献很小,而现在硅片已经很好,(功率MOSFET制造商)必须关注对封装的改进。”
三大因素能够实现对功率密度的提升:如Ernoux指出的那样,硅结构仍有一定的提高空间。晶圆减薄是技术上的另一种提升,而封装创新则排名第三。通常,半导体制造商购买的晶圆都通过了晶圆供应商的一次切割和抛光步骤。MOSFET制造工艺是在晶圆上制作出MOSFET。由于功率MOSFET是垂直型器件,因此关键在于晶圆要尽可能薄,以降低导通电阻。减薄是在晶圆处理末段,切割工艺前的一个研磨工艺。制造商们在8mil厚的晶圆上制作出了第一代MOSFET,现在常用的是2mil厚的晶圆。
半导体制造商们用晶圆减薄方法制造IGBT已有大约10年的时间了。与功率MOSFET不同,IGBT从减薄中得到的好处是保持击穿电压, 而不是降低导通电阻。制造商一般采用6英寸晶圆做IGBT,它不太容易被折曲, 减薄工艺也不复杂。功率MOSFET一度不用减薄法,它率先数年转向8英寸晶圆。最初曾因损坏问题,减薄工艺和8英寸薄晶圆的取放导致了合格率不高。MOSFET制造商被迫根据机械式运载器而开发自有的IP(知识产权),用以取放薄的晶圆。
去年, 英飞凌公司在位于奥地利Villach的功率开发厂,用300mm(约12英寸)薄晶圆生产出了第一个功率MOSFET样品(图1)。该公司称,这些芯片规格等同于200mm晶圆上的相当器件(参考文献2)。由于晶圆减薄以及硅器件结构方面的持续进步,功率MOSFET的电阻现在已很低,使封装电阻以及片芯与引线框连接的寄生电感成为了重点。在解决MOSFET大电流方面,相对薄而脆弱的打线是限制因素;在大功率高性能器件中,夹线(clip)已取而代之成为标准。

图1,英飞凌最近推出的功率MOSFET做在薄的300 mm(约12英寸)直径晶圆上。这些芯片达到了与200 mm晶圆上相当器件同样的规格。
夹线有更低的导通电阻与寄生电感,这两者都会降低器件的开关速度。导通电阻与栅极电荷共同构成了MOSFET中常用的FOM(品质因数):FOM=RDS(ON)×Qg,其中RDS(ON)为导通电阻,Qg为栅极电荷。栅极电荷通常与硅片中电流路径的面积有关,一般与导通电阻呈相反的变化。通常,源于硅器件结构的性能增强要以导通电阻或栅极电荷为代价,制造商要根据应用对最小导通电阻或更快转换的需求,对器件作出微调。晶圆减薄和片芯接线的改进都能改善电阻与寄生电感指标,而不影响栅极电荷。因此,这些进步对器件性能的影响要大于向下一种硅器件结构的转换(图2)。
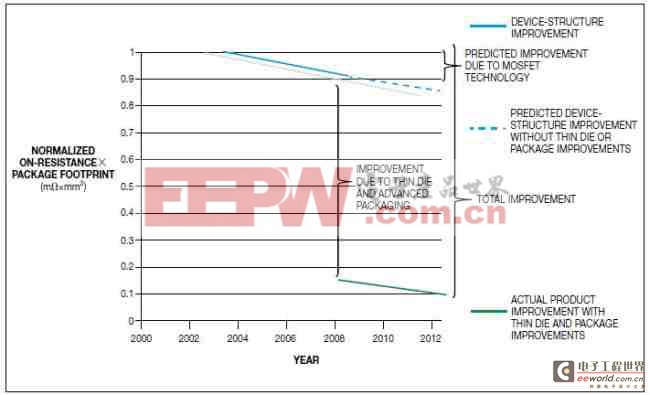
图2,不久前,硅器件结构上的改进推动了功率MOSFET性能的增长。现在,工艺上的进步(如晶圆减薄和封装创新)则是主要的进步。
飞兆半导体公司低压MOSFET技术开发副总裁Chris Rexer认为:“晶圆减薄为导通电阻提供了约25%的改进,而从传统打线技术转到夹线技术则提供了20%的改进。与向另外硅技术结点转换相比,这些改进非常明显。”
夹线技术并非片芯连接方面的唯一进步。扩散焊(diffusion solder)对于片芯底部与封装的接合也很重要。除了因更薄的打线而获得了较传统软焊更低的电阻和更好的热传导以外, 扩散焊还不含铅, 它对ROHS这种“绿色环保”倡议是一种关键的特性(图3)。例如,2014年将实现更严格的ELV(汽车寿命终结)ROHS规定,它可能要求欧洲汽车上使用100%无铅封装。英飞凌已推出了40V的OptiMOS T2功率MOSFET,它兼有扩散焊和薄晶圆工艺技术,该公司称已超过了硅芯片与封装连接的引线焊的现有ROHS规定。
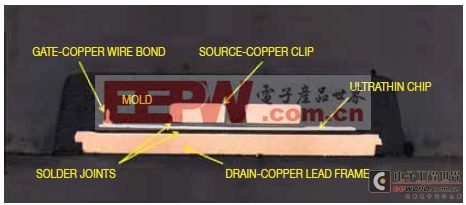
图3,SuperS08封装包括顶端安装的夹线技术,以及降低系统封装传导损耗的扩散焊技术。扩散焊有更薄的连接层,成为英飞凌薄晶圆MOSFET工艺的补充,现在的器件实现了60μm的片芯厚度。
由于采用了更小的片芯, 以及封装技术的进步,增加了功率密度,MOSFET驱动器的封装正在变得越来越实用。以前,对于要求有小的占位面积和低成本的产品,这些驱动器都显得太大,价格太高。现在,调整低侧与高侧开关是一种匹配开关特性的实用方法。2004年,英特尔首次提出了DrMOS驱动器规格的设计方案,但该概念的高成本和复杂性限制了它的采纳。而今天功率密度的增长已使配对开关技术成为可能。
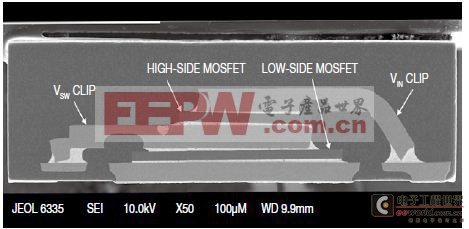
图4,德州仪器公司Power Block器件的剖面图,它采用了PowerStack技术,以厚的铜夹固定了高侧MOSFET和低侧MOSFET。低侧片芯连接到引线框的基础焊盘,为低侧MOSFET提供接地连接。这种结构在电路板面积、电流水平、功率效率,以及散热控制方面获得了显著的效益。
德州仪器公司有独特的NexFET技术,它采用了横向(而非纵向)的硅器件结构。横向结构将NexFET的阻断电压限制在25V。虽然该技术可以支持高的阻断电压,但这样就需要更大的片芯面积,可能导致价格的上涨。NexFET还获益于智能的封装。PowerStack产品在一个封装中同时包含了一个高侧和一个低侧FET(图4)。器件不是采用背靠背的结构,而是垂直堆叠形式,缩短了电路路径,因此降低了电阻,更重要的是减小了电感。电感的这种下降可以获得800kHz~1MHz的开关频率。
电荷放大器相关文章:电荷放大器原理













评论