光刻机之争掀起第三波浪潮
当下,光刻机在半导体行业的地位前所未有的重要,而且已经突破了技术和产业范畴,引发了新一波光刻机之争。
本文引用地址:https://www.eepw.com.cn/article/202309/450405.htm从历史发展情况来看,光刻机(这里主要指用于制造集成电路前道工序的光刻机)的发展和应用经历了很多波折,总体来看,有两个值得关注的时期,一个是 ASML 依靠浸没式技术,异军突起,并将原本的行业两强甩在身后,这是技术之战,另一个是 EUV 商用化之后,先进制程(从 16nm 开始)争夺战打响,台积电、三星电子和英特尔这三家为了争夺产量有限的 EUV 而展开竞争,这是商业之争。
从目前的情况来看,第三波光刻机之争正在酝酿之中,它比前两波更复杂,更激烈。
第一波:逆袭
1957 年,美国陆军一个实验室的 Jay Lathrop(拉斯洛普)和 James Nall(纳尔)获得了光刻技术的专利,该技术用于沉积薄膜金属条,以在陶瓷基板上连接分立晶体管。1959 年,拉斯洛普加入了德州仪器(Texas Instruments),纳尔去了飞兆半导体(Fairchild Semiconductor)。Jay Last(杰伊·拉斯特)和 Robert Noyce(罗伯特·诺伊斯)于 1958 年在飞兆半导体公司制造了第一批「步进重复」相机,使用光刻技术在单个晶圆上制造出了许多晶体管。这就是光刻机的雏形。
20 世纪 80 年代,在全球光刻机领域,行业老大是美国的 GCA 公司,不过,由于急于向客户交付设备,没有对产品进行检查,导致数百台带有故障镜头的产品流向市场。几乎在同一时期,日本的尼康改进了光刻机的聚焦系统,开发出了具有较大数值孔径的 g 线目镜,这种组合使系统能够更清晰地将微小图案成像到光刻胶上。这一创新使尼康很快占领了市场,客户们纷纷抛弃了 GCA 的光刻机,GCA 很快就衰败了。
同时期,佳能也推出了市场认可的产品,与尼康成为当时光刻机世界的两强。
与此同时,凭借在步进扫描光刻机上的成功,ASML 也逐步赶了上来,特别是其标志性的产品 PAS 5500,深受市场好评。经历了多年的苦心经营,ASML 在步进扫描光刻机时代走到了巨头行列。
然而,那时的 ASML,行业地位并没有现在这么凸出,略逊尼康、佳能一筹。
ASML 称霸光刻机行业,源于 193nm 到 157nm 制程的升级过程。那之前,步进扫描光刻机采用的都是干式法(曝光介质是空气)技术路线,通过用更高级的曝光光源,来支撑技术进步。为了追求更高的分辨率,光源波长从最初的 365nm,到 248nm,再到 193nm,之后,这条技术路线就很难走下去了。
当时,业内面临技术改良和颠覆两种选择,两大巨头尼康和佳能选择在原有技术路径上改良,而 ASML 选择赌一把,因为出现了一种新的浸没式技术。

浸没式技术是由时任台积电科学家的林本坚提出的,他创造性地用水作为曝光介质,还是用原来的 193nm 波长光源,但通过水的折射,可使进入光阻的波长缩小到 134nm。193 nm 光源在空气中的折射率为 1,在水中的折射率为 1.4,这意味着相同光源条件下,浸没式光刻机的分辨率可以提高 1.4 倍。
不过,这种技术在当时看起来过于大胆,技术难度很大,且成本高,多数传统光刻技术既得利益者不愿意接受它。为了推广浸没式技术,林本坚跑遍美国、日本、德国、荷兰,向光刻机厂商推销其创意,但碰了一鼻子灰。多数行业巨头对林本坚都持不友好的态度,尼康甚至向台积电施压,要求「封杀」他。
在这种情况下,林本坚把最后的希望寄托在了 ASML 身上,而后者并没有辜负他,在技术和行业发展到岔路口时,ASML 选择了颠覆式的创新技术,结果是赌赢了。
2003 年,ASML 和台积电合作研发的首台浸没式光刻设备——TWINSCAN XT:1150i 问世,第二年又推出了改进版。同年,研发进度缓慢的尼康,终于推出了 157nm 的干式光刻机产品样机。
一个是用原来 193nm 光源通过水进化到 132nm 波长的新技术,另一个是 157nm 波长的样机,浸没式技术的优势十分明显,这一技术成为此后 65nm、32nm、16nm 和 7nm 制程产线的主流光刻方案,直到现在的 3nm。
选择大于努力,ASML 选对了,尼康和佳能选错了。市场很快拥抱了浸没式光刻机,传统的干式法产品只能停放在仓库里吃灰,这使得尼康和佳能上百亿美元的研发费用打了水漂,市占率也大幅下滑。在 2000 年之前的 15 年里,ASML 是光刻机第一梯队里最小的玩家,市占率不足 10%,随着浸没式光刻机的商用化,到 2008 年,ASML 的市占率达到了 60%,一枝独秀。
技术驱动的第一波光刻机之争结束,ASML 大胜。
第二波:争夺
16nm 和 14nm 制程芯片量产以后,无论是 DUV,还是 EUV,ASML 的中高端光刻机一直是市场上的香饽饽,台积电、三星电子、英特尔,以及中国大陆的几大晶圆厂,每年都在争夺那数量有限的光刻机。
近些年,随着 7nm、5nm 和 3nm 制程的量产,台积电、三星电子和英特尔对 EUV 设备的争夺越来越激烈。
据悉,台积电拥有约 60 台 EUV 光刻机,超过市场上已出货 EUV 设备总量的 50%。随着 2nm 研发和晶圆厂建设工作的开展,台积电对高 NA(数值孔径)的 EUV 设备提出了更高要求,早早下单,争取在 ASML 那里拔得头筹。
三星也在抢购高 NA EUV,并要求 ASML 将设备直接拉到三星工厂内进行测试,创下 ASML 直接出货到客户厂内再测试的首例。目前,三星的 EUV 光刻机数量只有台积电的 60% 左右,甚至更少,2022 年,三星购买了约 18 台 EUV 设备。
2021 年,英特尔宣布重返晶圆代工市场,并在同年 7 月宣布推出先进制程技术蓝图,计划在未来 4 年推出 5 个新世代芯片制程技术。为了实现这一目标,英特尔也在争夺 ASML 最先进的 EUV 光刻机,2021 下半年,英特尔宣布领先于台积电和三星订购了 ASML 的 TWINSCAN EXE:5200,这是 ASML 正在开发的 NA 达 0.55 的 EUV 设备,单台价格达到 3 亿美元,据悉,其吞吐量超每小时 220 片晶圆。按照 ASML 的规划,TWINSCAN EXE:5200 最快将于 2024 年底投入使用,用于验证,2025 年开始用于芯片量产。
为了满足不断进化的先进制程,ASML 正在研发更先进的 EUV 光刻机,主要体现在高 NA 上。
高 NA 的 EUV 设备具有更高的分辨率,可使芯片密度增加数倍,还可以减少缺陷、成本和芯片生产周期。新的 EUV 设备,其 NA 值将从 0.33 提升到 0.55,以实现更高分辨率的图案化。和 0.33NA 光刻机相比,0.55NA 的分辨率从 13nm 升级到 8nm,可以更快更好地曝光更复杂的集成电路图案,突破 0.33NA 单次构图 32nm~30nm 间距的极限。
虽然 2023 年半导体市场低迷,但包括台积电、英特尔、三星、SK 海力士、美光在内的全球芯片大厂依然在积极投资 EUV 设备。台积电和三星将会在 2024 年扩大 3nm 产能,英特尔将在今年底量产首款采用 EUV 技术的 Intel 4 制程芯片。
ASML 表示,就目前主流的 0.33NA 而言,2021 年,晶圆代工厂的 5nm 制程,每片晶圆平均光罩约 10 层,但随着 2023 年 3nm 的量产,每片晶圆平均光罩达到 20 层。
DRAM 方面,目前采用 EUV 技术可实现 5 层光罩量产,但 2024 年将提升至 8 层光罩,部分制程将会采用多重曝光(multi-patterning),每片晶圆的光罩将达到 10 层。
据 ASML 统计,随着晶圆代工厂和 DRAM 厂扩大 EUV 资本支出,至 2023 年第一季度,该公司已出货 136 台 EUV 光刻机。
本周,ASML 首席执行官 Peter Wennink 表示,今年有望推出业界首款数值孔径达到 0.55 的 EUV 设备 TWINSCAN EXE:5000,不过,该设备主要用于研究开发,使该公司的客户熟悉新技术及其功能。如前文所述,每台这样的设备成本超过 3 亿美元。
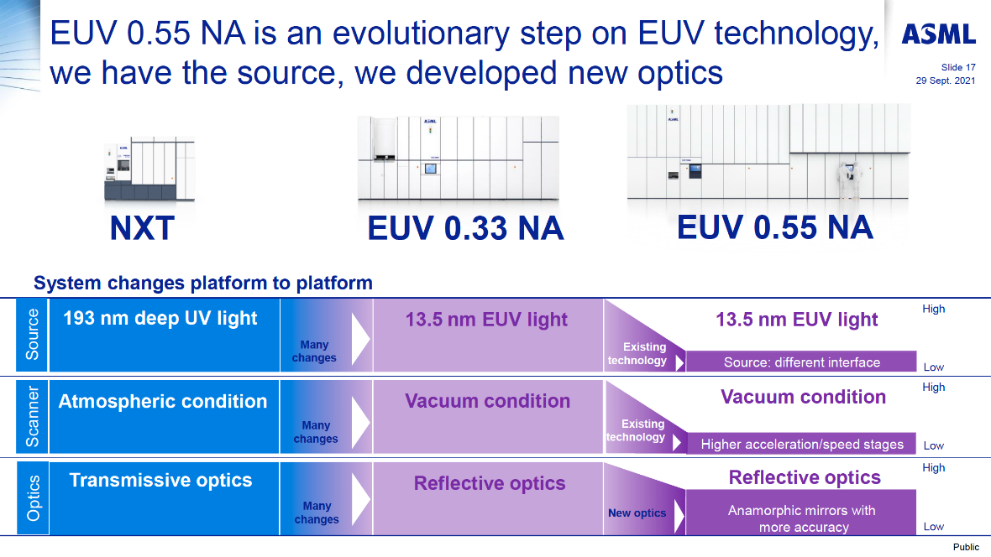
今年,ASML 将向一位未公开的客户发送其 TWINSCAN EXE:5000 设备,该客户很可能是英特尔,因为该公司曾经宣布,计划从 2025 年开始采用高数值孔径 TWINSCAN EXE 设备进行大批量生产(HVM),届时,该公司打算开始使用其 18A(~1.8nm)制程技术。为此,英特尔自 2018 年以来一直在尝试使用高数值孔径光刻设备,当时,它就预定了 TWINSCAN EXE:5000,还订购了商用版本的 TWINSCAN EXE:5200。
与英特尔相比,台积电和三星将会稍晚使用 NA 达到 0.55 的 EUV 设备,但不会晚于 2030 年。
就 2023 年而言,Susquehanna International Group 高级分析师 Mehdi Hosseini 表示,由于需要采用 EUV 设备进行多重曝光,基于成本考虑,在具有更高吞吐量的新款 NXE:3800E 上市之前,台积电 3nm 制程无法真正放量生产。目前,台积电使用的是 NXE:3600D,每小时可生产 160 个晶圆(wph)。
ASML 将于今年底推出新款高 NA 的 NXE:3800E,通过降低 EUV 多重曝光的总成本,NXE:3800E 每小时可生产 195 片晶圆,经过一段时间优化后,能提升到每小时 220 片,吞吐量比 NXE:3600D 提高 30%。
第三波:雄起
在美国推出禁止向中国大陆出售中高端 DUV 和 EUV 设备的法令后,第三波光刻机之争悄然到来,这其中包括限制与反限制,以及新一波的光刻技术开发和自研潮。
目前,中国大陆晶圆厂已经无法购买专门用于生产 14nm 以下先进制程芯片的光刻机,如果采用较旧版本的 DUV 设备生产 14nm、7nm 芯片,则需要多重曝光,成本会大幅上涨,且良率难以提升。
荷兰最新半导体设备出口管制措施于 9 月 1 日生效,进一步限制了用于成熟制程的 DUV 设备出口到中国大陆,有些涉及 38nm-45nm 制程。
本周,ASML 表示,该公司已向荷兰政府提出 TWINSCAN NXT:2000i 及后续推出的浸没式光刻机的出口许可证申请,荷兰政府已经颁发了截至 9 月 1 日所需的许可证,允许 ASML 在今年底前继续向中国客户出货 TWINSCAN NXT:2000i 及后续推出的设备。然而,该公司预估在 2024 年 1 月之后不能再获得相关出口许可证了。
9 月 4 日,ASML 首席执行官 Peter Wennink 在一档电视节目中表达了他对该公司面临的出口管制和保护主义的看法。
Peter Wennink 强调,通过出口管制完全孤立中国大陆并不是一个可行的做法。华为 Mate 60 Pro 中的芯片实现突破就间接说明了这一点,这些限制实际上正在推动中国大陆加倍努力创新。他表示,如果欧洲和美国不愿意分享技术,中国大陆就会自己研究,他们正在考虑西方企业尚未考虑过的解决方案。西方政府的限制性政策正在激发中国大陆的创新精神和创造能力。
Peter Wennink 警告,中国大陆将设计出新技术和产品,这可能会引发一场影响全球的竞赛。
华尔街日报曾经报道过,美国在 2022 年 10 月升级芯片限售令时,中国大陆企业只进口了 24 亿美元的半导体设备,创下美国推出禁令两年多以来的最低数据。这意味着,中国半导体设备正在努力摆脱对进口的依赖,自主化进程正在提速。



评论