功率器件在混合动力汽车(HEV)中的应用
混合动力汽车(HEV)市场的增长在很大程度上取决于每加仑/英里这一能耗指标及追加投入的每个硬币所带来的好处以及混合系统现场的可靠性。消费者将混合汽车与标准汽车进行比较,并期待在整体更低拥有成本的前提下起码具有同样的性能和可靠性。混合汽车增加的成本必须在拥有期间通过节省燃料和维护成本得到回报。
本文引用地址:https://www.eepw.com.cn/article/196867.htm用在HEV中逆变器和dc-dc转换器中的功率模块和其内的功率器件是主要的性能、可靠性和成本驱动器。效率、功率密度和特定功率是一些关键性能指标。最重要的可靠性规范是热循环和功率循环。
混合动力汽车的分类
在混合汽车驱动系统中,需将一或几个电机与燃烧引擎一起使用。可根据混合程度和系统架构对混合汽车进行分类。可被分为微(micro)级、轻度(mild)级和完全(full)级的混合程度决定电机执行的功能。该分类还决定所需的功率级及优选的系统架构。
串行、并行和功率分配是最常用的架构。对一款特定车辆来说,混合程度和系统架构的选择主要取决于所需的功能、车辆大小、行驶年限及设定的燃油经济性指标。每个混合系统的功率电子内容各不一样,它取决于功能、功率要求和架构。
当仅需要启动-停止功能时(例如旅行车场合),用一个集成起动器/交流发电机系统代替了起动器和交流发电机的并行微混合的方法就很通用。在这些系统中,电压和功率等级相对较低,其油耗的改进在10%左右。
除启动-停止功能外,当需要时,一个轻度混合系统可提升/辅助引擎功率,另外,它还从再生制动中获取能量,从而可将油耗的改进提升到15%左右。增加的功能需要更高的能耗,所以要采用高压器件(80 V 到600 V)。
若以完全电子模式运行车辆,则需要一个具有高压和大电流能力的完全混合系统。根据应用,完全混合系统可具有串行、并行和功率分配架构,它可将油耗降低35%。
HEV系统中功率电子面临的挑战
HEV系统中的功率电子需高效地将能量从dc转至ac(电池到电机)、从ac转至dc(发电机到电池)及从dc 到dc(对升压转换器来说,是从低的电池电压到高的逆变器输入电压;对降压转换器来说是从高压电池到低压电池)。因在该能量转换中,要对高压和大电流进行开关,所以需采用具有最低损耗的功率器件技术。对较低的系统电压和电流来说,MOSFET技术比IGBT有更好的功率密度,它们用在微混合应用中。对轻度混合应用来说,当系统电压高于120V时,IGBT是首选器件。对全混合应用来说,600V到1200V的IGBT是使用的唯一器件。
一般来说,传统的NPT IGBT在导通损耗和开关损耗特性间有一个平衡。若导通损耗降低则开关损耗增加。英飞凌的沟道FieldStop IGBT及配套的EmCon二极管技术与传统器件相比,在增加芯片电流密度的同时减小了导通和开关损耗。通过采用一个场截止(fieldstop)层来得到更低损耗,该层减小了器件厚度并降低了通过器件的压降。图1显示了平面和沟道器件所用不同IGBT技术的截面层。另外,Field-Stop器件可连续工作在150 °C(最高175 °C)的结温度,该特性强化了芯片电流密度并使采用更高的冷却温度变得更容易。

嵌放在一个便利封装内的功率模块可承受极端温度环境、震动及其它恶劣环境条件。除器件工作引起的温度变化外,环境温度变异及车内产生的振动带来可靠性挑战。在混合汽车应用中功率模块预期的使用寿命是15年/15万英里,所以在设计该模块时,要使其能具有期望的可靠性。例如,在某些情况,更高的器件性能会对模块的稳定性产生不良影响。从器件技术的角度讲,某些功率器件可工作于高的结温度,但该更高的结温度会在线绑定接口产生更高温度,从而降低模块功率周期的稳定性。因此,需建立一整套全面的器件和封装技术规范来优化性能、可靠性和成本。
混合车用功率半导体模块
应用需要功率模块具有高电流密度,这也就意味着每单位电流容量具有更小的体积。器件越小,包纳其于其内的底层也就越小,结果就得到一个模块虽小但功率密度更高的模块。图2显示的是英飞凌预期的1200V器件体积的减小情况。显然,与NPT器件相比,FieldStop器件显著缩小了体积。
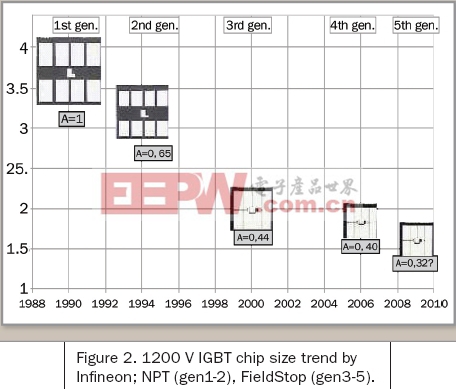
封装设计和互连技术对模块的寄生感应产生很大影响,它们也可被用来改进功率密度。另外,选择的材料也会对性能和可靠性产生影响。例如,氮化硅底层的成本比氧化铝底层的成本高很多,但前者的热性能明显好于后者。同样,昂贵的铝硅碳化物基板也比便宜的铜基板具有高得多的热循环可靠性。
当为HEV设计功率模块时,需在设计开始就明确关键的障碍。需采用恰当的器件技术、底层布局和封装技术以满足性能、可靠性和成本目标。表1显示了三种模块在性能和可靠性方面的对比,它们分别是:用于工业可变速驱动的标准半桥62mm模块、用于轻度混合的六单元(six-pack)HybridPACK1模块(图3)和用于全混合的六单元(six-pack)HybridPACK2模块。

在全部三种模块内,都采用了相同的600V沟道FieldStop器件技术,但采用的封装技术不同。62mm和 HybridPACK1模块实现的器件电流是400A(每开关各有两个200A IGBT和两个200A二极管),而HybridPACK2模块的电流是800A(每开关各有四个200A IGBT和四个200A二极管)。用于62 mm、HybridPACK1和HybridPACK2模块功率和信号热连接的封装技术分别采用的是:焊接、线绑定和超声波焊接。通过布局改良及采用线绑定的功率和信号热连接,HybridPACK1模块的功率密度已比62mm模块提升了50%。虽然寄生感应增加了50%,但对600V器件来说,这并非一个主要问题,因为在轻度混合应用中最坏的系统电压情况在200V以下。
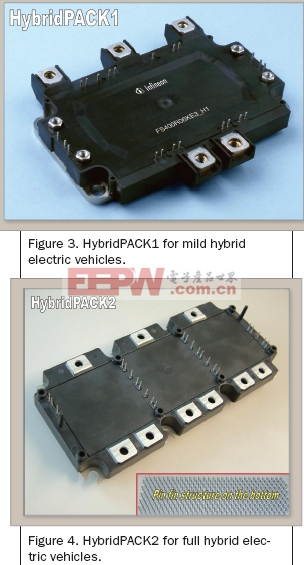
通过创新的超声波焊接工艺和改进的布局,HybridPACK2模块的功率密度增加了120%以上。多个线连接及为了移动绑定工具分配的空间使线绑定热连接在封装内很占空间;超声波焊接则省去了该空间且速度也比线绑定工艺快。另外,线绑定的电流输送能力有限。因厚的铜终端在超声波焊接时与底层融固在一起,所以,超声波焊接的电流载运能力不受限制。更紧凑的封装还显著降低了HybridPACK2封装的自感。对全混合应用来说,因系统电压会高于400V,且大电流会产生很大的dI/dt,所以低的寄生感应很重要。
模块的热阻抗主要取决于每开关所占的芯片面积、模块的材料堆叠及底层布局。材料堆叠特性直接影响模块的热阻抗,而布局则增加了交叉传导部分。在62mm和HybridPACK1模块中,采用了平的铜基层,而HybridPACK2则采用集成的针翅管(pin-finned)铜基层。对带有平基层的模块来说,需将导热脂和散热层的热阻抗加起来以得到“从结到环境”的热阻抗。借助拿掉了导热脂层并直接将底层与针翅管基板焊接在一起,从而显著改善了HybridPACK2模块的热阻抗表现。
模块内临近材料的热扩展不匹配将使连接部位产生压力形变并最终导致故障。最大的压力产生在铜基板上为与底层焊接在一起所涂覆的焊料点上。为加强可靠性,模块制造商传统上采用氮化铝底层与铝硅碳化物基板的组合,此举显著增加了成本。为替代昂贵的铝硅碳化物,英飞凌开发出采用铜基板和改进的氧化铝底层的HybridPACK1和HybridPACK2模块。这种材料组合可满足可靠性目标要求,但成本却降低了很多。汽车的可靠性目标是从-40 °C到125 °C的1000次循环。
结论
功率模块的性能、可靠性和成本是HEV市场增长的主要驱动器。为降低成本,需降低功率模块内器件的功率密度和结温度。英飞凌的沟道FieldStop IGBT和EmCon就是在增加结温度的同时可降低导通和开关损耗的这样一类器件。通过采用高效的功率器件和超声波焊接技术可显著改进模块的功率密度;同样,采用集成的针翅管基层可改进热性能。改进的氧化铝底层和铜基板方法能以低成本为HybridPACK模块提供最优异的可靠性。对全混合应用来说,HybridPACK2是一款优异的模块,它提供了高功率密度、低自感、低热阻及最佳可靠性和最低成本。
REFERENCES
1.McKinsey Company, “Drive — The future of Automotive Power,” 2006.
2.R. Amro et al, “Power Cycling at High Temperature Swings of Modules with Low Temperature Joining Technique,” ISPSD 2006, Naples.
3.T. Laska et al, “The Field Stop IGBT (FS IGBT) — A New Power Device Concept with a Great Improvement Potential,” Proceedings of the 12th ISPSD, pp.355-358, 2000.
4.P. Kanschat et al, “600V IGBT3: A Detailed Analysis of Outstanding Static and Dynamic Properties,” Proc. PCIM Europe, pp. 436-441, 2004.
5.A. Kawahashi et al, “A New-Generation Hybrid Electric Vehicle and its Supporting Power Semiconductor Devices,” Proceedings of 16th ISPSD, pp. 23-29, 2004.



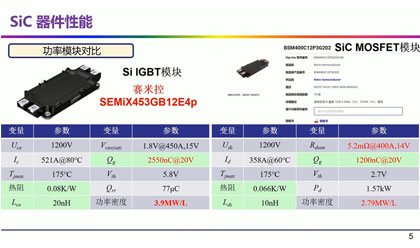



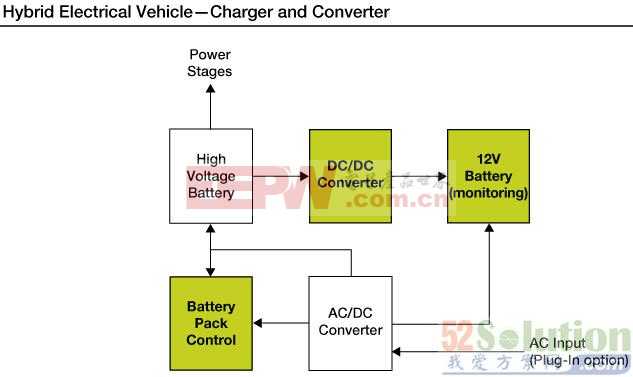


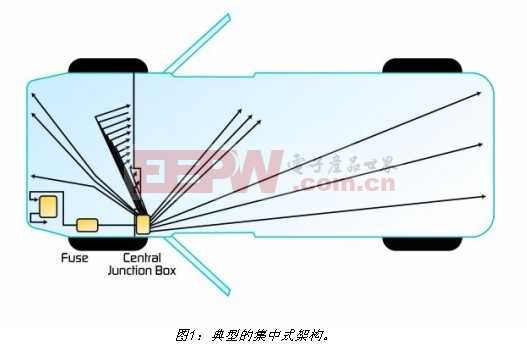

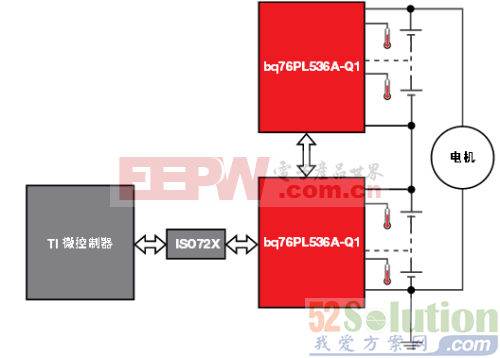
评论