
- 据外媒videocardz报道,Mac Studio的全面拆解表明,苹果最新的M1 Ultra芯片到底有多大。此多芯片模块包含两个使用
UltraFusion 技术相互连接的 M1 max
芯片。需要注意的是,这款超大型封装还包含128GB内存。不幸的是,在拆卸过程中看不到硅芯片,因为整个封装被一个非常大的集成散热器覆盖。M1 Ultra具有两个10核CPU和32核GPU。整体有1140亿个晶体管。根据苹果的基准测试,该系统应该与采用RTX 3090显卡的高端台式机竞争。虽然该系统确实功能强大,并
- 关键字:
苹果 M1 Ultra 封装 CPU
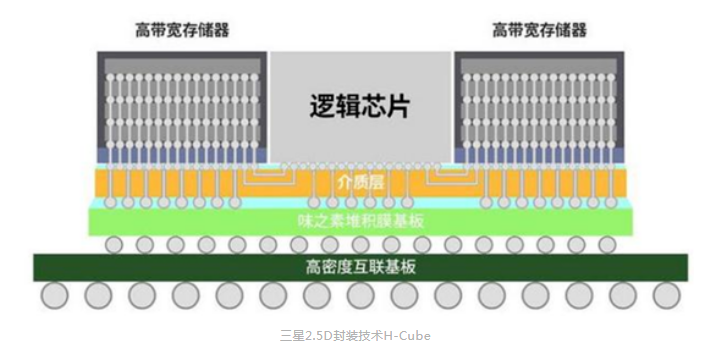
- 作为全球第二大的芯片代工厂,最近三星又在芯片领域做出重要一步。三星电子在其 DX 事业部的全球制造和基础设施部门内设立了测试和封装(TP,Test & Package)中心。
- 关键字:
三星 封装 业务

- 6 月 1 日消息 在今日召开的 2021 台北国际电脑展(Computex 2021)上,AMD CEO 苏姿丰发布了 3D Chiplet 架构,这项技术首先将应用于实现“3D 垂直缓存”(3D Vertical Cache),将于今年年底前准备采用该技术生产一些高端产品。苏姿丰表示,3D Chiplet 是 AMD 与台积电合作的成果,该架构将 chiplet 封装技术与芯片堆叠技术相结合,设计出了锐龙 5000 系处理器原型。官方展示了该架构的原理,3D Chiplet 将一个 64MB 的 7n
- 关键字:
AMD chiplet 封装
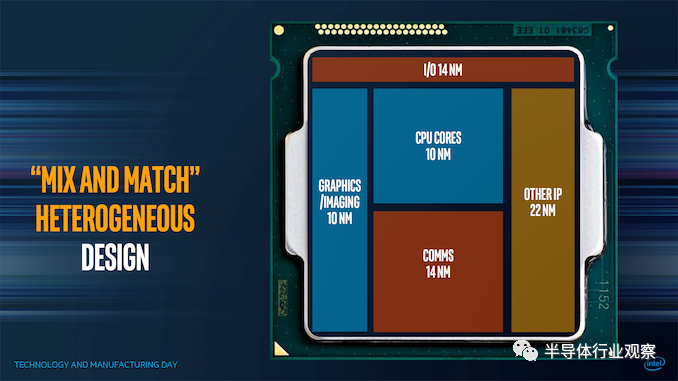
- 在英特尔2020年架构日活动即将结束的时候,英特尔花了几分钟时间讨论它认为某些产品的未来。英特尔客户计算部门副总裁兼首席技术官Brijesh Tripathi提出了对2024年以上未来客户端产品前景的展望。他表示,他们将以英特尔的7+制造工艺为中心,目标是启用“Client 2.0”,这是一种通过更优化的芯片开发策略来交付和实现沉浸式体验的新方法。Chiplet(小芯片)并不是新事物,特别是随着英特尔竞争对手最近发布的芯片,并且随着我们进入更复杂的过程节点开发,小芯片时代可以使芯片上市时间更快,给定产品的
- 关键字:
英特尔 chiplet 封装

- 长期进行IGBT器件焊接封装发现,IGBT器件封装所用关键部件子单元的存放时间长短对焊接空洞影响较大,本文分别对两批存放时间差别较大的子单元进行封装,通过实验对比两批产品的空洞率,结果表明存放时间较短的子单元焊接的IGBT器件空洞率明显偏小,从而提高了IGBT器件的可靠性。
- 关键字:
IGBT 焊接 封装 空洞率 子单元 202201

- 据国外媒体报道,三星电子计划采用一种新的封装技术,以降低图像传感器的成本。从外媒的报道来看,三星图像传感器计划采用的是芯片级封装(Chip Scale Package,CSP)技术,从明年开始采用,不过只会用于低分辨率的图像传感器。COB封装技术据The Elec报道,目前三星电子的图像传感器采用板上芯片封装(Chips on Board,COB) —— COB是当前图像传感器最常用的封装方法,即将图像传感器放置在PCB上,并通过导线连接,再将镜头附着在上面。然而,该过程需要一个洁净室,因为在封
- 关键字:
三星 图像传感器 CSP 封装
- 5G通信与新能源汽车引领的新一轮科技迭代浪潮,将全球半导体行业引入了新一轮景气周期。面对强劲市场需求,包括封测在内的行业相关企业普遍迎来业绩利好。日前,国内封测龙头长电科技(股票代码600584)发布了截至2021年6月30日的半年度财务报告。财报显示,长电科技上半年实现营收人民币138.2亿元,同比增长15.4%。净利润为人民币13.2亿元,同比增长261.0%,创历年上半年净利润新高。自2020年起,长电科技进入增长快车道,去年全年净利润达到13亿元。进入2021年,长电科技的业绩增速势头不减,上半年
- 关键字:
封装 先进

- 据国外媒体报道,本月中旬,三星展示了他们的3D芯片封装技术,而外媒最新的报道显示,三星已加快了这一技术的部署。外媒是援引行业观察人士透露的消息,报道三星在加快3D芯片封装技术的部署的。加快部署,是因为三星寻求明年开始同台积电在先进芯片的封装方面展开竞争。从外媒的报道来看,三星的3D芯片封装技术名为“eXtended-Cube” ,简称“X-Cube”,是在本月中旬展示的,已经能用于7nm制程工艺。三星的3D芯片封装技术,是一种利用垂直电气连接而不是电线的封装解决方案,允许多层超薄叠加,利用直通硅通孔技术来
- 关键字:
三星 3D 芯片 封装 台积电

- 在Intel的六大技术支柱中,封装技术和制程工艺并列,是基础中的基础,这两年Intel也不断展示自己的各种先进封装技术,包括Foveros、Co-EMIB、ODI、MDIO等等。Intel又宣布了全新的“混合结合”(Hybrid Bonding),可取代当今大多数封装技术中使用的“热压结合”(thermocompression bonding)。据介绍,混合结合技术能够加速实现10微米及以下的凸点间距(Pitch),提供更高的互连密度、更小更简单的电路、更大的带宽、更低的电容、更低的功耗(每比特不到0.0
- 关键字:
Intel 封装 凸点密度
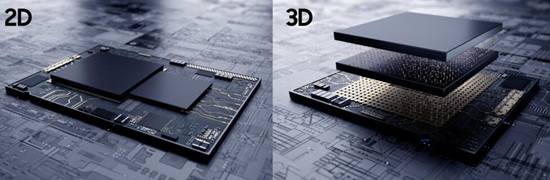
- 据台湾媒体报道,三星电子成功研发3D晶圆封装技术“X-Cube”,称这种垂直堆叠的封装方法,可用于7纳米制程,能提高该公司晶圆代工能力。图片来自三星电子官方三星的3D IC封装技术X-Cube,采用硅穿孔科技(through-silicon Via、简称TSV),能让速度和能源效益大幅提升,以协助解决次世代应用严苛的表现需求,如5G、人工智能(AI)、高效能运算、行动和穿戴设备等。三星晶圆代工市场策略的资深副总裁Moonsoo Kang表示,三星的新3D整合技术,确保TSV在先进的极紫外光(EUV)制程节
- 关键字:
三星 3D 晶圆 封装

- 摘要传感器半导体技术的开发成果日益成为提高传感器集成度的一个典型途径,在很多情况下,为特殊用途的MEMS(微机电系统)类传感器提高集成度的奠定了坚实的基础。本文介绍一个MEMS光热传感器的封装结构以及系统级封装(SIP)的组装细节,涉及一个基于半导体技术的红外传感器结构。传感器封装以及其与传感器芯片的物理交互作用,是影响系统整体性能的主要因素之一,本文将重点介绍这些物理要素。本文探讨的封装结构是一个腔体栅格阵列(LGA)。所涉及材料的结构特性和物理特性必须与传感器的光学信号处理和内置专用集成电路(ASIC
- 关键字:
红外传感器 封装 光窗 红外滤光片 MEMS
- 封装是半导体生产流程中的重要一环,也是半导体行业中,中国与全球差距最小的一环。然而,新冠肺炎疫情的突袭,让中国封装产业受到了一些影响。但是,随着国内数字化、智能化浪潮的不断推进,中国的封装产业增加了更多冲破疫情阴霾、拓展原有优势取得进一步发展的机会。
- 关键字:
封装 半导体 5G新基建
- 盛美半导体设备公司,作为国际领先的半导体和晶圆级封装设备供应商,近日发布公司新产品:适用于晶圆级先进封装应用(Wafer Level Advance Package)的无应力抛光(Stree-Free-Polish)解决方案。先进封装级无应力抛光(Ultra SFP ap)设计用于解决先进封装中,硅通孔(TSV)和扇出(FOWLP)应用金属平坦化工艺中表层铜层过厚引起晶圆翘曲的问题。
- 关键字:
盛美半导体 晶圆 封装
- 全球领先的高科技设备制造商Manz亚智科技,交付大板级扇出型封装解决方案于广东佛智芯微电子技术研究有限公司(简称佛智芯),推进国内首个大板级扇出型封装示范线建设,是佛智芯成立工艺开发中心至关重要的一个环节,同时也为板级扇出型封装装备奠定了验证基础,从而推进整个扇出型封装(FOPLP)行业的产业化发展。5G、云端、人工智能等技术的深入发展,使其广泛应用于移动装置、车载、医疗等行业,并已成为全球科技巨擘下一阶段的重点发展方向。而在此过程中,体积小、运算及效能更强大的芯片成为新的发展趋势和市场需求,不仅如此,芯
- 关键字:
封装 FOPLP
- Intel近日宣布,已成功将1.6Tbps的硅光引擎与12.8Tbps的可编程以太网交换机成功集成在一起。这款一体封装解决方案整合了Intel及旗下Barefoot Networks部门的基础技术构造模块,可用于以太网交换机上的集成光学器件。
- 关键字:
Intel 以太网交换机 封装
双列直插(dip)封装介绍
您好,目前还没有人创建词条双列直插(dip)封装!
欢迎您创建该词条,阐述对双列直插(dip)封装的理解,并与今后在此搜索双列直插(dip)封装的朋友们分享。
创建词条
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473