bga焊接技术
bga焊接技术
随着手机的体积越来越小, 内部的集成程度也越来越高,而且现在的手机中几乎都采用了球栅阵列封装模块,也就是我们通常所说的BGA。这种模块是以贴片形式焊接在主板上的。对维修人员来说,熟练的掌握热风枪,成为修复这种模块的必修课程。
1。BGA模块的耐热程度以及热风枪温度的调节技巧, BGA模块利用封装的整个底部来与电路板连接。不是通过管脚焊接,而是利用焊锡球来焊接。模块缩小了体积, 手机也就相对的缩小了体积, 但这种模块的封装形式也决定了比较容易虚焊的特性,手机厂家为了加固这种模块,往往采用滴胶方法。这就增加了维修的难度。对付这种胶封模块,我们要用热风枪吹很长时间才能取下模块,往往在吹焊过程中, 拆焊的温度掌握不好,模块拆下来也因为温度太高而损坏了。 那么怎样有效的调节风枪温度。即能拆掉模块又损坏不了呢!跟大家说几种机型中常用的BGA模块的耐热温度和焊接时要注意的事项。 摩托罗拉V998的CPU,大家肯定很熟悉吧,这种模块大多数是用胶封装的。这种模块的耐热程度比较高, 风枪温度一般不超过400度不会损坏它,我们对其拆焊时可以调节风枪温度到350-400度,均匀的对其表面进行加热,等CPU下有锡球冒出的时候,说明底下的焊锡已经全部融化,这时就可以用镊子轻轻的撬动它,从而安全的取下 。跟这种模块的焊接方法差不多的模块还用诺基亚8210/3310系列的CPU,不过这种CPU封装用的胶不太一样,大家要注意拆焊时封胶对主板上引脚的损害。 西门子3508音频模块和1118的CPU。这两种模块是直接焊接在主板上的, 但它们的耐热程度很差,一般很难承受350度以上的高温,尤其是1118的cpu.焊接时一般不要超过300度。我们焊接时可以在好CPU上放一块坏掉的CPU.从而减少直接吹焊模块引起的损害。吹焊时间可能要长一些, 但成功率会高一些。 2,主板上面掉点后的补救方法。 刚开始维修的朋友,在拆用胶封装的模块时,肯定会碰到主板上掉点。如过掉的焊点不是很多,我们可以用连线做点的方法来修复,在修复这种掉点的故障中,我用天目公司出的绿油做为固定连线的固化剂。
主板上掉的点基本上有两种,一种是在主板上能看到引脚,这样的比较好处理一些,直接用线焊接在引脚上,保留一段合适的线做成一个圆型放在掉点位置上即可,另一种是过孔式焊点,这种比较难处理一些,先用小刀将下面的引脚挖出来,再用铜线做成焊点大小的圈,放在掉点的位置。再加上一个焊锡球,用风枪加热。从而使圈和引脚连在一起。 接下来就是用绿油固化了,涂在处理好的焊盘上,用放大镜在太阳下聚光照上几秒钟,固化程度比用热风枪加热一天的还要好。 主板上掉了焊点, 我们用线连好,清理干净后。在需要固定或绝缘的地方涂上绿油,
拿到外面,用放大镜照太阳聚光照绿油。几秒钟就固化。
3.焊盘上掉点时的焊接方法。 焊盘上掉点后,先清理好焊盘, 在植好球的模块上吹上一点松香,然后放在焊盘上, 注意不要放的太正, 要故意放的歪一点, 但不要歪的太厉害,然后加热,等模块下面的锡球融化后,模块会自动调正到焊盘上, 焊接时要注意不要摆动模块。 另外,在植锡时,如果锡浆太薄, 可以取出一点放在餐巾纸,把助焊剂吸到纸上, 这样的锡浆比较好用!
球栅列阵(BGA)焊盘翘起或脱落的不幸现象是常见的。翘起的BGA焊盘把日常修理的程序变成一个复杂的印刷电路板修复程序。
BGA焊盘翘起的发生有许多原因。因为这些焊盘位于元件下面,超出修理技术员的视线,技术员看不到这些焊点连接,因而
可能在熔化所有焊锡连接点之前就试图移动元件。类似地,由于过量的底面或顶面加热,或加热时间太长温度太高,BGA焊盘可
能会被过分加热。结果,操作员可能由于想使所有的BGA焊盘都熔化而使该区域过热。加热太多或太少可能产生同样的不愉快的
结果。
一个位置上多次返工也可能造成焊盘对电路板层失去粘结。在焊锡回流温度,SMT焊盘是脆弱的,因为焊盘对板的粘结就是
这样。BGA是一个结实的元件,对PCB的连接很强;焊盘表面区域也值得注意,当熔化时,焊锡的表面张力最大。
在许多情况下,不管最有技术的操作员尽其最大努力,在BGA修理中偶然的焊盘翘起还是可能见到。你该怎么办?
下面的方法是用于修复损伤的BGA焊盘的,采用的是新的干胶片、胶底焊盘。新的焊盘是使用一种专门设计的粘结压力机来
粘结到PCB表面。必须使板面平滑。如果基底材料损伤,必须先用另外的程序修复。本方法用来更换BGA的铜箔焊盘,干胶片作胶
衬底。步骤如下。
• 清洁要修理的区域
• 取掉失效的焊盘和一小段连线
• 用小刀刮掉残留胶、污点或烧伤材料
• 刮掉连线上的阻焊或涂层
• 清洁区域
• 在板面连接区域蘸少量液体助焊剂,并上锡。清洁。焊锡连接的搭接长度应该小于两倍的连线宽度。然后,可将新的BGA
焊盘的连线插入原来BGA焊盘的通路孔中。将通路孔的阻焊去掉,适当处理。板面的新焊盘区域必须平滑。如果有内层板纤维暴
露,或表面有深层刮伤,都应该先修理。更换后的BGA焊盘高度是关键的,特别对共晶锡球的元件。去掉BGA焊盘与板面连线或通
路孔之间的阻焊材料,以保持一个较低的轮廓。有必要时,轻微磨进板面以保证连线高度不会干涉更换的元件。
• 选一个BGA的替换焊盘,最接近配合要更换的焊盘。如果需要特别尺寸或形状,可以用户订做。这些新的BGA焊盘是用铜箔
制造的,铜箔顶面镀锡,底面有胶剂胶结片。
• 在修整出新焊盘之前,小心地刮去新焊盘背面上焊锡点连接区域的胶剂胶结片。只从焊点连接区域刮掉树脂衬底。这样将
允许暴露区域的焊接。当处理替换焊盘时,避免手指或其它材料接触树脂衬底,这样可能污染表面,降低粘结强度。
• 剪切和修整新的焊盘。从镀锡边剪下,剪留的长度保证最大允许的焊接连线搭接。
•在新焊盘的顶面放一片高温胶带,将新的焊盘放到PCB表面的位置上,用胶带帮助定位。在粘结期间胶带保留原位。
• 选择适合于新焊盘形状的粘结焊嘴,焊嘴应该尽可能小,但应该完全覆盖新焊盘的表面。
• 定位PCB,使其平稳。轻轻将热焊嘴放在覆盖新焊盘的胶带上。施加压力按修理系统的手册推荐的。注意:过大的粘结压
力可能引起PCB表面的斑点,或者引起新的焊盘滑出位置。
• 在定时的粘结时间过后,抬起烙铁,去掉用于定位的胶带。焊盘完全整修好。仔细清洁区域,检查新焊盘是否适当定位。
• 蘸少量液态助焊剂到焊接连线搭接区域,把新焊盘的连线焊接到PCB表面的线路上。尽量用最少的助焊剂和焊锡来保证可
靠的连接。为了防止过多的焊锡回流,可在新焊盘的顶面放上胶带。
• 混合树脂,涂在焊接连线搭接处。固化树脂。用最大的推荐加热时间,以保证最高强度的粘结。BGA焊盘通常可经受一两
次的回流周期。另外可在新焊盘周围涂上树脂,提供额外的胶结强度。
• 按要求涂上表面涂层。
在焊盘修理之后,应该做视觉检查(包括新焊盘的宽度和间隔)、和电气连接测量。本程序的结果是又一块PCB被修复,因而
少一块PCB丢入垃圾桶,为“底线(bottom line)”作出积极贡献。



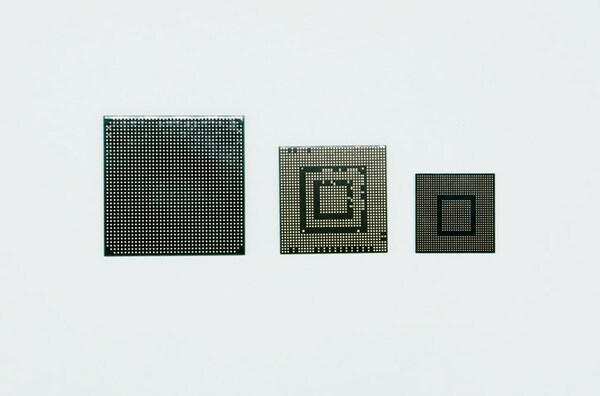

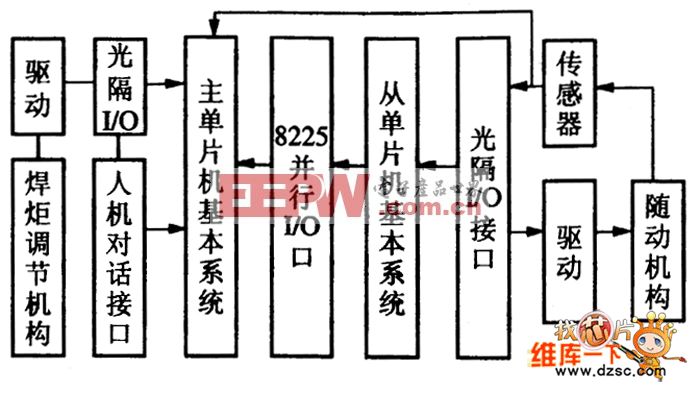









评论