化学机械抛光 Slurry 的蜕与进
岳飞曾说:“阵而后战,兵法之常,运用之妙,存乎一心。”意思是说,摆好阵势以后出战,这是打仗的常规,但运用的巧妙灵活,全在于善于思考。正是凭此理念,岳飞打破了宋朝对辽、金作战讲究布阵而非灵活变通的通病,屡建战功。如果把化学机械抛光 (CMP,Chemical Mechanical Polishing)的全套工艺比作打仗用兵,那么CMP工艺中的耗材,特别是slurry的选择无疑是“运用之妙”的关键所在。
“越来越平”的IC制造
2006年,托马斯•弗里德曼的专著《世界是平的》论述了世界的“平坦化”大趋势,迅速地把哥伦布苦心经营的理论“推到一边”。对于IC制造来说,“平坦化”则源于上世纪80年代中期CMP技术的出现。
CMP工艺的基本原理是将待抛光的硅片在一定的下压力及slurry(由超细颗粒、化学氧化剂和液体介质组成的混合液)的存在下相对于一个抛光垫作旋转运动,借助磨粒的机械磨削及化学氧化剂的腐蚀作用来完成对工件表面材料的去除,并获得光洁表面(图1)。

1988年IBM开始将CMP工艺用于4M DRAM器件的制造,之后各种逻辑电路和存储器件以不同的发展规模走向CMP。CMP将纳米粒子的研磨作用与氧化剂的化学作用有机地结合起来,满足了特征尺寸在0.35μm以下的全局平坦化要求。目前,CMP技术已成为几乎公认的惟一的全局平坦化技术,其应用范围正日益扩大。
目前,CMP技术已经发展成以化学机械抛光机为主体,集在线检测、终点检测、清洗等技术于一体的CMP技术,是集成电路向微细化、多层化、薄型化、平坦化工艺发展的产物。同时也是晶圆由200mm向300mm乃至更大直径过渡、提高生产率、降低制造成本、衬底全局平坦化所必需的工艺技术。





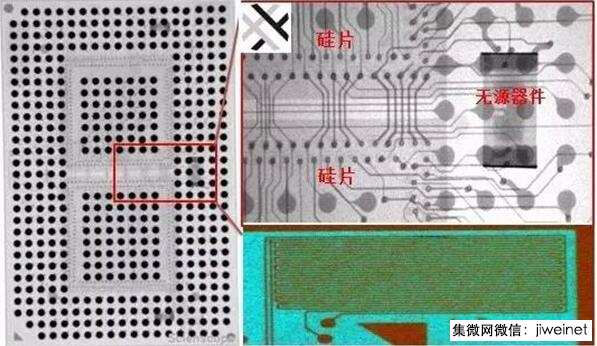
评论