LED封装技术的发展趋势
LED封装技术目前主要往高发光效率、高可靠性、高散热能力与薄型化四个方向发展,目前主要的亮点有硅基LED和高压LED,硅基LED之所以引起 业界越来越多的关注,是因为它比传统的蓝宝石基底LED的散热能力更强,因此功率可做得更大,Cree就重点在发展硅基LED,它目前存在的主要问题是良 率还较低,导致成本还偏高。
高压LED是另一大亮点,它因可大幅缩小DC-DC降压电路的输入输出压差,而进一步提升LED驱动电源的效率,这可有效降低LED灯具对散热外壳的要求,从而降低LED灯具的总体成本。目前Cree、Osram和亿光都在发展高压LED工艺。
LED封装原理
有更好的发光效率与好的散热环境,好的散热环境进而提升LED的使用寿命。LED封装技术主要建构在五个主要考虑因素上,分别为光学取出效率、热阻、功率耗散、可靠性及性价比(Lm/$)。
以上每一个因素在封装中都是相当重要的环节,举例来说,光取出效率关系到性价比;热阻关系到可靠性及产品寿命;功率耗散关系到客户应用。整体而言,较佳的封装技术就是必须要兼顾每一点,但最重要的是要站在客户立场思考,能满足并超出客户需求,就是好的封装。
针对LED的封装材料组成,林治民详细解说道,LED封装主要是由基板、芯片、固晶胶、荧光粉、封装胶等组成,我们先将芯片利用固晶胶黏贴于基板 上,使用金线将芯片与基板作电性连接,然后将荧光粉与封装胶混合,搭配不同荧光粉比例,以及适当的芯片波长可得到不同的颜色,最后将荧光粉与封装胶的混合 体灌入基板中,加热烘烤使胶材固化后,即完成最基本的LED封装。
他并指出,LED封装技术主要是往高发光效率、高可靠性、高散热能力与薄型化发展。从芯片来看,目前最普遍的是水平式芯片, 比较高端的厂商则研发垂直式芯片与覆晶型芯片,原先水平式LED使用蓝宝石基板,散热能力较差,且在高电流驱动下,光取出效率下降幅度也较大。因此,为了 降低LED成本,高电流密度的芯片设计便以获取更多的光输出为主要研究方向,在这样的考虑下,使用垂直式封装的芯片便成为下一课题,此类芯片使用硅等高散 热基板,在高电流操作下有更好的散热效率,所以也有更高的光输出,但由于制作流程复杂,工艺良率过低,以致于无法达到理想的高性价比,由此可知,在高瓦数 封装上,工艺良率所导致的价格因素也是一大考虑。
台积电子公司采钰科技便是专攻晶圆级高功率LED硅基封装技术的业者。该公司在2010年已打入中国路灯市场,2011年更将重心放在室内照明球泡 灯产品上。采钰科技LED技术研发处长李豫华表示,以8吋磊晶计算,目前采钰封装产能为单月2千片、相当于400万颗,去年产品成功打入中国路灯产品,量 大的时候甚至单月出货量高达70-80万颗。
与一般台湾LED封装厂商采用的氧化铝(蓝宝石)基板技术不同,采钰采用的是晶圆级LED硅基封装技术,采钰李豫华表示,硅基封装LED在散热方面 优于蓝宝石基板,但目前售价也高于蓝宝石基板的产品,不过,李豫华认为在今年内,采钰硅基封装与蓝宝石基板产品的价格将趋于一致,采钰更订下目标,希望每 年成本下降幅度可达到30%。
硅基板的良率尚低
硅基板的最大诉求为导热更佳,李豫华进一步指出,次世代照明的LED封装需求最重要的就是散热问题,估计热的问题5年内难解,其次则是需要强而有力 的结构体和稳定可靠的材料。另外光的表现也很重要,像均匀性、光源强度、出光效率是否更优异以及光的型式表现,最后就是量产和成本方面的管理。
LED封装在这30年的演进,最大的特色就是尺寸愈来愈小,因此热效应问题在输入驱动电流较高时便凸显出来。也就是说,现在高功率LED需求愈来愈 大,当放进小颗LED并将电源灌入后,热量便会产生,为了要降低热,光的亮度就会减小,这时为了要增加亮度,又得导入更高的电流,高电流又会产生更多的 热,如此成为一个循环,热量就不断增加。接合温度过高,结果便是每升高20℃,LED效能就要降低5%(或每增加1℃,效能降0.25%)。
LED产生的90%热量都是向下走,因此封装技术中,散热十分重要。整体而言,可供选择的高功率LED次安装基台(sub-mount)材料有陶瓷(氧化铝、氮化铝)和硅。其中,铝基板有翘曲问题,且以导热系数和热扩散来看,硅是最佳选择。
硅基LED封装工艺流程为:绝缘及金属层、芯片/金属线键结及荧光材料涂布、透镜组装,再进行切割与测试。使用硅晶圆方法可以藉以控制穿孔型式(单 一或多重),因而增加光萃取率,这是陶瓷基板所做不到的。李豫华并特别指出采钰独家的IC制造兼容晶圆级荧光粉涂布技术,可以在LED芯片最上层造就薄而 高效能的荧光粉出光层,可改善黄晕现象,且此技术可控制色温的一致性。
另外,半球形镜头为以光学设计方式增加出光率的方法之一,也是采钰独家设计的晶圆级产品,镜头设计符合各种出光形式的需求。此外,利用不同材料的折 射率不同,由内而外愈来愈小,亦可控制出光路径使其出光率增加,此结构模式可改善出光率逾7%。再者,藉由荧光粉补偿过程可以达到紧密的色温控制,因而良 率可获得提升,使原本低于70%的良率,经由补偿可以提升超过95%。目前采钰的LED硅基封装成品已经在多处导入,包括大陆秦皇岛、大陆京沈高速公路匝 道的LED路灯及新竹清华大学校园等。
不过,LED硅基封装仍有许多技术上面临的挑战需要克服,例如材料方面,硅材有容易碎裂的缺点,且机构强度也是问题所在。荧光粉则需考虑其电子亮度和热及湿阻抗。另外,镜头的折射率及热稳定度、粘着性等都是考虑点。结构方面,绝缘层、金属层都有其挑战。
采钰专攻LED照明,目前并没有跨入LED大尺寸背光源的计划。在2012年台湾、日本、美国、加拿大将开始禁用白炽灯泡的政策下,采钰认为,2011年第3季LED暖白色球泡灯销售量将爆发性成长,公司也将球泡灯产品列入今年的发展重点。
除了上述垂直式芯片外,覆晶型芯片也是业界极力发展的目标。覆晶型芯片的制作较立体型简单许多,且可避掉复杂工艺,使得量产可行性大幅提升,加上后 端芯片工艺金手指和过孔技术成熟辅助,以往必须种植多颗金球的固晶方式转变为大面积P、N电极直接黏着支架,搭配上eutectic固晶方式,更大大的简 化了覆晶型芯片封装的技术门坎,再者,缩短的封装散热路径,相较于水平式芯片有较佳的散热能力,驱动电压也可下降,林治民强调,在未来节能减碳的驱动下, 覆晶型芯片封装会是很好的解决方案。
基于上述封装的考虑,亿光目前采用的主要封装技术为荧光粉涂布以及转注工艺。荧光涂布是亿光发展的技术,主要是在芯片上覆盖一层薄薄的荧光层,如此可大幅提升组件的发光效率,目前亿光已将此产品运用在高功率件上。
转注工艺技术则原本是使用在小型的表面贴装型产品上面,林治民表示,亿光在此产品上获得了很大的成功,并进一步将此技术运用在高功率机种上,克服了 硅成型与粘模等技术问题,目前由于TV等背光组件功率的提升与信赖性的要求,传统的PPA反射盖基板为有机材料,无法像硅或树脂提供较佳的耐热与耐光能 力,为了有效提升信赖性,亿光也计划将此转注工艺技术运用在背光组件的产品上。
关于封装尺寸,目前亿光电子实验当中所能达成之最小高功率封装体尺寸为3.0 ×3.0mm,甚至是2.0×2. 0mm以下的样品制备,然而目前市售最普遍的规格仍为3.5×3.5mm产品,此一产品的应用面极为广泛,因此,亿光林治民表示,身为开启固态照明时代的 先锋分子,亿光电子将持续将小尺寸高功率技术应用于此产品上,以低成本的氮化铝陶瓷基板搭配高反射率的反射镜实施,制作此项产品所需的封装支架,另外并会 应用共金固晶的工艺技术,藉由金属快速的将热由LED中心地带导向高导热的氮化铝陶瓷,以期降低LED组件的操作温度,达成高效率(150lm/w)、高 功率(3-5W操作)、长寿命(60000hrs)、低能耗的LED产品表现。
再者,芯片的选择也非常重要,林治民表示,亿光将与全球的优质合作伙伴共同致力于现有芯片的质量改良与降低成本,以及新芯片结构的快速开发,以期能 以成本最低之大量生产的硅胶压模工艺技术,降低现有LED芯片工艺的封装成本,并以快速反应的光学结构设计符合新设计芯



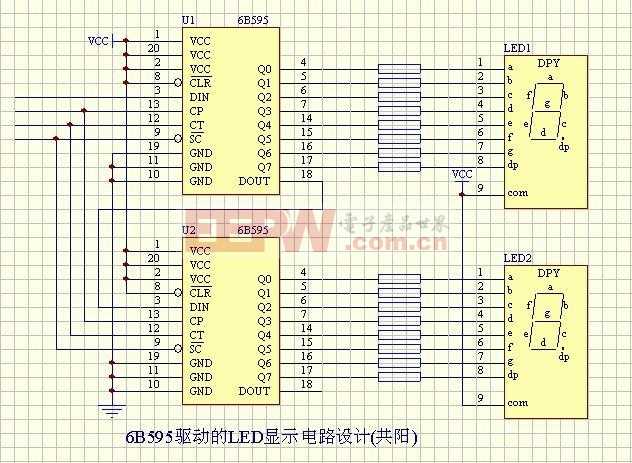


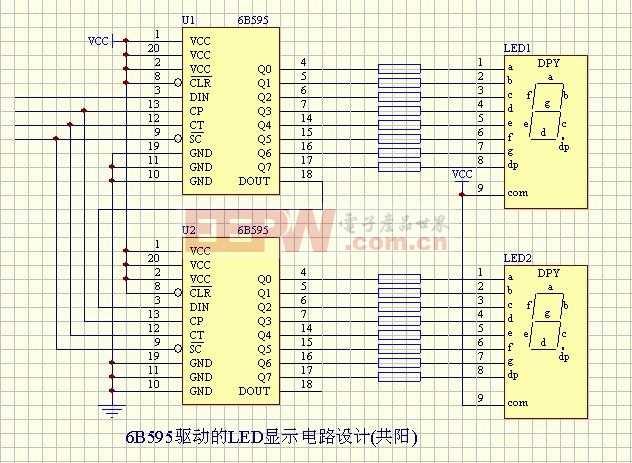







评论