550V无电压折回逆导型横向绝缘栅双极晶体管器件设计
摘要:仿真结果显示:在几乎相同的耐压和反向导通能力下,由于更小的器件尺寸,本文提出的器件获得了更高的电流密度;本文器件的导通压降与关断损耗分别相比于传统器件降低14.4%和62.2%,实现了更好的导通压降与关断损耗的折中。
本文引用地址:https://www.eepw.com.cn/article/202204/433440.htm0 引言
由于兼具双极晶体管的低导通压降以及场效应晶体管具有的高输入电阻、高速开关等优点,IGBT已经成为了高频功率开关器件领域中的主流器件,并且被广泛应用于交通、智能电网等诸多领域[1-3]。传统的IGBT器件在反向状态下无法导通,一般需要并联1个快恢复二极管(FRD)用以续流保护,然而这会增加额外的封装成本和面积。逆导型绝缘栅双极晶体管(RC-IGBT)[4]通过将IGBT器件和FRD集成在同一元胞上,解决了两者的封装问题,具有小器件尺寸、高电流密度、低封装成本等优点。
最初的RC-IGBT器件为纵向器件,然而随着绝缘体上硅(SOI)技术的出现与发展,RC-LIGBT开始成为功率器件领域内的一大研究热点。阳极短路LIGBT(Shorted Anode LIGBT, SA-LIGBT)[5]即为最传统的RC-LIGBT器件,通过1个与阳极P区短接的N+区实现了其反向导通的能力,然而器件也因此在正向导通态下会发生电压折回现象,器件的正向导通压降会增加,并且可靠性也会受到影响。因此,如何解决电压折回现象带来的不利影响,是RC-LIGBT器件需要解决的核心问题之一。
为了解决以上问题,国内外学者也提出了诸如分离式阳极短路LIGBT(Separated SA-LIGBT, SSALIGBT)[6]、阳极隔离槽栅LIGBT(Segmented Trenches in the Anode LIGBT, STA-LIGBT)[7]等器件结构,这些器件能够在一定程度上降低电压折回现象的影响,但不能完全消除电压折回现象,还会导致更大的器件尺寸、更差的正向导通压降Von与关断损耗Eoff间折中关系等问题。
本文提出了一种基于SOI技术的耐压550 V的新型RC-LIGBT,该器件通过将FRD集成在位于埋氧层下的衬底上,利用埋氧层优良的绝缘和隔离特性,在集成的同时实现了对FRD与RC-LIGBT器件的电学隔离,完全消除了电压折回现象,并且兼具更小的器件尺寸以及更好的Von-Eoff折中关系等优点。
1 器件结构和工作原理
图1(a)为传统SSA-LIGBT器件的二维结构示意图,LB为阳极P+区与N+区之间的间距,当阳极施加较小的正向电压时,阳极P+/N-Buffer形成的PN结未导通,来自阴极的电子经过P-Base内部沟道区,N-Drift漂移区,N-Buffer区以及LB所示区域,最终被N+阳极区收集[8],此时器件将工作在MOS模式下,电流密度较小;当正向电压不断增大至P+/N-Buffer结导通时,大量空穴注入至N-Drift漂移区,与此同时大量电子被P+阳极区收集,漂移区内发生电导调制效应,器件工作模式便由MOS模式转变至普通IGBT模式,电流密度显著增大,正向压降减小,此时便会发生电压折回(snapback)现象。通过增大LB可以增大P+阳极与N+阳极之间的电阻RB,使电子更难被N+阳极区收集,器件将更快从MOS模式过渡到IGBT模式,从而减小电压折回现象的影响,但是这会显著增大器件的尺寸。
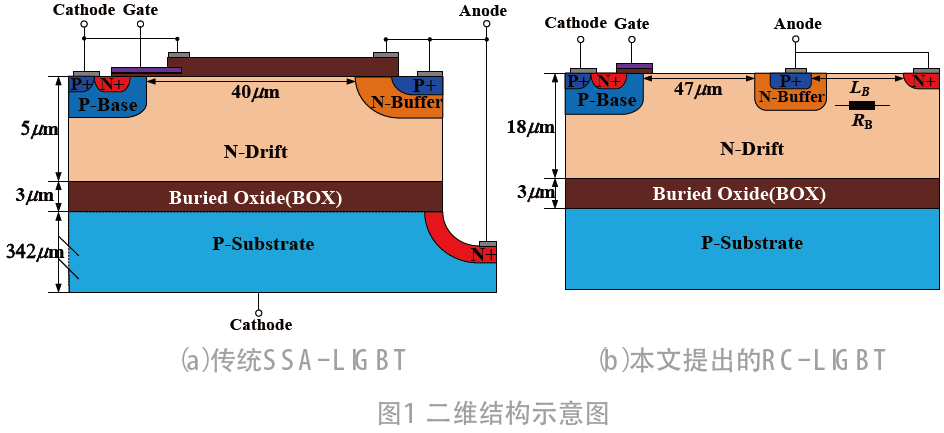
图1(b)为本文提出RC-LIGBT器件的二维结构示意图,埋氧层上的SOI层为普通的LIGBT,通过在埋氧层下P型衬底内引入一个N+区,N+区接阳极,衬底接阴极,两者形成的FRD便与SOI层的LIGBT集成在了1个元胞上。在正向状态下,阳极施加正向电压,埋氧层下的FRD处于关断状态,同时由于埋氧层优良的隔离特性,衬底的N+区与SOI层以及P+阳极区实现了电学隔离,N+区将无法收集电子,器件将一直工作在普通IGBT模式下,从而能实现完全消除电压折回现象;在反向状态下,SOI层的LIGBT处于关断状态,而此时衬底下的FRD将处于正偏状态而导通,从而实现器件的反向导通特性。除此之外,SOI层表面使用场板来增加LIGBT的耐压,FRD冶金结面设计为柱面结,并且N+区注入结深足够深(7.5 mm)来提高FRD的耐压[9]。相关器件关键参数如表1所示。
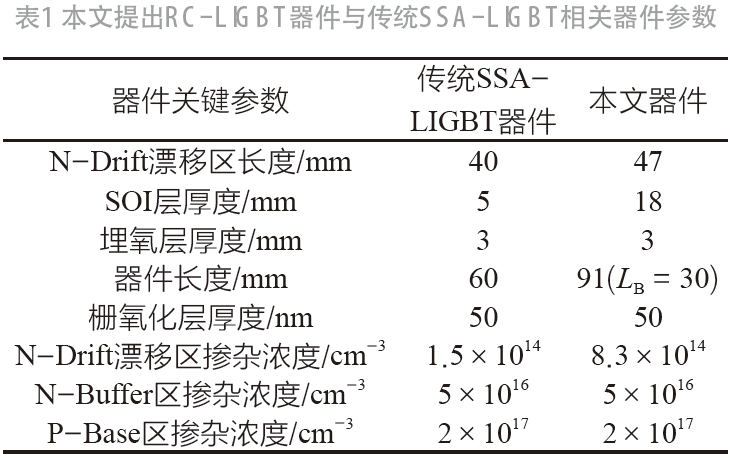
2 仿真结果
传统SSA-LIGBT器件与本文提出RC-LIGBT器件的仿真均基于Synopsys公司的Sentaurus TCAD tools工具下进行。图2为传统SSA-LIGBT器件与文章提出RCLIGBT器件的击穿特性曲线,如图所示,传统器件的击穿电压为560 V,文章提出器件的击穿电压为567 V,两者耐压处于同一水平。
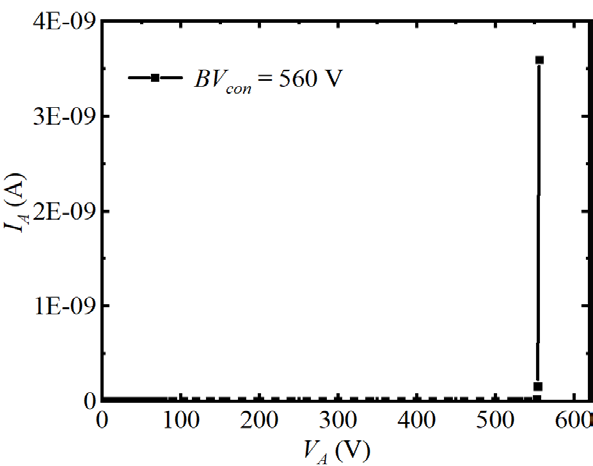
(a)传统SSA-LIGBT

(b)本文提出RC-LIGBT器件
图2 击穿特性曲线
图3为本文提出RC-LIGBT器件与传统SSA-LIGBT器件在栅压为10 V下的正反向输出特性曲线对比图,其中图3(a)为本文器件与不同LB长度的传统SSALIGBT(15 mm, 30 mm, 45 mm)的正向电流-电压输出特性曲线对比图。如图所示,对于传统的SSA-LIGBT器件,随着LB长度的增加,折回电压VS(电压折回现象发生时的阳极电压)减小,根据前一小节的分析,在正向状态下,当器件工作于MOS模式,LB长度的增加使电子电流路径上的电阻增加,器件工作模式能够在更低的阳极电压下转换为IGBT模式,从而减小了电压折回现象的影响。然而从仿真结果可知,即使在LB长度高达45 mm时,电压折回现象依然存在,并且当器件工作于IGBT模式时,过大的器件尺寸也会使器件的电流密度降低。相比于传统SSA-LIGBT,根据上一小节分析以及仿真结果所示,本文提出RC-LIGBT器件通过埋氧层对SOI层和FRD的电学隔离,完全消除了电压折回现象,同时由于没有额外的LB,本文提出器件的尺寸低于传统器件,因而获得了更高的电流密度。
由图3(a)可知,在LB长度从15 mm增加至30 mm时,折回电压VS明显减小;然而在LB长度从30 mm增加至45mm时却没有明显的改善,因此在后面的仿真中均采用LB = 30 mm的SSA-LIGBT器件。图3(b)为本文器件与传统SSA-LIGBT(LB = 30 mm)的反向电流-电压输出特性曲线,由图可知本文提出RC-LIGBT器件在反向状态下通过集成在衬底的FRD实现了其反向导通特性。
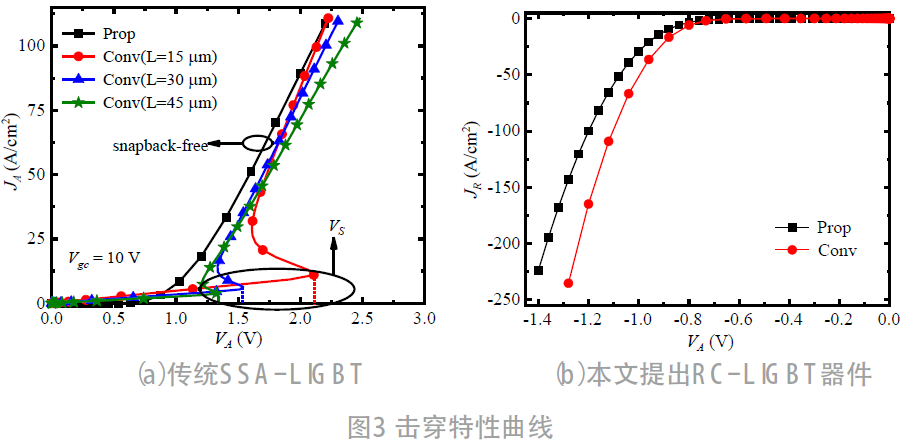
图4 为本文提出RC-LIGBT器件与传统SSALIGBT,以及文献[10]与文献[11]中的RC-LIGBT器件,在正向导通电流密度JA = 100 A/cm2条件下的正向导通压降Von与关断损耗Eoff 折中曲线,由图可知,相比于传统SSA-LIGBT(3.99 mJ/cm2),在Von=1.95 V的条件下,本文器件的Eoff(1.51 mJ/cm2)降低了62.2%;在Eoff = 3.99 mJ/cm2条件下,本文器件的Von(1.67 V)降低了14.4%,可见,获得了比传统器件更好的Von-Eoff折中关系。除此之外,由图中曲线可看出,本文器件的Von-Eoff折中特性也优于文献[10]和文献[11]中提出的LIGBT器件。
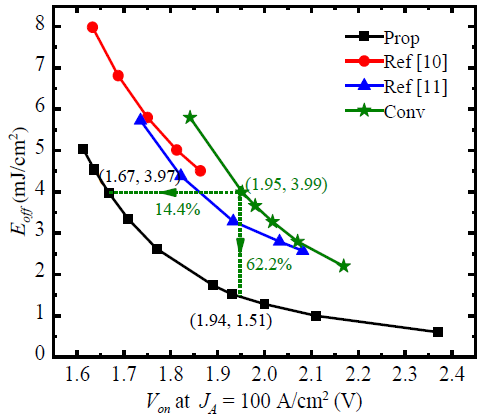
图4 本文提出器件与不同RC-LIGBT的Von-Eoff折中关系对比
3 结论
本文提出了一种基于SOI的耐压为550 V的无电压折回RC-LIGBT器件。通过在埋氧层下P型衬底注入N+阳极区,在实现LIGBT器件与FRD集成在1个元胞的同时,利用埋氧层的优良隔离特性,使N+阳极区与P+阳极实现了电学隔离,从而完全消除了电压折回现象的影响。并且由于没有传统SSA-LIGBT中额外LB的器件长度,本文提出器件的电流密度高于传统SSA-LIGBT器件。仿真结果表明:相比于传统SSA-LIGBT器件,本文提出RC-LIGBT器件实现了更好的Von-Eoff折中关系。此外,由于衬底电极与阴极短接,本文提出器件可应用于诸如零电压开关(ZVS)和零电流开关(ZCS)Boost变换器电路等领域中[12]。
参考文献:
[1] SAKURAI N,MORI M,YATSUO T. High speed high current capacity LIGBT and diode for output stage of high voltage monolithic three-phase inverter IC[C].The 1990 International Symposium on Power Semiconductor Devices & IC’s (ISPSD),IEEE,1990:66-71.
[ 2 ] N A K A G A W A A , F U N A K I H , Y A M A G U C H I Y , e t al. Improvement in lateral IGBT design for 500 V 3 A o n e c h i p i n v e r t e r I C s [ C ] . T h e 1 9 9 9 I n t e r n a t i o n a l Symposium on Power Semiconductor Devices & IC’s (ISPSD),Toronto:IEEE,1999: 321-324.
[3] GOUGH P A,SIMPSON M R,RUMENNIK V. Fast switching lateral insulated gate transistor[C].The 1986 I n t e r n a t i o n a l E l e c t r o n D e v i c e s M e e t i n g , L o s Angeles:IEEE,1986:218-221.
[4] TAKAHASHI,YAMAMOTO,AONO,et al.1200V reverse conducting IGBT[C].The 2004 International Symposium on Power Semiconductor Devices and ICs,Kitakyushu:IEEE,2004:133-136.
[5] GOUGH P A,SIMPSON M R,RUMENNIK V.Fast switching lateral insulated gate transistor[C].The 1986 Electron Devices Meeting,IEEE,1986:218-221.
[ 6 ] C H U L J H , B Y E O N D S , O H J K , e t a l . A f a s t - s w i t c h i n g S O I S A - L I G B T w i t h o u t N D R r e g i o n [ C ] .T h e 2 0 0 0 P o w e r S e m i c o n d u c t o r D e v i c e s a n d IC’s(ISPSD),IEEE,2000:149-152.
[7] PARK J M,WAGNER S,GRASSER T,et al.New SOI lateral power devices with trench oxide[J].Solid-State Electronics,2004, 48(6):1007-1015.
[8] LIN Z,CHEN X.A new solution for superjunction lateral double diffused MOSFET by using deep drain d i f f u s i o n a n d f i e l d p l a t e s [ J ] . I E E E E l e c t r o n De v i c e Letters,2015,36(6):588-590.
[9] ZHU J,et al. Electrical characteristic study of an SOILIGBT with segmented trenches in the anode region[J].IEEE Transactions on Electron Devices,2016,63(5):2003-2008.
[10] LUO X R,et al.A snapback-free fast-switching SOI LIGBT with an embedded self-biased n-MOS[J].IEEE Transactions on Electron Devices,2018,65(8):3572-3576.
[11] LUO X,et al.A snapback-free and low-loss shortedanode SOI LIGBT with self-adaptive resistance[J].IEEE Transactions on Electron Devices,2019,66(3):1390-1395.
[12] CANESIN C A,BARBI I.Comparison of experimental losses among six different topologies for a 1.6 kW b o o s t c o n v e r t e r , u s i n g I G B T s [ C ] . T h e 1 9 9 5 Po w e r Electronics Specialist Conference(PESC),Atlanta:IEEE,1995:1265-1271.
(本文来源于《电子产品世界》杂志2020年9月期)




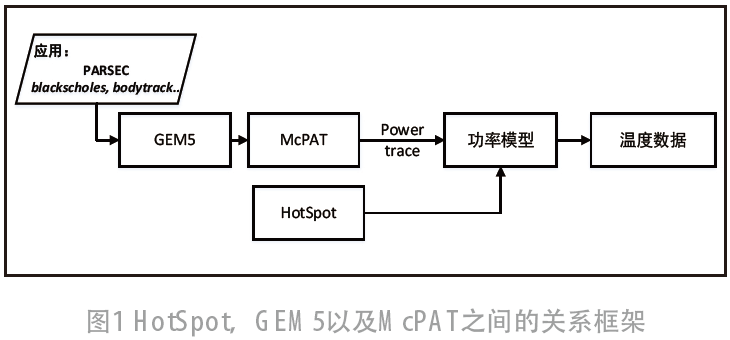




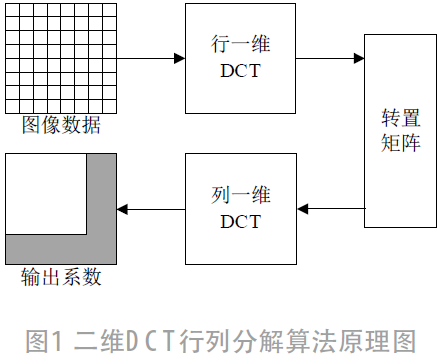

评论