什么是IGBT?如何使用此模块实现“双面水冷”,IGNT未来的发展趋势又是如何?
什么是IGBT?
IGBT(Insulated Gate Bipolar Transistor),绝缘栅双极型晶体管,是由BJT(双极型三极管)和MOS(绝缘栅型场效应管)组成的复合全控型电压驱动式功率半导体器件, 兼有MOSFET的高输入阻抗和GTR的低导通压降两方面的优点。GTR饱和压降低,载流密度大,但驱动电流较大;MOSFET驱动功率很小,开关速度快,但导通压降大,载流密度小。IGBT综合了以上两种器件的优点,驱动功率小而饱和压降低。非常适合应用于直流电压为600V及以上的变流系统如交流电机、变频器、开关电源、照明电路、牵引传动等领域。IGBT模块是由IGBT(绝缘栅双极型晶体管芯片)与FWD(续流二极管芯片)通过特定的电路桥接封装而成的模块化半导体产品;封装后的IGBT模块直接应用于变频器、UPS不间断电源等设备上;IGBT模块具有节能、安装维修方便、散热稳定等特点;当前市场上销售的多为此类模块化产品,一般所说的IGBT也指IGBT模块;随着节能环保等理念的推进,此类产品在市场上将越来越多见;IGBT是能源变换与传输的核心器件,俗称电力电子装置的“CPU”,作为国家战略性新兴产业,在轨道交通、智能电网、航空航天、电动汽车与新能源装备等领域应用极广。
本文引用地址:https://www.eepw.com.cn/article/201710/365409.htm
怎样用IGBT模块实现双面水冷?这项技术又有何意义?
Infineon 的德国团队和美国团队(前IR团队)发表了两篇关于双面水冷的IGBT模块的相关设计及测试结果。原文标题如下
“Dual-sided Cooling for AutomoTIve Inverters – PracTIcal ImplementaTIon with Power Module”
从应用角度而言,双面水冷技术(DSC)的开发即是基于新能源汽车(纯电动及混动)的应用考虑,主要为了解决车载逆变器功率密度的问题。图1给出其基本结构,相比现有IGBT模块,芯片上层的DCB构成第二条散热通道,用于改善模块的散热效果。
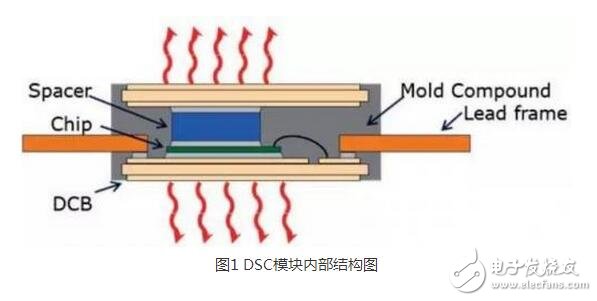
图2 的样品照片,模块的尺寸较小,顶部和底部通过DCB陶瓷基板直接和散热器接触,强电和弱电端子分布在芯片的前后两侧。
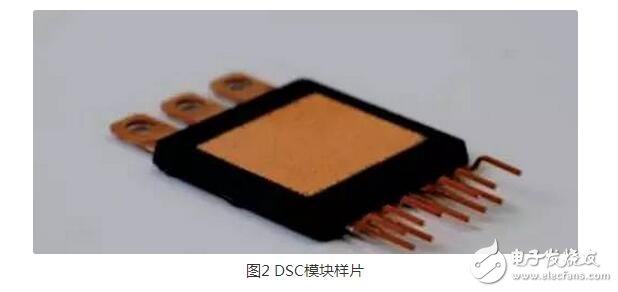
作为双面水冷模块,其塑封材料不同温度下的机械一致性首先需要保证,22、150摄氏度下的模块表面平整度较好,同时防潮性能也比较优异。
由于增加了模块顶部的散热通道,散热效果剋提升70%,需要注意的是,热阻值随表面影响较大,要达到最佳的热阻,800N的压力这条确实也吓了笔者一跳。

由于去除了传统设计中的铜底板,模块的热容显著减小,其热耦合性能大幅提高,基本只在热源附近的芯片温度较高。同时,新的DSC模块还伴随着寄生电感和封装电阻的显著降低,寄生电感只有13nH。
此外,模块还集成了电流和温度传感器,便于实现芯片电流、温度的检测,这条与常规芯片倒没有特别的差异。电流检测基本都在百毫伏范围内。
相比德国团队的工作,前IR团队的研究重心则放在了与之配套的水冷散热的方案实现和性能测试上。图4给出了对应的水冷散热器方案。
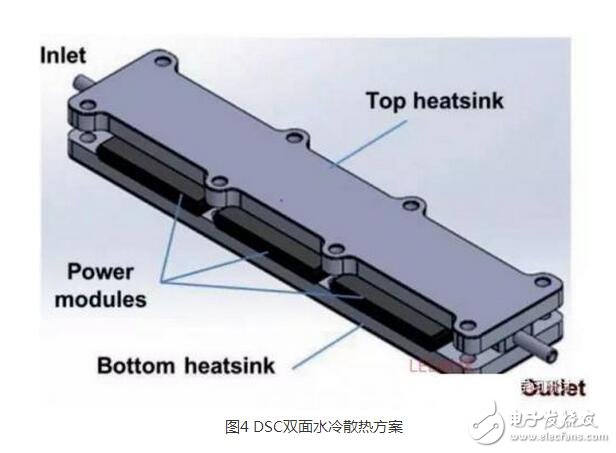
散热器内部还是使用经典的Pin-Fin散热方案,水冷设计的重点包括流量的均恒,散热流族 限制下的Pin针形状和大小的优化设计。基于同样的总流量假设,双面水冷较之单面水冷,热阻可以减小32%,同时水路压降跌落也只有其35%。同时,对于双面散热,仅增大27.5%的压力,就能获得双倍于单面水冷的总散热流量。
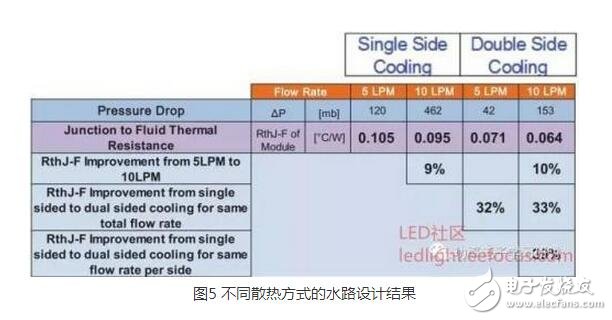
仿真结果显示,单面水冷下220摄氏度节温的模块采用双面水冷后节温只有175摄氏度。

针对着这种双面散热,其温度测量需要做一定修改,如增加相应的开孔及夹具固定。热测试的结果也印证了前文的设计和仿真结果 ,其中稳态热阻将达到30~40%的降低。同时可以发现,模块的热时间常数只有1.5s,大大小于带铜底板的常规IGBT模块。
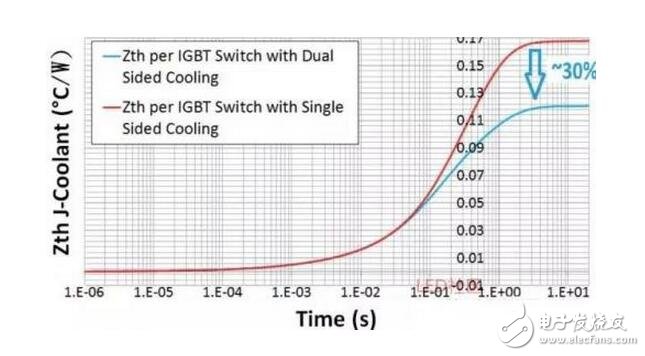
最后通电实验显示,同等条件下,采用双面水冷散热后,输出功率能够增加30%以上。作者同时预言如果采用更优化的水冷版设计,逆变器的电流能力能够增加50%甚至更多。
IGBT在未来的发展,以及发展趋势:
IGBT作为电力电子领域非常理想的开关器件,各种新结构、新工艺及新材料技术还在不断涌现,推动着IGBT芯片技术的发展,其功耗不断降低,工作结温不断升高,从125℃提升到了175℃并向200℃迈进,并可以在芯片上集成体二极管,形成逆导IGBT(RC-IGBT/BIGT),无需再反并联续流二极管,在相同的封装尺寸下,可将模块电流提高30%,还可以将电流及温度传感器集成到芯片内部,实现芯片智能化,如图所示。
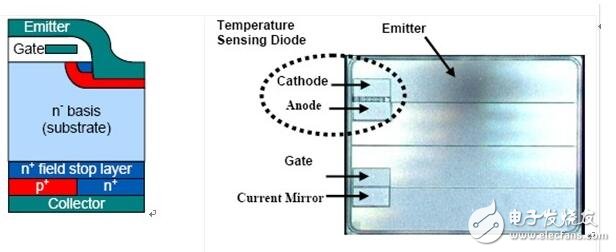
通过对IGBT芯片的边缘结构进行隔离处理,可以形成具有双向阻断能力的IGBT(RB-IGBT),在双向开关应用中无需再串联二极管,并具有更小的漏电流及更低的损耗 。
超结技术(super juncTIon)打破了传统硅器件的导通压降与耐压的极限关系(Ron∝VB2.5),可大大降低器件功耗,已成功应用在MOSFET上。将该技术应用在IGBT上,则可以进一步降低功耗,目前已受到广泛的关注。超结IGBT的主要难点是工艺实现,为了降低工艺难度,各种“半超结”结构被提出,实现性能与工艺的折中。
与此同时,IGBT的工艺水平也在不断提升,许多先进工艺技术,如离子注入、精细光刻等被应用到IGBT制造上。IGBT芯片制造过程中的最小特征尺寸已由5um,到3um, 到1um,甚至达到亚微米的水平。采用精细制造工艺可以大幅提高功率密度,同时可以降低结深,减小高温扩散工艺,从而使采用12英寸甚至更大尺寸的硅片来制造IGBT成为可能。随着薄片与超薄片加工工艺的发展,英飞凌在8英寸硅片上制造了厚度只有40um的芯片样品,不久的未来有望实现产品化应用。
此外,新材料如宽禁带半导体材料技术的发展,可以实现更低功耗、更大功率容量、更高工作温度的器件,其中SiC成为目前的大功率半导体的主要研究方向,并在单极器件上实现商品化,在IGBT等双极器件的研究上也不断取得进展。目前IGBT主要受制造工艺及衬底材料的缺陷限制,例如沟道迁移率及可靠性、电流增益较小及高掺杂P型衬底生长等问题,未来随着材料外延技术的发展,SiC IGBT将会实现突破。
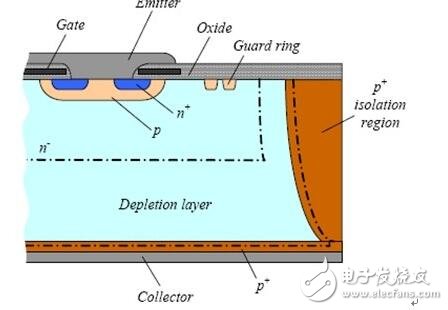
IGBT模块技术发展
随着IGBT芯片技术的不断发展,芯片的最高工作结温与功率密度不断提高, IGBT模块技术也要与之相适应。未来IGBT模块技术还将围绕芯片背面焊接固定与正面电极互连两方面不断改进,有望将无焊接、无引线键合及无衬板/基板等先进封装理念及技术结合起来,将芯片的上下表面均通过烧结或压接来实现固定及电极互连,同时在模块内部集成更多其他功能元件,如温度传感器、电流传感器及驱动电路等,不断提高IGBT模块的功率密度、集成度及智能度。
小结
本文从IGBT体结构、背面集电极区结构与正面MOS结构三方面分析了IGBT芯片的技术现状,目前IGBT芯片普遍采用平面栅或者沟槽栅结构,并运用软穿通体结构与透明集电极区结构技术,以及各种增强型技术,以提高综合性能和长期可靠性。高压IGBT模块技术还是以标准的焊接式封装为主,中低压IGBT模块产品则出现了很多新技术,如烧结取代焊接,压力接触取代引线键合,无衬板/基板封装等。未来IGBT将继续朝着集成化、智能化、小型化的方向发展。













评论