功率MOSFET抗SEB能力的二维数值模拟
摘要:在分析了单粒子烧毁(SEB)物理机制及相应仿真模型的基础上,研究了无缓冲层MOSFET准静态击穿特性曲线,明确了影响器件抗SEB能力的参数及决定因素。仿真研究了单缓冲层结构MOSFET,表明低掺杂缓冲层可提高器件负阻转折临界电流,高掺杂缓冲层可改善器件二次击穿电压,据此提出一种多缓冲层结构,通过优化掺杂浓度和厚度,使器件的抗SEB能力得到了显著提高。仿真结果显示,采用三缓冲层结构,二次击穿电压近似为无缓冲结构的3倍,负阻转折临界电流提高近30倍。
关键词:金属氧化物场效应晶体管;单粒子烧毁;二维数值模拟
1 引言
功率VDMOSFET晶体管以其开关速度快、输入电阻高、频率特性好、驱动能力高、跨导线性度高等特点,广泛应用在空间系统的电源电路中。但它在空间辐射环境中极易被重离子诱发SEB,造成功率变换器或电源电压的剧烈波动,可导致卫星的电子系统发生灾难性事故。国外对功率VDMOSFET的SEB效应研究较多。而我国起步较晚,在理论和实验上存在许多问题。
在此对功率MOSFET的SEB效应的机理进行了简单分析,并针对600 V平面栅VDMOSFET,利用半导体器件模拟软件Medici研究了缓冲层对提高MOSFET抗SEB能力的影响,提出利用多缓冲层结构改善MOSFET抗SEB能力的方案,最后给出一组优化后的多缓冲层结构。
2 SEB机理以及仿真物理模型
2.1 单粒子烧毁机制
SEB效应主要发生在器件阻断状态,由轰击到MOSFET发生SEB的原理如图1所示。重离子轰击产生的电子空穴对中的电子,在电场作用下向漏接触区(Drain Contact)移动,而空穴则在漏电场作用下沿迹线向p体区(p-body)运动,进入p-body区之后,横向运动,最后经p-body接触区流出。由于横向空穴流产生压降,致使远离电极接触区的p-body部分电位升高,造成p体区/n源极(p-body/n-source)结正偏,触发寄生npn晶体管的发射极向漂移区注入电子。由于此时MOSFET处于高压阻断态,电子的注入会改变空间电荷分布,造成电子在n漂移区/n+衬底(n-drift/n+-sub)高低结的积累,空间电荷区收缩,n-drift/n+-sub高低结处电场强度增加。随着重离子轰击强度增加,等离子体丝流增大,寄生npn晶体管发射结正偏程度增强,n-drift/n+-sub高低结处电场强度越来越高。当该电场增加到一定程度时,会激发雪崩倍增效应,漂移区电流增大,进而使寄生晶体管的发射结进一步正偏,此正反馈效应反复进行,最终可导致器件因电流过大、温度过高而烧毁。
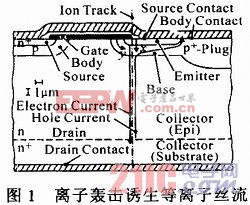
从SEB的失效机理可见,抑制SEB效应可从两方面入手:①降低寄生晶体管的电流增益,削弱晶体管作用,主要包括背栅短路、进行p+注入,增强源区下半导体导电能力、采用源区挖槽工艺,缩短源区宽度、减小寄生晶体管面积等:②优化电场分布,提高n-drift/n+-sub高低结处雪崩倍增效应发生的临界电流。由于这方面的研究相对较少,且主要采用单缓冲层结构,故这里在单缓冲层仿真结果的基础上,提出多缓冲层结构,并给出一组三缓冲层结构的优化结果。
电磁炉相关文章:电磁炉原理














评论