对使用铜丝键合的功率MOSFET进行失效分析
——
图5 对模塑料进行平行抛光。晶片(die)的高低相对于框架不是很平整,使得晶片的左上角先露了出来。
本文引用地址:http://www.eepw.com.cn/article/147852.htm
图6和图7显示的是铜丝键合的聚离子束横切面的照片,照片显示残留铝的最薄厚度是0.125 μm。这种键合是必须避免的,但如果没有很好的分析技术,就很难察觉。
采用化学刻蚀的办法,能够更快地测量出铜丝键合下面铝层的厚度,只把铜丝和键合腐蚀掉,同时完整无损地保留下面的铝层,就可以进行聚离子束的横切面分析。这种方法的优点是能看到整个晶片表面的所有铜丝键合,这样就可以选择合适的键合进行分析。
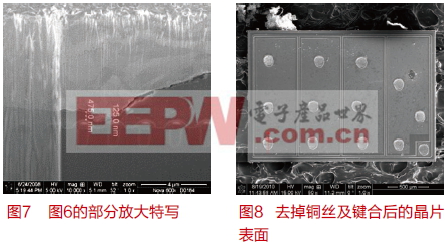
图8显示的是用酸刻蚀后的晶片表面。图9显示的是涵盖一个键合区域的聚离子束横切面。注意,从这幅图上可以清楚地看到最上面铝金属层,键合造成周围溢出了一些铝,这表明最上面的金属表面未曾受损。

采用传统的机械研磨的方式暴露出引线键合的横切面,在铜键合和键合下面金属的交界处,经常会发生铜胶着于表面的情况。先研磨,再用聚离子束进行精细抛光,就可以解决这个问题,如图10和图11所示。

案例研究一
首先,我们研究一组用铜丝键合的MOSFET,经过1000次的温度循环后,呈现高阻失效状态。要找到失效原因,需要对铜线两端进行仔细的检查。首先,我们先用激光开封,把钉架上铜键合露出来,这是因为传统的酸开封很容易损坏这些键合的缘故。
离子色谱仪相关文章:离子色谱仪原理












评论