TRIQUINT宣布采用其CuFlip 技术的器件已出货超1亿片
全球射频产品的领导厂商和晶圆代工服务的重要供应商TriQuint半导体公司,日前强调了其铜凸倒装晶片互连专利技术(CuFlip™)的成功,采用其铜凸倒装晶片技术的器件出货量已突破1亿大关。CuFlip (读作Copper Flip) 具有优异的射频性能和设计灵活性,可加快生产和组装速度。TriQuint产量最高的CuFlip™产品是TQM7M5012(HADRON II PA Module™功放模块),助力于全球各种主流的消费电子设备。
本文引用地址:https://www.eepw.com.cn/article/110883.htm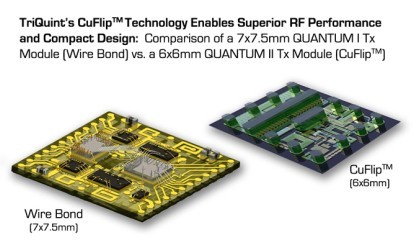
TQM7M5012的设计灵活性,,在其支持的广泛产品随处可见。30多家客户采用这一器件用于数据卡、上网本和电子阅读器、M2M设备以及许多业界最流行的3G智能手机上,如:
· 全球五大手机原始设备制造商(OEM)中的四家
· 全球三大数据卡提供商
· 全球五大智能手机制造商中的三家
· 全球最流行的无线阅读设备
TQM7M5012是一种5x5mm HADRON II Polar EDGE功率放大器模块(PAM),其尺寸比前代产品减少50%。这个高度集成的模块包含了功率放大器,适用于GSM/EDGE无线手机和GSM 850 / 900 / 1800 / 1900波段数据传输设备,同时支持class 12 GPRS模式和E2开环极性EDGE模式,在临界GMSK模式下,其耗电量和噪声性能达到最佳水平。从而显著提高了手机电池使用寿命和散热率。
TQM7M5012设计灵活性部分得益于TriQuint 独特的CuFlip™互连技术。CuFlip采用统一的的铜凸点提高了产品性能、可靠性和生产扩展性。凸点封装与丝焊不同,由于不需经过环氧体和背面镀金电路铜,因此有助于提高散热率和导电性,让更直接的的信号传输和更好的散热路径传送至器件。此外,CuFlip可以极大地降低z向高度,与同类产品相比整体尺寸更小,高度更低,支持超薄的设备设计。
CuFlip技术可以简化标准贴装技术(SMT)器件组装工艺的装配过程,有助于缩短生产周期,提高组装线产量。铜柱一致性可以确保精确的制造公差,提高参数成品率和产能利用率。
TriQuint半导体的中国区总经理熊挺指出:“CuFlip技术使TriQuint具备战略差异化的优势。CuFlip技术具有优异的射频性能和设计灵活性,可以加快产品组装速度,从而帮助我们的客户节省成本。”
TriQuint的CuFlip技术将用于即将推出的多种产品线,包括支持双波段和四波段、GSM/GPRS (2G)和 GSM/GPRS/EDGE (2.5G) 应用的QUANTUM Tx Module™系列,以及支持WCDMA/HSUPA应用的TRITON PA Module™系列。两种系列产品专门满足业界领先收发器芯片组供应商的需求。




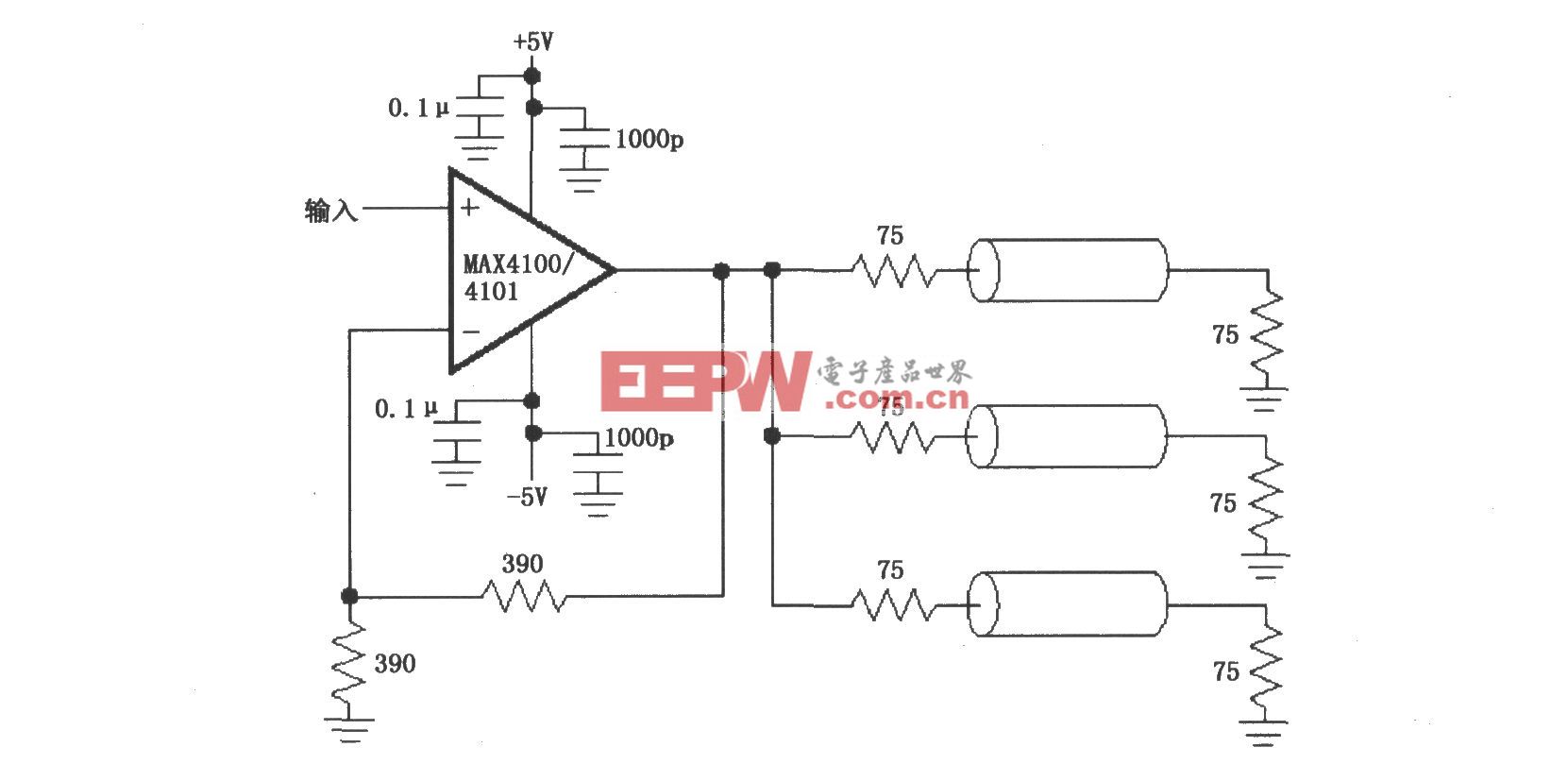



评论