EUV光刻,最终胜出!
来源:半导体行业观察
其中,光刻是摩尔定律的前沿阵地。
自从1958年世界上出现第一块平面IC开始,微电子技术之所以能够创造如此伟大的奇迹,光刻技术立下了汗马功劳。在所有半导体产品制造中,都需要通过光刻技术将电路图形转移到单晶表面或介质层上,光刻技术的不断突破推动着集成电路密度、性能不断翻倍,成本也愈加优化。
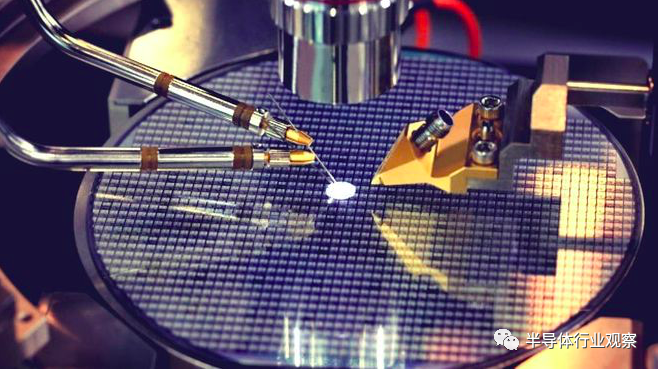 在过去的60年发展历程中,光刻技术一次又一次突破分辨率极限,使得IC制造技术的工艺极限不断被打破,摩尔定律不断在延伸。
在过去的60年发展历程中,光刻技术一次又一次突破分辨率极限,使得IC制造技术的工艺极限不断被打破,摩尔定律不断在延伸。回顾光刻技术发展历程,随着工艺节点的不断缩小,光刻技术主要经历了紫外光刻技术(UV)、深紫外光刻技术(DUV)和极紫外光刻技术(EUV)。光刻技术采用的光波长也随之从436nm、365nm、248nm,向193nm、13.5nm等延伸迭代。
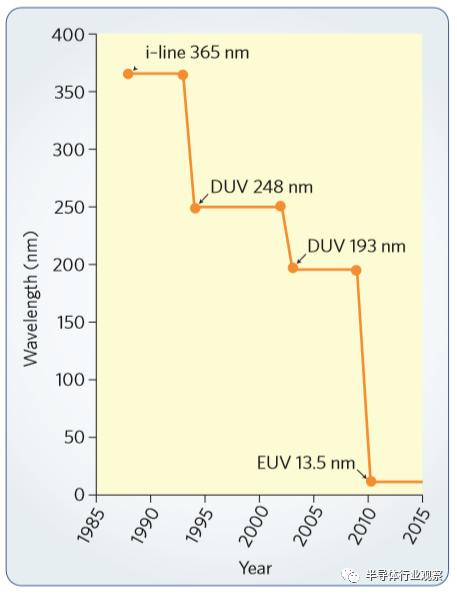 1980s以来,光刻技术采用的光波长变化(图源:ASML)回溯产业发展进程,光刻光源被卡在193nm无法进步长达20年。从上图也能看到,从193nm到13.5nm光波长之间,出现了一大段“真空地带”,光波长从193nm到EUV的13.5nm中间,曾经历过哪些波折,留下了哪些故事。
1980s以来,光刻技术采用的光波长变化(图源:ASML)回溯产业发展进程,光刻光源被卡在193nm无法进步长达20年。从上图也能看到,从193nm到13.5nm光波长之间,出现了一大段“真空地带”,光波长从193nm到EUV的13.5nm中间,曾经历过哪些波折,留下了哪些故事。时间退回到20世纪60年代,彼时距离ASML成立还有二十余年,集成电路已在美国加州海岸发展得如火如荼。
在集成电路制造全部流程中,光刻是最为关键的一环。光刻机的原理其实像幻灯机一样简单,就是把光通过带电路图的掩膜(Mask)投影到涂有光敏胶的晶圆上。早期60年代的光刻,掩膜版是1:1尺寸紧贴在晶圆片上,那时的晶圆也只有1英寸大小。
围绕光刻技术,GCA、Perkin-Elmer等公司开始了最初的技术与市场积累。在荷兰飞利浦实验室终于开始研发光刻机之际,GCA已经开发出了重复曝光光刻机,并将其推入了市场。
随着集成电路结构逐渐缩小,接触式光刻逐渐难以满足精度需求,产业开始寻求光刻技术全新的突破。
1970年代末,Perkin-Elmer凭借投影扫描光刻机获得了90%的光刻市场,一跃成为半导体行业最大的设备供应商。GCA也迅速推出第一台步进光刻机,与前者展开正面博弈。
直到1980年代初,美国的Prekin-Elmer和GCA主导着全球光刻机市场,日本的尼康、佳能开始显现出强劲的发展势头,开始从GCA和P&E手里夺下一个接一个大客户。而荷兰的飞利浦却陷入了停滞状态,1983年终于答应与ASM合作,此时其光刻机研发已经走到了穷途末路。
到了1984年,尼康已经和GCA平起平坐,各享三成市占率。Ultratech占约一成,Eaton、P&E、佳能、日立等剩下几家每家都不到5%。
同年,飞利浦与ASM合资创建的ASML成立,受不到重视的ASML被迫在飞利浦大厦外面的木板简易房里工作。
在竞争与演进中,时间来到八十年代中期,半导体市场陷入大滑坡。导致一帮光刻机厂商都碰到严重的财务问题,其中,入不敷出的ASM卖身自保,同时从ASML撤资;同样受到影响的还有GCA和Prekin-Elmer,由于新产品开发停滞不前,这两家曾经的巨头先后于1988年和1990年被General Signal和SVG收购。
而彼时ASML还规模尚小,所遭损失不大,还可以按既有计划开发新产品,得以在乱世中伛偻前行。而1980年还占据大半壁江山的美国三雄,到80年代末地位完全被日本双雄取代。这时ASML还只有大约10%的市场占有率。
光刻技术的岔路口从另一个角度来看,光刻市场的变化也对应着光刻技术的变迁。长期以来,摩尔定律被集成电路产业奉为圭臬。为了延续摩尔定律,光刻技术就需要每两年把曝光关键尺寸(CD)降低30%-50%。这就引出一个公式:CD=K1*λ/NA。从公式可以看出,曝光关键尺寸与波长、数值孔径以及制程因子三个参数有关。根据诉求,降低曝光关键尺寸,只需降低波长λ、增大数值孔径NA或降低制程因子K1。
其中,缩短波长是较为直接的手段。20世纪60年代到80年代中期的接触式光刻机、接近式光刻机和投影式光刻机主要采用汞灯光源,其光谱线分别为g线(436nm)、h线(405nm)和i线(365nm)。
随着技术演进,后续陆续开始使用248nm的KrF激光,进入1990年代,干式微影技术已经难以维系摩尔定律的演进,最终停滞在193nm波长的DUV光刻技术上,这就是著名的ArF准分子激光。
光刻机的光源波长被卡死在193nm,成为了摆在全产业面前的一道难关,也导致芯片制程在65/45nm技术节点上遇到了困难。
上世纪90年代后半期,大家都在寻找取代193nm光刻光源的技术,为了把193nm的光波“磨”细,大半个半导体业界都参与了进来,分成两队人马跃跃欲试:
尼康、佳能等公司主张用在前代技术的基础上,采用157nm波长光源,走稳健道路;新生的EUV LLC联盟则押注更激进的极紫外技术(EUV),用仅有十几纳米的极紫外光,刻10纳米以下的芯片制程。
但技术都已经发展到了这地步,不管哪一种方法做起来都不容易。
生不逢时的157nm干式光刻技术上面提到,光刻技术在追求更短波长光源的技术上卡住了。
2002年以前,业界普遍认为193nm光刻无法延伸到65nm技术节点,而157nm将成为主流技术。
157nm光刻被称为光学方法的极限,其光源采用氟气准分子激光,发出波长157nm附近的真空紫外光,最初的应用目标是65nm技术节点。
实际上,157nm波长的光刻技术其实在2003年就有光刻机了。然而,157nm光刻技术遭遇到了来自光刻机透镜的巨大挑战。这是由于绝大多数材料会强烈地吸收157nm的光波,只有二氟化钙(CaF2)勉强可以使用。但研磨得到的CaF2镜头缺陷率和像差很难控制,并且价格相当昂贵,雪上加霜的是它的使用寿命也极短,频繁更换镜头让芯片制造业无法容忍。另外,157nm对193nm的波长进步只有不到25%,研发投入产出比太低。
正当众多研究者在157nm浸入式光刻面前踌躇不前时,时任台积电资深处长的林本坚提出了193nm浸入式光刻的概念。
林本坚认为,与其在157nm上“撞墙”,倒不如倒退到193nm波长但将介质从空气改为水,以水为透镜在晶圆和光源间注入纯水,目前主流采用的纯净水的折射率为1.44,所以ArF加浸入技术实际等效的波长为193 nm/1.44=134 nm,从而实现更高的分辨率。
然而在当时,这项技术却被尼康、佳能等头部企业拒之门外,他们依然对干式光刻技术寄予厚望不想额外增加成本,而只有当时并不亮眼的ASML接受了浸入式光刻技术。
浸入式光刻的成功开发是台积电与ASML这两家企业的重要转折点。2004年,ASML在台积电的帮助下成功研发出首台浸入式光刻机,并一举拿下了多家大客户的订单。这后来也极大的促进了台积电和ASML的合作发展,为ASML后来超越尼康和佳能埋下了伏笔。随后几年,浸入式光刻占据了先进节点工艺的主导地位,一直持续优化,把工艺节点突破到22nm。
加上后来不断改进的高NA镜头、多光罩、FinFET、Pitch-split、波段灵敏的光刻胶等技术,浸入式193nm光刻机一直做到了芯片的7nm制程(苹果A12和华为麒麟980)。
浸入式光刻的出现无形当中宣判了干式微影光刻技术的死亡,在ASML推出浸入式193nm产品的前后脚,尼康也宣布其157nm产品以及EPL产品样机完成。然而,浸入式属于小改进大效果,产品成熟度非常高,所以几乎没有人去订尼康的新品。随后,尼康也将目光转向浸入式光刻技术,但始终落后一程。
从市场角度出发,作为上世纪九十年代最大的光刻机巨头,尼康的衰落,始于157nm光源干刻法与193nm光源湿刻法的技术之争。也正是这次冒险的****注,ASML彻底摆脱了以往的窘境。与此同时,英特尔倒向ASML使得尼康失去了挑战摩尔定律的勇气。凭借浸入式光刻技术,ASML于2007年以60%的市占率超越尼康,成为光刻市场的领导者。
对157nm来讲,2003年是个铭记于心的年份,5月份英特尔公司突然宣布放弃157nm技术,将继续使用193nm浸入式光刻技术进行65nm及45nm的制程,并继续拓展193nm浸入式光刻技术,使之能够适应更深层次的工艺需求,同时计划采用极紫外光(EUV)来制作22nm以下的制程。
英特尔的此举尤如重量级炸弹一样,因为实则上将157nm技术跳了过去。众所周知,彼时的英特尔是全球光刻设备最大的买主,其任何动作都将在全球半导体业界引起极大反响。而不采购157nm光刻相关设备,则意味着英特尔放弃了这个被称为传统意义上光学极限的光刻技术。
 ITRS 2005路线图实际上已经把157nm光刻技术抛弃(图源:中关村在线)到2010年,193nm液浸式光刻系统已能实现32nm制程产品,并在20nm以下节点发挥重要作用,浸没式光刻技术凭借展现出巨大优势,成为EUV之前能力最强且最成熟的技术。
ITRS 2005路线图实际上已经把157nm光刻技术抛弃(图源:中关村在线)到2010年,193nm液浸式光刻系统已能实现32nm制程产品,并在20nm以下节点发挥重要作用,浸没式光刻技术凭借展现出巨大优势,成为EUV之前能力最强且最成熟的技术。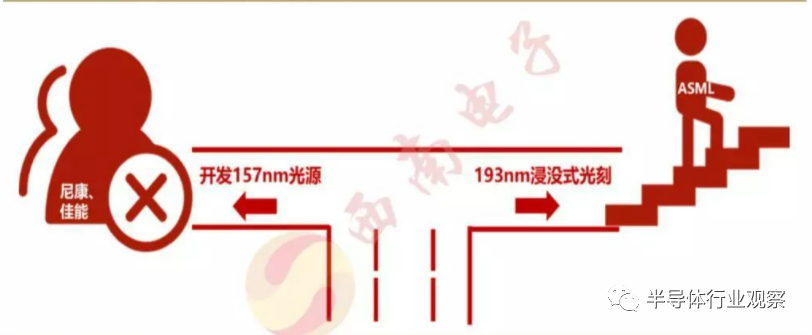 光刻技术分水岭(图源:西南电子)作为ASML遇到的第一个“贵人”。台积电在技术、人才、资金方面给了ASML很大帮助。凭借台积电的“浸入式光刻技术”方案,ASML将光源波长一举从193nm缩短到134nm。此后,ASML开启了快速蚕食光刻机市场的时代。
光刻技术分水岭(图源:西南电子)作为ASML遇到的第一个“贵人”。台积电在技术、人才、资金方面给了ASML很大帮助。凭借台积电的“浸入式光刻技术”方案,ASML将光源波长一举从193nm缩短到134nm。此后,ASML开启了快速蚕食光刻机市场的时代。EUV光刻渐成主流
在业界寻求突破193nm光刻瓶颈时,EUV也是其中一个方向,然而受限于当时的技术水平,这项技术一直没能实现。从1997年成立到2003年解散,EUV LLC联盟集中全产业链之力,推进了EUV光刻技术的研究进程。
在22nm节点之后,DUV已经很难再继续优化了。在研究了1990年代的几种预期技术之后,半导体行业逐渐达成共识,极紫外(EUV)波长的光刻技术是最好的前进之路,成为近年来英特尔、台积电、三星等芯片公司追捧的新宠。
由于157nm波长的光线不能穿透纯净水,无法和浸入技术结合。因此,准分子激光光源只发展到了ArF。通过浸没式光刻和双重光刻等工艺,第四代ArF光刻机最高可以实现22nm制程的芯片生产,但是在摩尔定律的推动下,半导体产业对于芯片制程的需求已经发展到 14nm、10nm,甚至7nm,ArF光刻机已无法满足这一需求,半导体产业将希望寄予第五代EUV光刻机。
 EUV光学系统简图(图源:lithography gets extreme)EUV技术最明显的特点是曝光波长一下子降到13.5nm,用13.5nm波长的EUV取代193nm的DUV光源,在光刻精密图案方面更具优势,能够减少工艺步骤,提升良率,也能大幅提升光刻机的分辨率。
EUV光学系统简图(图源:lithography gets extreme)EUV技术最明显的特点是曝光波长一下子降到13.5nm,用13.5nm波长的EUV取代193nm的DUV光源,在光刻精密图案方面更具优势,能够减少工艺步骤,提升良率,也能大幅提升光刻机的分辨率。但也面临挑战,因为在如此短波长的光源下,几乎所有物质都有很强的吸收性,EUV技术的关键难点在于材料吸收,因为波长太短光子能量很高,基本上大部分材料都会很容易的吸收EUV光源,导致光源到达工作面时光强很弱,所以设计时,材料的选取是非常关键,光刻环境也要要求严格的真空环境。一种新光源光刻机的出现,必定是影响一整条产业链的格局,因为不同光源对掩膜材料,光刻胶材料,光学镜头等都独特的要求。
从市场进展来看,ASML在2006年推出了EUV光刻机的原型,2007年建造了10000平方米的无尘工作室,在2010年造出了第一台研发用样机NXE3100,到了2015年终于造出了可量产的样机,而在这研发过程中,英特尔、三星、台积电这些半导体大厂的也输了不少血。
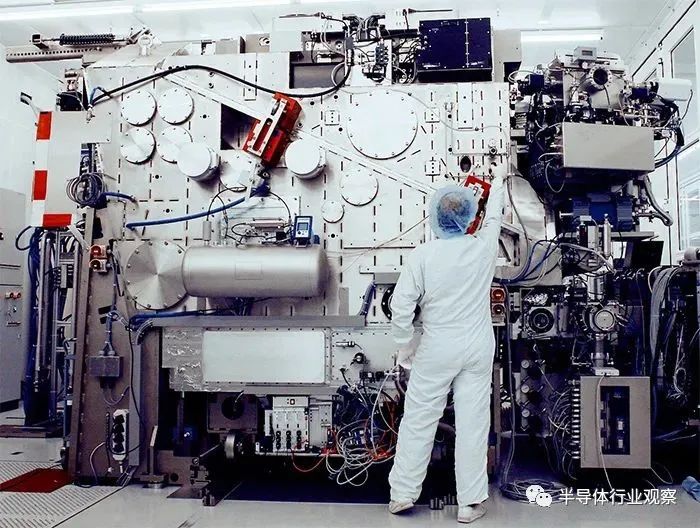 2006年全球首台EUV光刻机原型此后,ASML凭借EUV光刻技术,逐渐成为光刻机市场不可撼动的霸主。2012年,英特尔、台积电、三星等厂商纷纷注资入股ASML,以支持其EUV光刻技术的改进与升级,从而换取优先供货权。
2006年全球首台EUV光刻机原型此后,ASML凭借EUV光刻技术,逐渐成为光刻机市场不可撼动的霸主。2012年,英特尔、台积电、三星等厂商纷纷注资入股ASML,以支持其EUV光刻技术的改进与升级,从而换取优先供货权。2013年之后,为加速EUV技术的发展,ASML不断进行并购整合,陆续收购了光刻光源制造商Cymer、电子束测量工具供应商HMI、荷兰高科技公司Mapper以及Berliner Glas集团等。聚焦EUV光刻领域,ASML于二十余年内投资超60亿欧元,并于2020年实现了EUV光刻机大规模量产。
作为全球唯一一家能EUV光刻机的厂家,ASML自然获得了大量的订单。截至2022年第一季度,ASML已出货136个EUV系统,约7000万个晶圆已曝光。
 ASML EUV系统销量(图源:ASML)光刻技术的过去与未来根据光刻机所用光源改进和工艺创新,光刻机经历了5代产品发展,每次改进和创新都显著提升了光刻机所能实现的最小工艺节点。
ASML EUV系统销量(图源:ASML)光刻技术的过去与未来根据光刻机所用光源改进和工艺创新,光刻机经历了5代产品发展,每次改进和创新都显著提升了光刻机所能实现的最小工艺节点。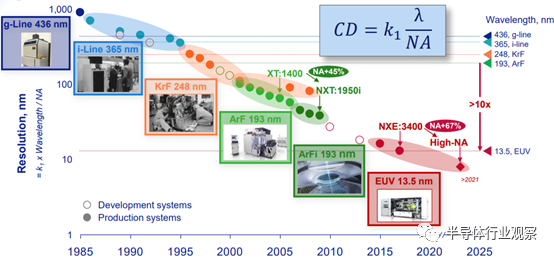 ASML光刻机发展历程(图源:ASML)第一代为接触接近式光刻机,曝光方式为接触接近式,使用光源分别为436nm的g-line和365nm的i-line,接触式光刻机由于掩模与光刻胶直接接触,所以易受污染,掩模版和基片容易受到损伤,掩模版寿命短。
ASML光刻机发展历程(图源:ASML)第一代为接触接近式光刻机,曝光方式为接触接近式,使用光源分别为436nm的g-line和365nm的i-line,接触式光刻机由于掩模与光刻胶直接接触,所以易受污染,掩模版和基片容易受到损伤,掩模版寿命短。第二代为接近式光刻机,使用光源也为436nm的g-line和365nm的i-line,曝光方式为掩模版与半导体基片之间为非紧密接触状态,掩模版不容易受到损伤,掩模版寿命长,但由于掩模版与基片之间有一定间隙,成像质量受到影响,分辨率下降。
第三代为扫描投影式光刻机,利用光学透镜可以聚集衍射光提高成像质量将曝光方式创新为光学投影式光刻,以扫描的方式实现曝光,光源也改进为248nm的KrF激光,实现了跨越式发展,将最小工艺推进至180-130nm。
第四代为步进式扫描投影光刻机,最具代表性的光刻机产品,1986年由ASML首先推出,采用193nm ArF激光光源,实现了光刻过程中,掩模和硅片的同步移动,并且采用了缩小投影镜头,缩小比例达到 5:1,有效提升了掩模的使用效率和曝光精度,将芯片的制程和生产效率提升了一个台阶。
第五代为EUV光刻机,采用波长为13.5nm的激光等离子体光源作为光刻曝光光源。在摩尔定律的推动下,半导体产业对于芯片的需求已经发展到5nm,甚至是3nm,浸入式光刻面临更为严峻的镜头孔径和材料挑战。第五代 EUV光刻机,可将最小工艺节点推进至5nm、3nm。
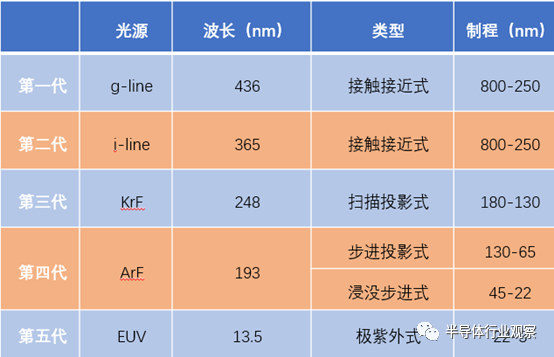 在现有技术条件上,NA数值孔径并不容易提升,目前使用的镜片NA值是0.33。
在现有技术条件上,NA数值孔径并不容易提升,目前使用的镜片NA值是0.33。下一步,据ASML透露,EUV技术将实现0.55数值孔径的EUV光刻机,该项目正在进行中。0.55 NA EUV平台将继续为未来节点实现经济高效的扩展,具有更高数值孔径的新型光学设计,有望使芯片尺寸减小1.7倍,进一步提高分辨率,并将微芯片密度提高近3倍。第一个EUV 0.55 NA平台早期接入系统预计将在2023年投入使用,预计客户将在2024-2025年开始研发,2025-2026年进入客户的大批量生产。
 ASML EUV系统路线图(图源:ASML)在完成第一台0.55 NA光刻机后,预计在光刻机、掩模和光刻胶方面将有进一步的创新,它们将进一步降低K1系数,并使收缩率在下一个十年得以延续。
ASML EUV系统路线图(图源:ASML)在完成第一台0.55 NA光刻机后,预计在光刻机、掩模和光刻胶方面将有进一步的创新,它们将进一步降低K1系数,并使收缩率在下一个十年得以延续。写在最后纵观光刻技术的发展历程,这项最精密复杂、难度最高、价格高昂的技术,在漫长的发展过程中,不断推动着摩尔定律的演进,让全球半导体产业为之前赴后继。然而,高昂的研发成本与巨大的研发难度,让光刻技术一次次走到岔路口。市场角逐,巨头厮杀,无不在摩尔定律的推动下,再迎来一次又一次突破。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。
关键词:
光刻

相关推荐
俄罗斯押注130纳米芯片:本土光刻技术能否弥补技术鸿沟?
EUV光刻技术,想了解的可以下载看看
ASML报告2025年销售额为327亿欧元
IC工艺原理
集成电路的制造
据报道,中国利用较旧的ASML组件制造EUV原型机,Eyes 2028芯片制造
中国研究团队首度揭秘光刻胶在显影液中的微观行为,为提升光刻精度与良率开辟新路径
ASML亮相第八届进博会,展示其全球AI洞察与面向主流芯片市场的全景光刻解决方案
光刻工艺流程
日本开发10纳米印记技术,有望解决极紫外(EUV)瓶颈问题
ASML的魔力揭秘:其EUV优势背后的技术和合作伙伴中国无法复制
成品率驱动的光刻校正技术
美国为其限制向中国出口光刻设备的政策辩护
中国陕西8英寸硅光子学平台正式上线
据中国中小企业在国内推动下赢得1.1亿元人民币光刻工具合同
美国智库指出DUVi存在漏洞,中国正推动利用多模式技术开发先进芯片