3D封装与TSV工艺技术
来源:半导体封装工程师之家



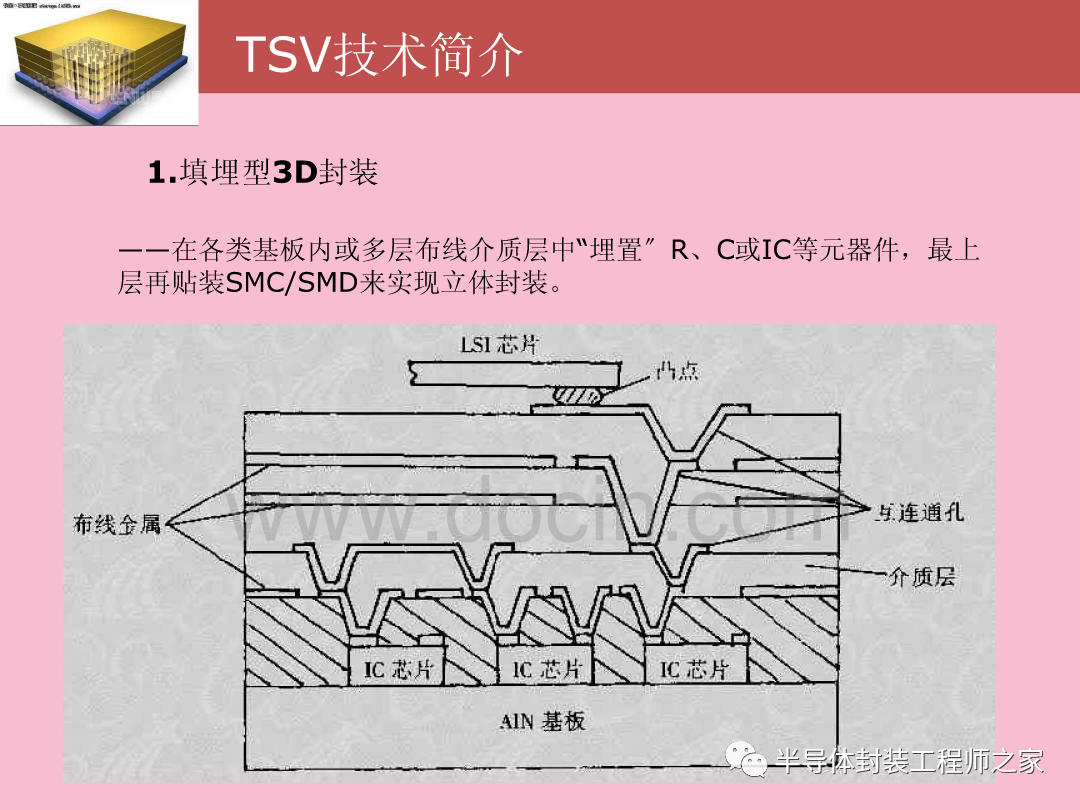

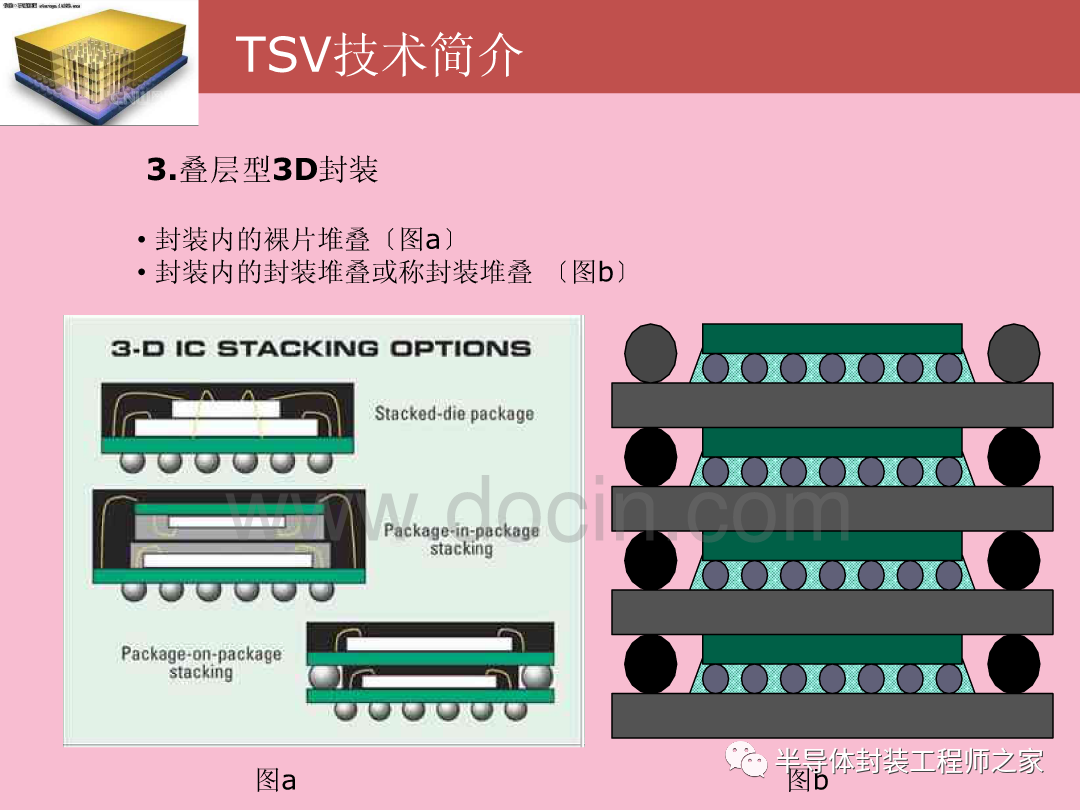

*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。
关键词:
3D封装
来源:半导体封装工程师之家



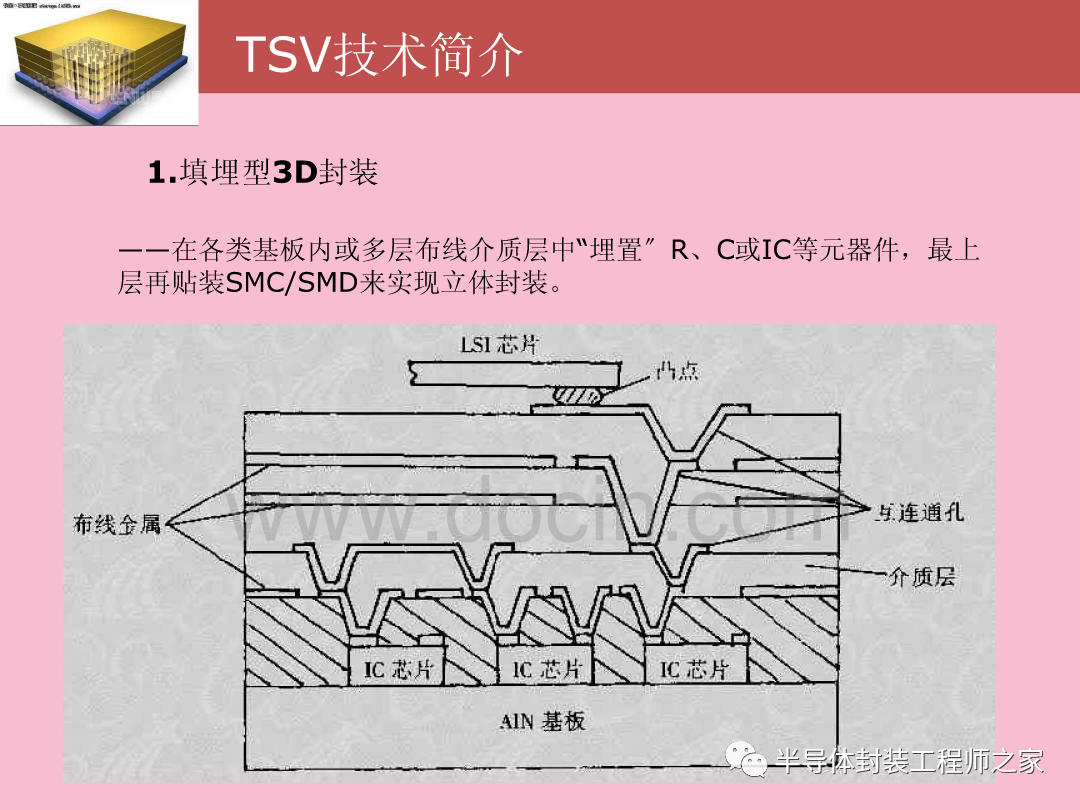

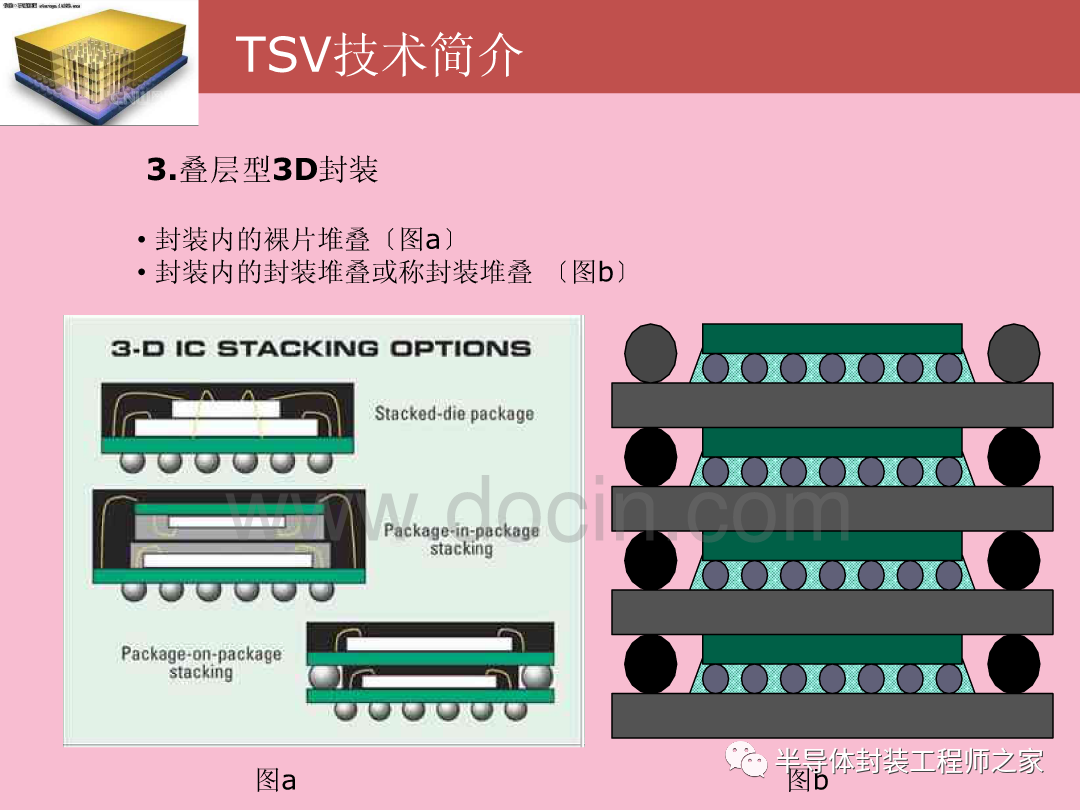

*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。
相关推荐
2.5D/3D 芯片技术将推动半导体封装技术的进步
3D封装技术突破 台积电、英特尔引领代工封测厂
AMD公布3D封装技术:处理器与内存、缓存通过硅穿孔堆叠在一起
台积电完成首颗3D封装,继续领先业界
2.5D和3D封装的差异和应用
电源设计来响应需求更大的功率密度
“乌合麒麟”口中的14+14nm 3D封装技术能成为国产芯片的希望吗?
格芯为何放弃7nm转攻3D封装
博众精工牵头设立2.5D/3D封装关键技术及核心装备创新联合体
3D封装技术及其发展
台积电与美国客户合作开发先进3D封装技术,计划2022年量产
有关Shell-Op的3D封装的pcb的装配指导
nepes采用西门子EDA先进设计流程,扩展3D封装能力