- 自博通(Broadcom)官网获悉,博通公司宣布推出其3.5D eXtreme Dimension系统级(XDSiP)封装平台技术。这是业界首个3.5D F2F封装技术,在单一封装中集成超过6000mm²的硅芯片和多达12个HBM内存堆栈,以满足AI芯片的高效率、低功耗的计算需求。据介绍,博通的3.5D XDSiP平台在互联密度和功率效率方面较F2B方法实现了显著提升。这种创新的F2F堆叠方式直接连接顶层金属层,从而实现了密集可靠的连接,并最小化电气干扰,具有极佳的机械强度。博通的3.5D平台包括用于高效
- 关键字:
博通 3.5D封装 AI芯片
- 据博众半导体官微消息,近日,苏州市科技局正式公布了2024年度苏州市创新联合体名单。其中,由博众精工牵头的“苏州市半导体2.5D/3D封装关键技术及核心装备创新联合体”被纳入指令性立项项目清单。据悉,该创新联合体由博众精工科技股份有限公司作为核心力量,携手苏州大学、哈尔滨工业大学等12家企事业单位共同组建。该联合体聚焦于半导体封装测试领域的核心部件自主研发,旨在通过跨学科、跨领域的协同创新,构建国内领先的半导体2.5D/3D封装设备关键技术平台,为破解国外技术垄断、提升我国高端装备制造业竞争力贡献力量。博
- 关键字:
博众半导体 先进封装 2.5D封装 3D封装
- 半导体芯片封装的重要性、传统和先进技术以及该领域的未来趋势。半导体芯片封装是指半导体器件的保护外壳。该保护壳可保护电路免受腐蚀和物理伤害,同时还便于连接电气连接以将其与印刷电路板 (PCB) 连接。在这里,我们探讨了半导体芯片封装的重要性、传统和先进技术以及该领域的未来趋势。半导体芯片封装:传统技术和先进技术半导体芯片封装的重要性半导体芯片封装是半导体器件生产过程的最后阶段。在此关键时刻,半导体块会覆盖一层保护层,保护集成电路 (IC) 免受潜在的外部危险和时间的腐蚀影响。这种封装本质上充当保护外壳,屏蔽
- 关键字:
2.5D封装 3D封装
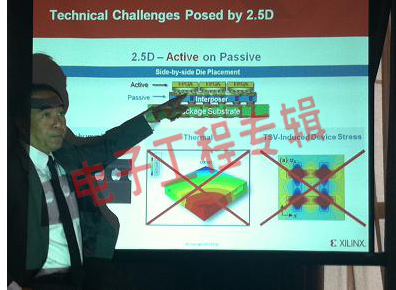
- 68亿只晶体管、1,954,560个逻辑单元(容量相当于市场同类最大28nm FPGA的两倍)、305,400个CLB切片的可配置逻辑块(CLB)、21,550Kb的分布式RAM容量、以及2,160个DSP slice、46,512个BRAM、24个时钟管理模块、4个PCIe模块、36个GTX收发器(每个性能达12.5 Gbps)、24个I/O bank和1,200个用户I/O、19W功耗……是的,您没有看错,这一连串令人眼花缭乱的数字,就是赛灵思(Xilinx)日前宣布可
- 关键字:
赛灵思 FPGA 2.5D封装
2.5d封装介绍
您好,目前还没有人创建词条2.5d封装!
欢迎您创建该词条,阐述对2.5d封装的理解,并与今后在此搜索2.5d封装的朋友们分享。
创建词条
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473