纳米级隧道效应器件
集成电路问世以来,IC技术一直沿着电路和器件特征尺寸按比例缩小的办法大踏步前进,特征尺寸越小,电路和器件的性能越好。正由于此,上世纪末,Intel公司将集成度和性能都达到空前高水平的奔腾4芯片和PC送到用户手上。目前MOSFET的沟道长度已趋近0.1mm(=100nm),按比例缩小的办法还能继续下去吗?答案是否定的。早在20年以前,著名的“半导体器件物理”一书的作者S.M.Sze就预计,传统MOSFET的沟道长度应大于约70nm。IBM研究中心的D.J.F.rank盼望能作出沟道长度达20-30nm的MOSFET,但是沟道再短就很困难了。也就是说20-30nm可能就是器件特征尺寸的物理极限。
本文引用地址:https://www.eepw.com.cn/article/3041.htm为了减小器件特征尺寸,从而达到整体提升器件性能的目的,人们希望找到其它的方法来避开上述困难。在设法抑制短沟道效应的实验中发现,当特征尺寸逼近物理极限时,基于量子隧道效应的隧道效应器件比传统MOSFET好。换言之,双电子层隧道晶体管和共振隧道二极管等隧道效应器件比MOSFET更适合于纳米电子学。
这是由美国Sandia国家实验室J.Simmons等人首先研究的隧道效应器件。它由一个绝缘势垒和两个二维量子阱组成,绝缘势垒位于两个量子阱之间。为使器件正常工作,量子阱和势垒厚度都很小,分别为15nm和12.5nm。由于势阱厚度很小,势阱可看成是二维的,电子运动被限制在阱平面内。Sandia的研究者们把Deltt和MOSFET作类比,称上量子阱接触(Top quantum well contact)为源(电极)。下量阱接触(Bottom quantum well contact)为漏(电极)。器件工作时,由于量子力学隧道效应,电子从上量子阱(Top quantum well)隧道穿过势垒层到达下量子阱(Bottom quantum well)。
Deltt的结构如图1所示。和MOSFET相比,上量子阱相当于源区,下量子阱相当于漏区,势垒区(Barrier)相当于沟道,上控制栅(Top control gate)相当于MOSFET的栅极;和上控制栅相对应,还有背控制栅(Back control gate),这个栅通常不是必备的(optional)。从图1可以看到,源漏电极都是平面型的。为了保证源电极只和上量子阱接触,漏电极只和下量子阱接触,Deltt还有背耗尽栅(Back depletion gate)和上耗尽栅(Top detletion gate)。
由量子力学理论可知:量子阱中的电子能级由阱的尺寸和势垒高度决定,当阱的尺寸很小时,电子能级间隔很大;当由势垒隔开的两个量子阱中的电子能级相同(对准)时,产生电子由一个阱到另一个阱的量子隧穿效应,因为在量子隧穿过程中,电子要遵守能量守恒和动量守恒原理。一般来讲,在未加外电压(包括源-漏电压和栅压)时,两个量子阱中没有相同的电子能级,因而没有源——漏电流,器件是截止的。加上外电压时,势阱中电子能级会发生位移,电压增大位移增大,当两个势阱中的电子能级对准时(共振),隧道效应发生,器件导通。
Deltt的工作有类似MOSFET的一面:在某个源——漏电压下,可由栅压开关器件。但也有显著不同的另一面:当栅压再上升,超过共振点时,电子隧穿过程中止,器件关闭。也就是说,Deltt微分电阻可正可负,在器件从导通态到截止态的工作区微分电阻为正,从导通态到截止态的工作区,微分电阻为负。
微分电阻可正可负的器件的主要优点是,可用较少数量的器件完成相当的功能。如用两个Deltt串联可组成CMOS电路中需要n型和p型两种MOSFET的静态随机存储器单元。
双电子层晶体管用InP或GaAs等半导体平面工艺制造,例如用分子束外延(MBE)技术或金属有机化合物汽相淀积(MOCVD)技术生长厚度合适的窄禁带半导体薄层制得量子阱区,在其上再生长宽禁带半导体层得到势垒层。由于MOCVD和MBE技术生长的薄层厚度可控制在几个纳米以内,量子阱和势垒的厚度都可控制在几个纳米内。Deltt的势垒厚度相当于MOSFET的“沟道”长度,电子渡越这种“沟道”靠的是比漂移运动快得多的量子隧道运动,因而Deltt的速度性能应比MOSFET好。而Deltt事实上不存在MOSFET那样的沟道,所以不会出现短沟道效应。
限制Deltt速度性能进一步提高的是它的RC时间常数。很薄的势垒其电阻R可以做得很小,但两个量子阱靠得很近,电容C很大。为了改进速度性能j.Simmons领导的研究小组在下量子阱后又增加了第三个量子阱。第三阱非常厚,电子隧穿过第一个势垒从上量子阱到下量子阱后,继续隧穿过第二个势垒到第三阱,在第三阱中被较大的电势梯度加速。增加了第三个量子阱,不但改善了Deltt的速度性能,而且使Deltt的工作电压从豪安量级提高到伏量级,使其能与现有电子器件和电路相匹配。
现在Deltt的工作温度较低(0℃),人们努力的目标是室温工作。制作Deltt的材料是Ⅲ-V族化合物半导体,最合适的是InAlAs/InGaAs材料系。
共振隧道二极管是由势垒和量子阱组成的二端器件,所用材料大都为Ⅲ-V化合物半导体异质结材料。麻省理工学院R.H.Mathews等人设计的RTD如图2所示,量子阱为窄禁带半导体InGaAs,势垒为宽禁带半导体AlAs。由于量子阱尺寸只有几纳米,量子阱中电子能级间隔很大,一般RTD的工作只和一个电子能级有关。图中用细线画出了被势垒层AlAs隔开的左右两个InGaAs势阱中的电子能级。从上至下的三个分图分别表示:随着源——漏电压Vsd的增加,左边势阱中的能级逐渐升高,由低于右边势阱中的能级(上图)到等于右边势阱中的能级(中图),到高于右边势阱中的能级(下图)。源——漏电流isd也随着Vsd的升高发生变化,先是增大,当左、右势阱中能级对准(共振)时,Isd达到最大。通过共振点后,由于两个势阱中电子能级再次偏离,隧穿几率减少,Isd下降,所以和Deltt类似,RTD的微分电阻也可正可负,利用这一特性,可用两个背靠背连接的RTD和一个晶体管构成静态RAM单元,既节省芯片面积,又降低功耗。
RTD的高速性能是很突出的,比当前最快的高电子迁移率晶体管(HEMT)还快,其振荡频率已做到700GHZ。人们利用RTD和HEMT组成RTD/HEMT电路,这种电路和HEMT相比,完成同样的功能,元件数和芯片面积都下降了。例如RTD/HEMT比较器电路和HEMT比较器电路相比,元件数减少5/6,芯片面积减少3/4。
至今,和Beltt一样,大多数RTD是用Ⅲ-V族化合物半导体,如GaAs和InP工艺制造的,主要用于军事、国防领域,但也有人研发了类似的硅基共振隧道二极管——硅共振带间隧道二极管(RITD)。将硅RITD和CMOS晶体管技术相结合,可改进电路速度性能和减少电路管脚数。例如RITD/CMOS数字转换器电路和CMOS数字转换器电路相比,尺寸减少2/3,速度提高一倍,功耗大大降低(动态功耗降低到1/5.8,静态功耗降低到1/2.3)。
致力开发和研究与CMOS电路相容的RTD制造工艺的Seabaugh认为,在逼近IC技术物理极限的今天,只在CMOS电路制造工艺基础上增加一块掩膜的硅基RTD工艺,给CMOS电路的设计提供了新的柔性和活力。■
参改文献
1 S.M.Sze.physics of Semiconductor devices. Nd,Newyork Wiley1981
2 L.Geppert.guantum tuanwistors: toward nanoelectronics. IEEE Spectrum.Vol.37(2000).NO.9:46~49
漏电开关相关文章:漏电开关原理









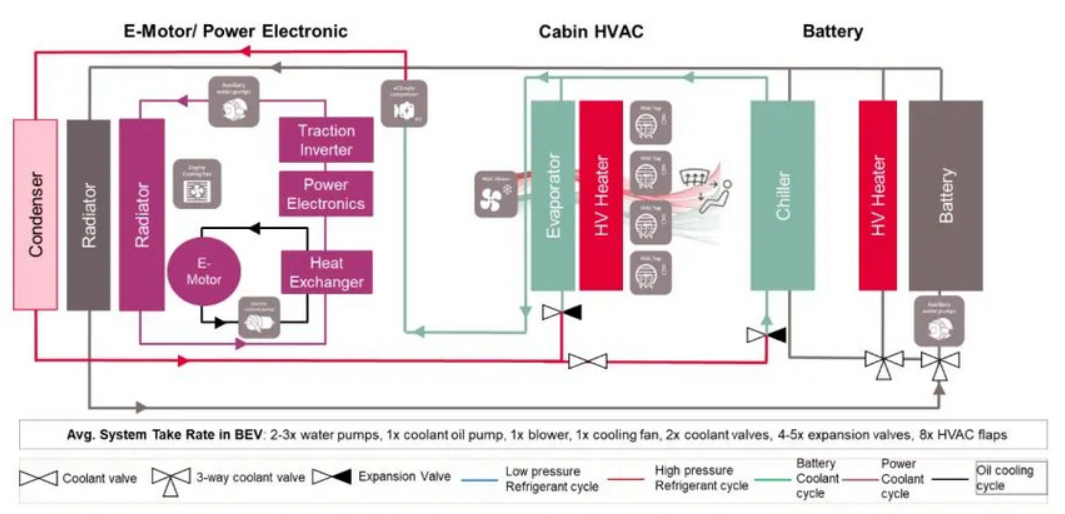
评论