采用紧凑式SIP的QFN封装
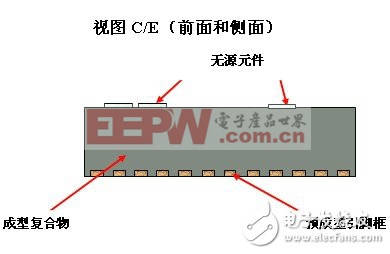
图 6 “采用紧凑式 SIP 的 QFN 封装”的不同视图【视图C/E(前面和侧面)】
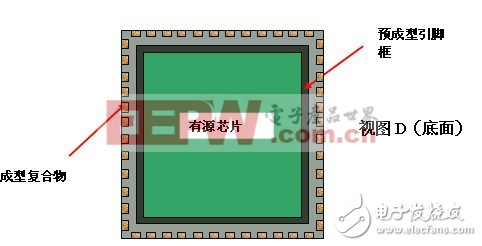
图 7 “采用紧凑式 SIP 的 QFN 封装”的不同视图【视图D(底面)】
优点:
封装设计理念
在 QFN 中集成 SIP 是全新的封装理念,具有紧凑、集成度高的特点(可集成更多的无源元件和芯片)。此设计可在内部集成具有不同功能的有源元件和无源元件,降低成本和缩短上市时间,成为最受青睐的封装技术之一。此外,该封装设计可更换不同的无源元件或芯片,从而实现不同的 BOM 组合,有助于封装产品的升级。
产品性能和应用
与传统的需要采用印刷电路板的 SIP 封装相比。“采用紧凑式 SIP 的 QFN 封装”设计采用了堆叠概念,可使芯片 I/O 接线、无源元件、有源芯片等的距离达到最小。此设计可直接改善开关频率、信号,且有助于改善产品性能/效率。例如:DrMOS 应用 à 无源元件应尽可能地靠近 HS 芯片的漏极和 LS 芯片的源极,如此才能实现更高的 DC/DC 转换器效率。
突破封装/产品的灵活性和可扩展性的限制
当前市场中的 SIP :在成型封装中固定和封装的无源元件、功能性芯片和 CSP 产品 à 灵活性差,在集成厚度较大的元件时需要采用新封装尺寸。对于“采用紧凑式 SIP 的 QFN 封装”设计而言:可采用多种厚度的芯片、CSP 产品、无源元件及其他功能芯片,不受限于总封装厚度。可根据客户应用或需求,以“拾取放置”(pick place) 方式更换无源元件、CSP 产品及其他功能芯片。由于采用暴露元件/“开放式”封装理念,对于芯片、CSP 产品、无源元件或其他功能芯片无严格厚度限制。开发工作量少,上市时间短,封装灵活性高。
工艺简化
由于采用的是倒装芯片设计,封装时无需采用焊线和成型工艺。总体而言,这将极大地简化整体工艺。
可靠性高
由于采用了预成型引脚框,且其为“开放式”,因此无需担心成型复合物和无源元件/硅芯片表面之间的 CTE (热膨胀系数)不匹配问题。无源元件和引脚框之间的间隙极小,不存在封装气孔的问题。无源元件与引脚框之间(如 I/O 区域)的细小间隙通常会导致形成微小气孔。在压力测试过程中,孔内的空气可能会导致“爆米花”效应。
热性能增强
对于高发热量芯片应用,可在有源芯片的背面涂覆额外的高性能导热膏,从而增强热性能。热量传导路径为:有源芯片 à 高性能导热膏 à 印刷电路板
以下说明“采用紧凑式 SIP 的 QFN







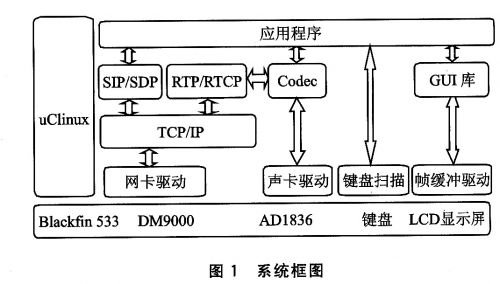

评论