3D-IC将如何改变芯片设计
专家在座:半导体工程与西门子 EDA 产品管理高级总监 John Ferguson 坐下来讨论 3D-IC 设计挑战以及堆叠芯片对 EDA 工具和方法的影响;Mick Posner,Cadence 计算解决方案事业部 IP 解决方案小芯片高级产品组总监;莫维卢斯的莫·费萨尔;是德科技新机会业务经理 Chris Mueth 和新思科技 3D-IC 编译器平台产品管理高级总监 Amlendu Shekhar Choubey。本讨论的第 1 部分在这里,第 2 部分在这里。

从左到右:是德科技的 Mueth;Synopsys 的 Choubey;西门子的弗格森;莫维卢斯的费萨尔;Cadence 的 Posner。
Posner:我们倾向于关注所有新的挑战,但堆叠多芯片也将影响传统挑战,例如简单验证。如果您有两个十字线大小的模具堆叠在一起,则需要验证它们是否相互配合。如果是 3.5D,具有水平和垂直堆叠、仿真、验证以及所有传统的仿真和软件开发,那么整个挑战就会成倍困难。这推动了工具的变化。现在仅仅做一个 SoC 就是一个巨大的挑战。现在,我们有多个 SoC 相互通信。数字孪生是解决这个问题的一种方法,但最终需要验证您的 RTL 和系统,因此一切都需要扩展。
Mueth:是的,如果你有 10 个相互依赖关系,现在你必须处理 100 个。
波斯纳:但传统的挑战也存在。
Choubey:而且它们正在增长。现在我们必须处理异构集成。当您关闭计时时,角的数量将爆炸。你是如何做到的?如果你想在异构堆叠芯片中所有可能的角上进行时序收敛,这是不会发生的。这在当今的计算中是不可能的。你必须弄清楚如何减少问题,这样你才不会失去任何东西,而且你需要在合理的时间内完成。所有这些都即将到来。我们已经研究这些问题有一段时间了,我们认为我们在提取、多芯片系统的时序收敛和封装验证方面取得了很大进展。您不仅仅是在验证独立模具。你也在验证它们之间的交互。
SE:跨越界限的部件越多,你在性能和功率方面损失的就越多。我们可以通过垂直而不是水平堆叠在 SoC 上来缩短互连并将所有东西靠得更近。但当你这样做时,你就会做出权衡。因此,鉴于每个人都在寻求在相同或更低的功率下实现性能的数量级改进,将所有这些东西添加到一个包中会受到惩罚吗?
Faisal:将为这些云用户带来最多资金的最大和最具挑战性的工作负载是芯片设计工作负载,尤其是人工智能驱动的芯片设计。像谷歌这样的公司突然想与芯片设计人员合作,因为这是最大、最复杂的工作负载,他们想要这项业务。我参加了一个会议,其中五大人工智能芯片公司之一向所有人提供免费的 EDA 工具,以便他们可以获得运行云的工作负载。这些价值万亿美元的公司可能会介入并抓住 EDA 工作负载,并打破不同步骤之间的所有障碍和交接。
Choubey:筒仓是主要挑战。即使他们要采用多芯片系统,传统规则仍然存在。曾经做数字设计的人正在做模具,或者有时他们正在做堆叠。然后他们把它交给曾经做过先进封装部分的人。这些税收仍然存在,因为你仍然在你的筒仓里,你做某事并将其交给其他人。我们需要打破这些孤岛。我们不能将其视为将不同设计元素集成到一个系统中,而应将其视为一种系统设计。您从系统定义开始,并且想要设计该系统。你尽早划分你的平面图,并决定你真正想做什么。然后,在那个地方,您可以设计所有芯片和互连,以便您可以完全了解系统。那么,每当你交出设计时,你就不需要缴纳这些税。这是一个在单个数据库上运行的平台,将所有内容保存在一个地方,并利用该单一数据库和平台来确保您不会有跨越边界的孤岛,并且每次这样做时都会为性能和功耗支付税。这对于获得我们想要的好处非常重要。
SE:这适用于多个供应商吗?
弗格森:这就是标准的用武之地,这是一个挑战。标准可能是解决方案,但我们在这方面仍然落后于这一点。我们有一些我们需要的东西,但还不够。
SE:现在我们有基本的连接标准,对吧?
Mueth:是的,这会有所帮助。但让我们以集成高性能电子和数字系统为例。您的射频模拟/混合信号人员设计了一个芯片,它在他的脑海中效果很好。数字人员设计了一个芯片,它在他的脑海中效果很好。然后你把它们集成在一起,突然间你遇到了影响这些芯片的噪声问题——串扰、数字门由于接地层中的噪声而处于错误的状态。这是一个集成问题。你必须在系统层面处理这个问题,你需要一个可以完成所有这些工作的平台。你永远不会有一个可以完成所有事情的平台,但你必须有足够的能力来分析手头的问题。
Choubey:如果你正在做射频设计,而我正在做其中的数字部分,那么每次你进行更改时,我都需要看到影响。我不想要求提供最新版本,然后翻译它并导出数据,以便我了解影响。如果每次我运行分析时数据都在那里,那么我就拥有了完整的数据设计集,我可以看到一切的影响。这缩短了上市时间并最大限度地减少了不确定性。
Mueth:它位于芯片外部而不是模型内部,但它将您想要捕获的、您感兴趣的区域嵌入到模型中。你不能对所有事情都做一个 ROM(降阶模型)。但是,让我们说 10 件对您来说很重要的事情。你构建该芯片的 ROM,然后在系统级别对其进行模拟。所以现在你处于某种程度的抽象,但至少你正在尝试考虑对你来说重要的领域。
SE:好的,现在你有了这个多供应商的模具系列。谁负责确保所有部分协同工作?
波斯纳:这又回到了标准化。你听到很多关于标准化的讨论,但如果你与代工厂交谈,他们并没有谈论这个。他们想要一个封闭的生态系统,因为他们将包装视为一种差异化。他们希望增加价值以让您留在他们的频道中。如果你看 2.5D 水平,就会发现封装技术没有收敛。每个人都有一个中介层。它们彼此不兼容。2D 有机基材尽可能接近,但供应商不支持这一点。你在那里独自一人。这就是它进入业务方面的地方。如果你需要性能,你将做出这些权衡。但并不是每个人都会吞下进入 3D 所需的大药丸。
Mueth:他们担心,如果他们拥有太多开放的生态系统,那么可能会有人使用整个流程。因此,人们自然而然地倾向于建造砖墙。
Ferguson:客户不希望他们的小芯片的细节或他们设计的任何组件暴露给第三方。因此,出于这个原因,您必须对其进行混淆。
Posner:这也给小芯片市场带来了挑战。你不能只是创建一个骰子,'哦,是的,你可以把这个堆叠起来。它在任何地方都有效。
Choubey:总会有某种定制。当您将小芯片放入系统中时,根据它在该系统和该分区中的位置,要求会有所不同。它需要为其他东西提供电力吗?什么是热剖面?任何人都可以使用的硬小芯片是不可能的。它必须是一个软小芯片,并且根据它去向,您必须能够对其进行定制。如果您将问题限制在通用的硬小芯片上,那么您将无法从中获得最佳性能。你限制太多了。多芯片的想法是,您可以利用很多东西,然后为您想要的东西提供最佳解决方案。如果你把它放在一个盒子里,然后说,'不,你不能在这里做任何改变',那么你就失去了自由度。
SE:这成为人工智能的另一种问题,对吧,因为它可能开辟了太多的可能性。
弗格森:是的,而且情况更糟,因为人工智能不止一个。
Faisal:在未来的某个时候,云人员可能会发生颠覆,因为他们非常专注于开源一切。那么,有没有一个世界,EDA 行业和芯片设计会采用这种做法,即使秘密武器没有打开,但很多东西都是开放的?人们正在构建完全垂直的解决方案,从 IP 到软件等等。但客户实际上不喜欢这样,因为有时他们想将这些数据用于提供给他们之外的其他用途。因此,“给我完全垂直的解决方案”与同时,“保持数据流开放,这样我就可以用它做其他事情,并为额外的优化开辟机会”之间存在冲突。
SE:我们正在寻找有史以来使用 3D-IC 创建的性能和功耗方面的最佳解决方案,但目前似乎没有人能够完全实现这一目标。
费萨尔:这是洗碗机的问题。任何人都可以洗碗,但安装洗碗机时需要专家来调试。您想要完全垂直的解决方案,即洗碗机,但如果它坏了,没有人知道如何修复它。
SE:那么您对全 3D-IC 是乐观还是悲观?
Posner:目前,逻辑上逻辑或逻辑上存储器的所有专业知识都是在内部构建的。是否会有扩展 3D 的流程?众所周知,从原型的数量来看,代工厂已经打开了 3D 堆叠设计的大门。他们希望达到可以说'3D 堆叠技术已为您准备好'的地步。客户表示他们愿意制作原型。我认为没有人说过有前期制作流程,或者他们还没有进入制作阶段。大门又开了一点。但它很贵。你必须是精英才能参加这个游戏。
弗格森:我们都同意我们必须进入这个领域。我们致力于。我们别无选择。
Choubey:如果你看看未来三年真正高性能的计算和 AI 工作负载,你会看到大多数设计至少开始尝试堆叠。在该特定领域,3D 堆叠将成为未来三四年的常态。



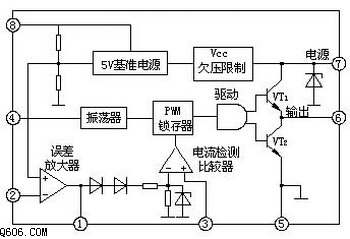







评论