功率MOSFET抗SEB能力的二维数值模拟
由图3c,d可见,当出现二次击穿时,漂移区载流子浓度达到1017cm-3,漂移区电场大幅降低,导致Uc很低。如果在衬底与外延层间加一浓度低于此值而高于耐压层的过渡层即缓冲层,缓冲层的耗尽会改变电场分布,缓冲层选择合理,就会使漂移区电场在达到二次击穿时具有较高值,从而改善二次击穿特性,亦即改善抗SEB能力,这就是缓冲层技术的思想。
3.2 单缓冲层技术
对不同单缓冲层浓度下器件的静态击穿特性进行了仿真,仿真结果如图4所示。本文引用地址:https://www.eepw.com.cn/article/177788.htm
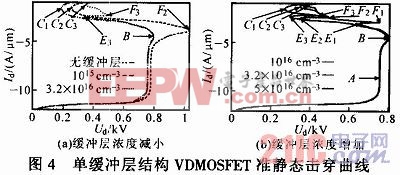
(1)与无缓冲层结构相比,单缓冲层MOSFET的击穿特性曲线多了2个拐点E和F,E点对应n漂移区/n缓冲层高低结击穿电场达到最大,该点称为二次击穿点;之后缓冲层耗尽层扩展,直至n漂移区/n缓冲层界面附近过剩载流子浓度达到缓冲层背景掺杂浓度,这就是F点。
(2)随着缓冲层厚度增加,E,F点间距增大;反之亦然。当缓冲层厚度小到一定程度,E,F点重合。E,F两点重合,可作为厚度优化的一个参考。
(3)随着缓冲层浓度减小,E点向B点移动。当缓冲层浓度低到一定程度,E点与B点重合,F点表观取代B点,此时漂移区过剩载流子浓度达到缓冲层背景掺杂浓度,由于缓冲层浓度高于外延层浓度,从而使负阻转折临界电流IB提高,从3.47x10-5A/μm提高到1.37x10-4A/μm。
(4)随着缓冲层浓度增加,E点向电压负方向移动,C点向电压正方向移动。当缓冲层浓度增加到一定值,E点电位低于C点电位。E点的击穿成为限制器件抗SEB能力的限制因素。因此,对于单缓冲层结构,存在一个最佳缓冲层浓度,由E,C两点电压相等获得。若考虑厚度优化(导通电阻优化),则由C,E,F 3点重合得到一个仿真厚度。
3.3 多缓冲层技术
采用缓冲层结构,可改善电场分布,提高器件抗SEB能力。但对单缓冲层结构,优化缓冲层掺杂浓度,或使IB提高,或使Uc达到最佳,无法使两者同时得到改善,有必要采用多缓冲层结构。利用低掺杂浓度缓冲层提高IB,利用高浓度缓冲层提高Uc,这就是多缓冲层技术的思想。
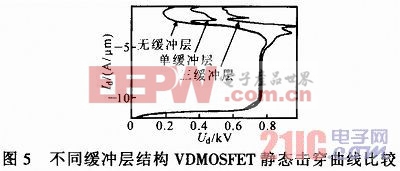
参考单缓冲层浓度优化思想,对三缓冲层结构进行了仿真,结果如图5所示。无缓冲层时,IB=3.47×10-5A/μm,Uc=186 V;单缓冲层时,IB=3.47×10-5 A/μm,Uc=355 V;三缓冲层时,IB=1.03×10-3A/μm,Uc=536 V。可见,与无缓冲层和单缓冲层相比,三缓冲层的IB和Uc均得到了很大改善。
4 结论
缓冲层结构可改善器件抗SEB能力:低掺杂浓度缓冲层有利于提高负阻转折临界电流,高浓度缓冲层更利于提高二次击穿电压。高、低浓度缓冲层结构相结合,可使器件负阻转折临界电流和二次击穿电压均得到改善。根据这一构想,给出一种三缓冲层结构,通过优化掺杂浓度和厚度,使器件抗SEB效应的综合能力提高。仿真结果显示,采用三缓冲层结构,二次击穿电压近似为无缓冲层结构的3倍,负阻转折临界电流提高近30倍。
电磁炉相关文章:电磁炉原理














评论