SOC中多片嵌入式SRAM的DFT实现方法
若测试覆盖率较低,首先应分析DRC(design rule constraint)Violations,并尽量消除DRCViolations。再分析AU(ATPG untestable)报告,减少AU的数量。按照模块层次来报告测试覆盖率时,应找到覆盖率低的模块重点分析。该项目的AU报告中和RAM有关的部分占了很大一部分。RAM自测试模块的测试覆盖率只有6%。分析工具把RAM当做black box,由于这些SRAM的数据位很宽,故SRAM数据端口不可控和不可测的逻辑(称为阴影逻辑)更多,芯片的测试覆盖率也更低。给RAM加旁路(bypass)逻辑,测试模式下将输入和输出连起来,可使原来不可控和不可观测的逻辑变化反映到扫描链上,使之变得间接可控和可观测,从而提高整个芯片的测试覆盖率。RAM的输入比输出多,故可用XOR连接。对于XOR/XNOR门,为了将故障响应从它的一个输入传播到它的输出,可根据方便程度设置所有其他的输入为0或1。而对于AND/NAND门,为了将系统的故障响应从它的一个输入传播到它的输出,则必须通过将其他输入设置为l来实现,其中“l”对于AND/NAND门是一个非控制值。同理,“0”对于OR/NOR门也是一个非控制值。图4所示是旁路RAM的电路示意图。图中,多路选择器由test_mode信号控制,与RAM的输入输出连接的逻辑可测,RAM模块的测试覆盖率可提高到98.3%,相应的整个芯片的测试覆盖率提高了4个百分点。本文引用地址:https://www.eepw.com.cn/article/151464.htm
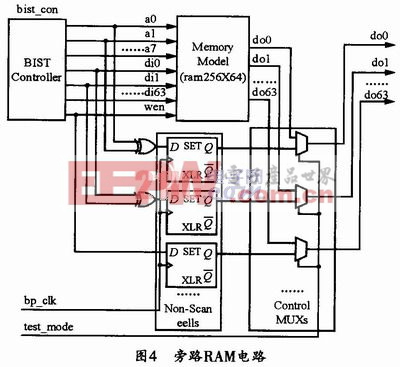
由此可见,MBIST结构可直接实例化地用在数字设计部分。该系统的功能逻辑部分含有万余寄存器,为了提高测试覆盖率添,加几个寄存器及很少组合逻辑作为测试点后,即可将测试覆盖率提高且不会增加太大的面积开销,因而这种方法是很有效率的。如果前期设计时就能考虑这种测试结构,DFT设计过程中就会减少反复,减少测试设计周期。
5 结束语
本文基于一个实际项目,分别用常用的并行与串行两种方式来实现MBIST的构架,并对其开销进行了定量与定性讨论,结果是对于不同的设计,应当灵活构建测试结构以达到设计目的。对于在嵌入式存储器数量较少,位宽较小的情况下,MBIST对扫描测试覆盖率的影响并不明显,易被人们忽视,一旦这种影响显著发生,比较高效的方法是插入旁路电路,这样,在提高覆盖率的同时也不会增加太大的面积开销。可见,对于一个嵌入多片SRAM的SOC进行DFT设计时。应从多维度灵活处理,折中考虑。





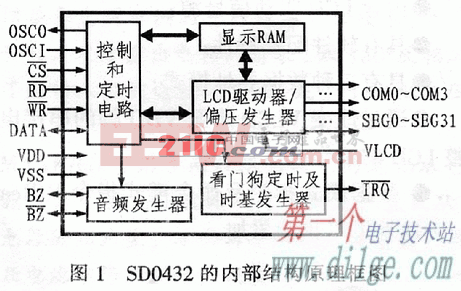
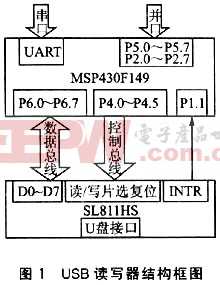
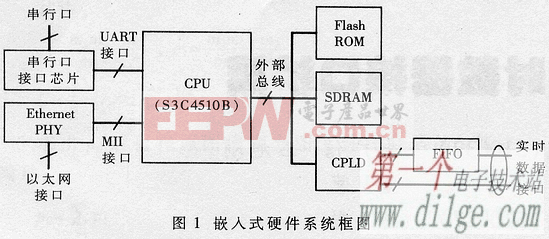
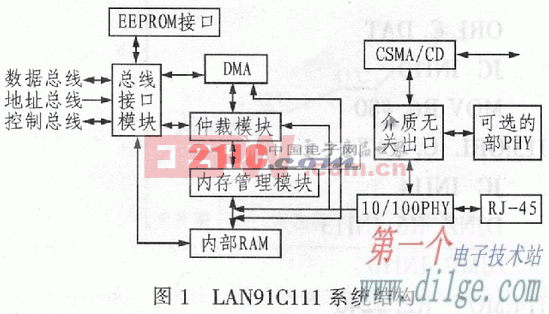

评论