华为日前公布了一项新专利,展示了一种《反射镜、光刻装置及其控制方法》, 专利申请号为CN202110524685.X,据介绍,这种方法便能够解决相干光因形成固定的干涉图样而无法匀光的问题,在极紫外光的光刻装置基础上进行了优化,进而达到匀光的目的。

该专利提供一种光刻装置,该光刻装置通过不断改变相干光形成的干涉图样,使得照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。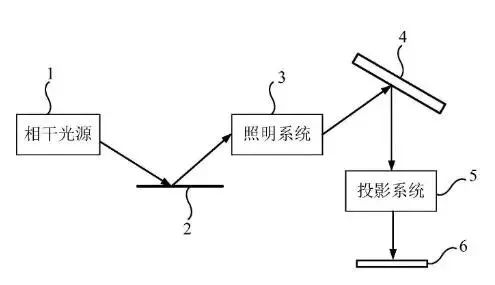
该光刻装置包括相干光源 1、反射镜 2 ( 也可以称为去相干镜 ) 、照明系统 3。其中,反射镜 2 可以进行旋转;例如,可以在光刻装置中设置旋转装置,反射镜 2 能够在旋转装置的带动下发生旋转。在该光刻装置中,相干光源 1 发出的光线经旋转的反射镜 2 的反射后,通过照明系统 3 分割为多个子光束并投射至掩膜版 4 上,以进行光刻。在光刻装置中,上述照明系统 3 作为重要组成部分,其主要作用是提供高均匀性照明 ( 匀光 ) 、控制曝光剂量和实现离轴照明等,以提高光刻分辨率和增大焦深。照明系统 3 的匀光功能可以是通过科勒照明结构实现的。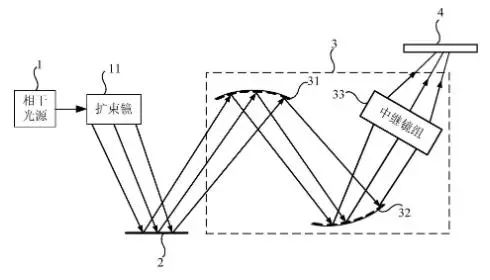
该照明系统 3 包括视场复眼镜 31 ( field flyeye mirror,FFM ) 、光阑复眼镜 32 ( diaphragm flyeye mirror,PFM ) 、中继镜组 33;其中,中继镜组 33 通常可以包括两个或者两个以上的中继镜。照明系统 3 通过视场复眼镜 31 将来自相干光源 1 的光束分割成多个子光束,每个子光束再经光阑复眼镜 32 进行照射方向和视场形状的调整,并通过中继镜组 33 进行视场大小和 / 或形状调整后,投射到掩膜版 4 的照明区域。通过在相干光源 1 与照明系统 3 之间的光路上设置反射镜 2,在此情况下,相干光源 1 发出的光线经旋转的反射镜 2 反射后相位不断发生变化,这样一来,在经反射镜 2 反射后的光线通过照明系统 3 分割为多个子光束并投射至掩膜版 4 上时,形成在掩膜版 4 的照明区域的干涉图样不断变化,从而使得照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。值得注意的是,光刻机作为半导体制造过程中最核心的设备,同时也是研发难度最高的设备。就目前光刻机市场来看,高端的EUV光刻机设备也只有荷兰ASML能生产,这个重达数吨的设备中涉及了超过10万零部件,需要的工种繁多,毫不客气地说,ASML所生产的EUV光刻机是集结了全球先进的产业链,将诸多零部件进行整合,最终集成一台EUV光刻机设备。因此大可不必鼓吹“华为申请了光刻机装置专利,意味着攻克了EUV光刻机技术”。来源:EDN 电子技术设计
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。
存储器相关文章:存储器原理