局部应变技术可望提高FDSOI性能
法国研究机构CEA-Leti宣布开发出可为全耗尽型绝缘体上覆矽(FDSOI)矽通道制程诱导局部应变的2种新技术,可望用于实现更快速、低功耗与高性能的下一代FDSOI电路。
本文引用地址:https://www.eepw.com.cn/article/284533.htm意法半导体(STMicroelectronics;ST)和Globalfoundries倡议为先进晶片中采用FDSOI,并视其为能够达到世界级能效的方法,而且不必面对像FinFET制程的复杂性与高成本。
晶格上的应变通常用于增加传统平面CMOS与FinFET CMOS的行动性。如今,Leti则提议将它用在下一代的FDSOI电路上,以实现同样的好处;使其得以在相同的功耗下实现更高性能。
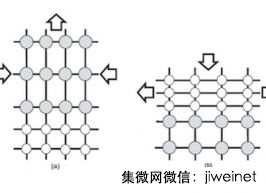
无论是FinFET或FDSOI制程都十分重要,因为在FDSOI中的 p-通道FET需要矽锗(SiGe)通道材料的压缩应变,同时也需要拉伸应变来改善矽晶n-通道 FET。Leti分为为两种制程开发新技术,使其能在MOSFET通道中诱导高达1.6GPa的局部应变。
LETI表示,由于28nm FDSOI并不一定需要应变,这两项技术主要瞄准的是22/20nm节点。第一种技术利用从SOI薄膜顶上的松散SiGe转移应变。这可用于提高短通道电迁移率达到20%以上。
第二技种技术取决于高温退火下的埋层氧化物潜变至插入覆晶中的拉伸应变。Leti指出,这种潜变也可以用于导入压缩应变。
这种应变通道可增加CMOS电晶体的导通电流,以及在相同功率时实现更高的性能,或在一定性能时降低功耗。




评论