富士通:超级计算机能否使用基于TSV的三维IC?
半导体的微细化(也就是摩尔定律)的发展前景笼上了阴云,微细化以外的技术(新摩尔定律)则备受期待。新摩尔定律的一项技术是使用TSV(硅通孔)的三维封装IC。基于TSV的三维封装能否用于超级计算机的处理器IC?前不久的一场演讲就是讨论这个问题的。
本文引用地址:https://www.eepw.com.cn/article/282889.htm这场演讲发表于“ANSYS Electronics Simulation Expo”(2015年10月23日在东京举办)。演讲人是富士通先进系统开发本部处理器开发统括部 第二开发部的汾阳弘慎(如图)。
汾阳研究了PI(电源完整性)分析和热分析能否用于基于TSV的三维IC的开发,并发布了研究结果。他在研究中使用了美国ANSYS公司的3种分析软件,分别是RedHawk-GPS、ANSYS RedHawk和ANSYS Sentinel-TI。
这项研究有四个目的:(1)在布局设计和逻辑设计之前,能否对电源网络进行PI分析;(2)使用软件是否真的能够分析三维IC;(3)能否构建三维IC的PI和热分析流程;(4)超级计算机用处理器能否做成三维IC。
针 对第一个目的“在布局设计和逻辑设计之前,能否对电源网络进行PI分析”,研究中使用了RedHawk-GPS。即便在没有布局设计数据的状态下,只要使 用该软件,就能通过GUI或脚本定义电力区域。使用定义好的电力区域信息,可以在开发初期进行PI分析。汾阳研究的对象是使用1块面朝上的芯片和TSV的 安装模型(图1)。
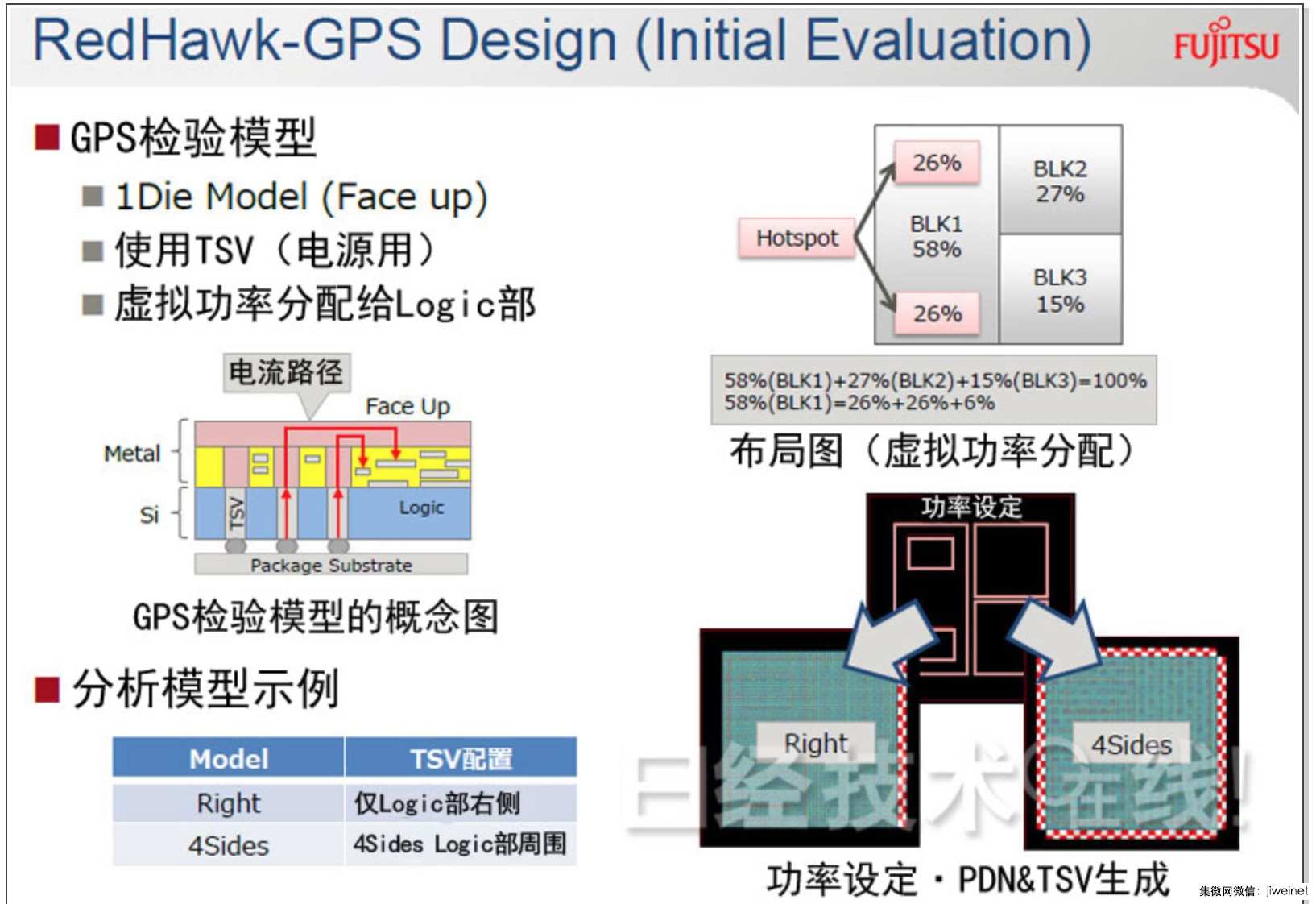
图1:RedHawk-GPS的评价使用的安装模型。图片来自富士通的幻灯片资料,下同。

图2:RedHawk-GPS的运行结果的一个例子。TSV的位置不同,会改变IR压降。
对于TSV只位于一边和TSV位于四边这两种封装进行分析的结果显示,与前者相比,后者的IR压降小85%(图2)。而且,在改变TSV的数量和间隔时,IR压降也会出现差别。这表明,通过使用RedHawk-GPS在开发初期进行PI分析,可以掌握IR压降的趋势。
PI和热能否利用工具进行分析
针对第二个目的“使用软件是否真的能够分析三维IC”,具体研究的是使用RedHawk和Sentinel-TI能否分析三维IC。首先以两层逻辑IC芯片叠加而成的三维IC为模型,使用RedHawk实施PI分析(图3)。分析使用的是现有芯片的布局数据。

图3:RedHawk与Sentinel-TI的评价使用的安装模型。

图4:使用RedHawk的静态IR压降分析结果。
具体分析了4边设置TSV的设计(基准案例),在此基础上进行改进的设计(案例1)和进一步改进的设计(案例2)这三个案例。结果显示,静态IR压降与动态IR压降,均按照基准案例→案例1→案例2的顺序得到了改善(图4)。
Sentinel- TI使用上面案例2的设计进行了测评,成功分析了上端芯片和下端芯片的温度分布(图5)。而且发现,TSV和微焊点在从三维模型改为线性模型后,分析结果 的温度基本不变,而处理速度提高到了3.5倍。汾阳表示,这些情况“证明了使用RedHawk和Sentinel-TI可以分析三维IC”。

图5:使用Sentinel-TI的热分析结果。
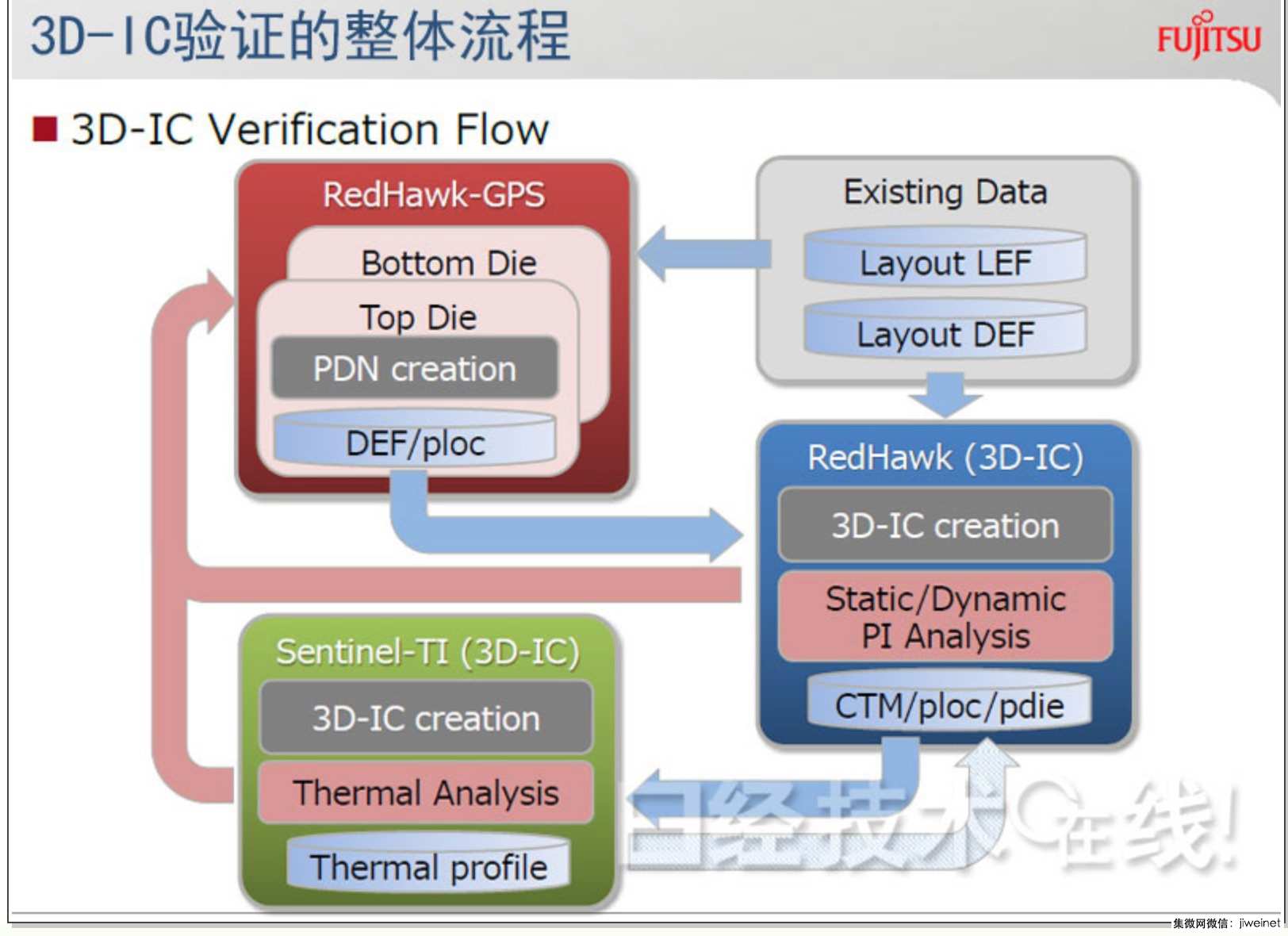
图6:基于TSV的三维安装IC的分析流程。
最令人关注的是成本
另外,根据截至目前的研究,对于“能否构建三维IC的PI和热分析流程”这个问题,汾阳表示:“已经构建出能在开发初期以较短的TAT(周转时间)完成PI和热分析的循环流动,并进行了验证”(图6)。
而且,对于“超级计算机用处理器能否做成三维IC”这一点,汾阳说:“研究结果证实,使用两块逻辑芯片叠加制作的超级计算机用高性能处理器IC,能够实现高精度分析。”不过汾阳也表示,在投入实用之前,还需要对电源网络的结构进行改进。
演讲结束后,笔者向汾阳询问了个人比较关心的TSV封装的制造成本问题。得到的回答是:“与PoP(Pacakge-on-Package)封装相比,估计成本是其2~3倍。”由此可见,与分析相比,成本可能才是基于TSV的三维封装的课题。






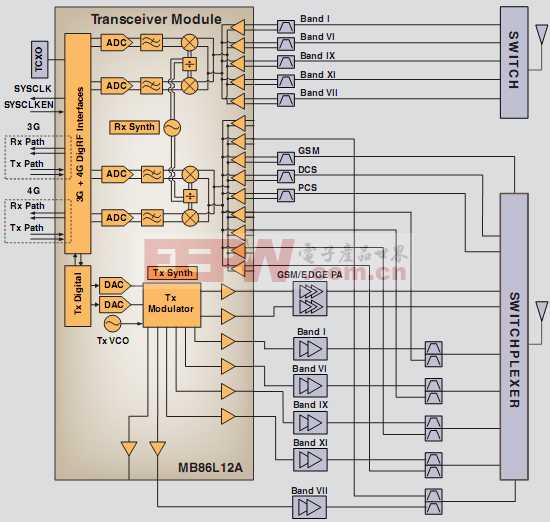




评论