EVG集团为工程衬底和电源器件生产应用推出室温共价键合技术
EVG集团,微机电系统(MEMS)、纳米技术和半导体市场上领先的晶圆键合和光刻设备供应商,今天宣布推出EVG®580 ComBond® - 一款高真空应用的晶圆键合系统,使得室温下的导电和无氧化共价键合成为可能。这一全新的系统以模块化平台为基础,可以支持大批量制造(HVM)的要求,非常适合不同衬底材料的键合工艺,从而使得高性能器件和新应用的出现成为可能,包括:
本文引用地址:https://www.eepw.com.cn/article/265929.htm· 多结太阳能电池
· 硅光子学
· 高真空MEMS封装
· 电源器件
· 化合物半导体以及其他用于“后CMOS”应用的先进工程衬底,比如高电子迁移率晶体管、高性能/低功耗逻辑和射频(RF)器件
多套 EVG580 ComBond 系统已经成功付运到器件厂商和研发中心那里。EVG公司奥地利圣弗洛里安总部将提供客户展示服务。如需下载产品数据表,请访问网址: http://www.evgroup.com/118694/118810/142472/EVG580_ComBond_ShortBrochure.pdf
法国研究机构CEA-Leti硅技术部门副总裁Fabrice Geiger表示:“在最近的安装和验收测试阶段,我们全新的EVG580 ComBond系统在室温下展示了卓越的共价键合能力。CEA-Leti实验室正在寻求与EVG在公共实验室内的合作,在几个关键领域内部署EVG580 ComBond系统,推动研发活动的进展。”
EVG集团执行技术总监Paul Lindner 表示:“EVG580 ComBond系统掌握了室温下无污染、无氧化键合所需要的关键表面预处理步骤。凭借这项突破性的技术,我们几乎可以将任何材料键合在一起——开创出多种不同材料在晶圆形式下的组合。这不仅支持了我们客户的研发力量,而且为大规模生产引入了全新的设备,使得各种快速发展的新兴应用成为可能 – 从下一代电信技术硅光子学的发展到更为先进的电源器件(在两次充电之间,可以使得电动车行驶更远的距离),等等。(这使得我们的客户新器件从研发阶段到大批量生产成为了可能,新器件指的是各种新兴的、快速发展的应用——从下一代电信技术硅光子学的发展到更为先进的电源器件,更先进的电源器件可以使电动汽车在充电间隔间跑的更远。)”
化合物半导体和键合的挑战
将不同性能的材料键合在一起,用以生产电子器件,例如硅衬底同氮化镓(GaN)、砷化镓(GaAs)和磷化铟(InP)等III-V化合物半导体材料的融合,可以产生更高的载流子迁移率进而提高器件性能,并且开拓出全新的功能,比如支持光纤互连和路由器功能的晶硅透光发射技术。然而,通过传统的外延生长工艺融合这些材料时,由于晶格常数和热膨胀系数(CTE)之间的差异,将会导致晶体的位错缺陷,反而会降低性能。
EVG集团推出室温共价键合机
晶圆键合的优势
在优化后的生长衬底上让各个半导体材料单独生长,之后再通过晶圆键合将他们融合在一起,可以减缓这些制造问题。值得一提的是,室温共价键合,将是一种理想的选择,因为这一工艺无需退火处理,退火过程产生的高温将增加热膨胀系数差异引发的额外应力。但是,室温共价键合的一个关键局限因素在于这一工艺无法保持对接合界面层厚度和均匀性的严格限制,包括有效去除颗粒污染物和原生氧化层(为了键合材料之间的键合界面同时保有足够的键合强度和导电性,这一点至关重要)。EVG580 ComBond系统则克服了限制因素。
EVG580 ComBond系统主要特色
· 专用的 ComBond激活模块(CAM)无缝集成到这一平台中,不同于湿法化学蚀刻工艺,它通过引导带电粒子附着在衬底表面之上,提供先进的表面处理工艺,从而实现无污染、无氧化的键合界面
· 可在高真空工艺环境运行,从而防止加工后的晶片在进入融合阶段之间出现再氧化。
· 最多可配置5个并行键合腔,同时满足研发和HVM 应用需求
· 加工的晶圆尺寸可达8英寸(200毫米)



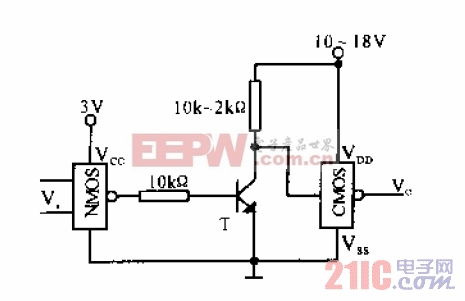
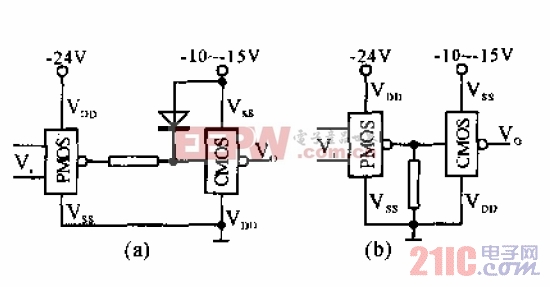





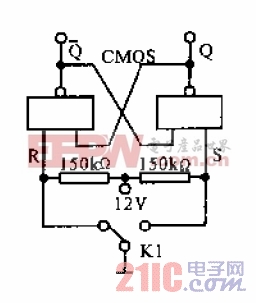

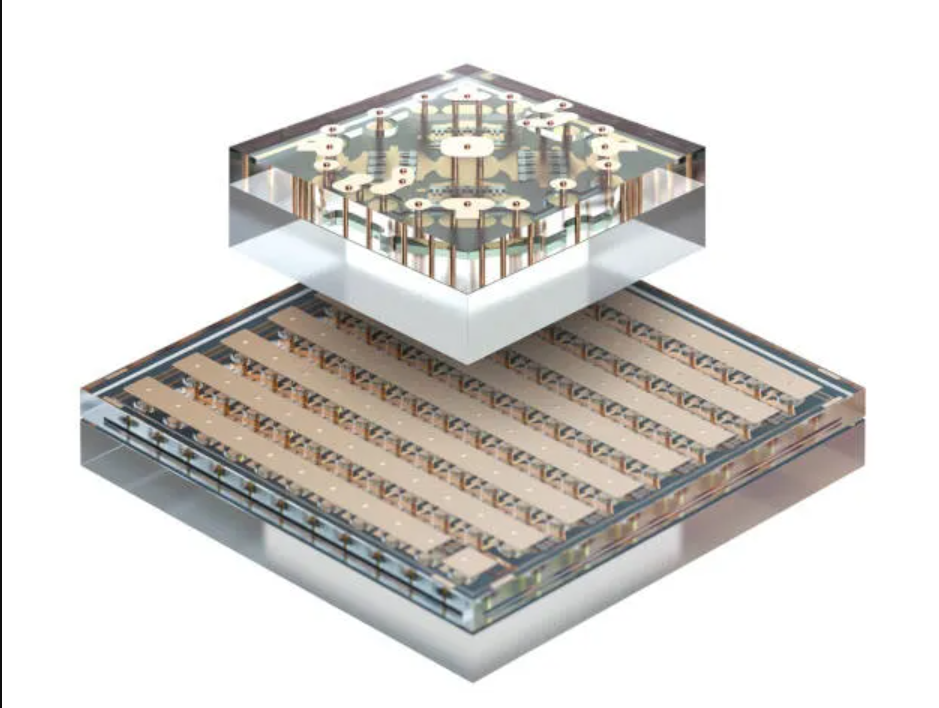

评论