DIP/BGA/SMD等常见芯片封装类型汇总,你了解几个?
QFP(方型扁平式)封装
本文引用地址:http://www.eepw.com.cn/article/201811/394764.htm该技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。

QFP封装
特点:
1.适用于SMD表面安装技术在PCB电路板上安装布线。
2.适合高频使用。
3.操作方便,可靠性高。
4.芯片面积与封装面积之间的比值较小。
QFN封装类型
QFN是一种无引线四方扁平封装,是具有外设终端垫以及一个用于机械和热量完整性暴露的芯片垫的无铅封装。
该封装可为正方形或长方形。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度 比QFP 低。

QFN封装
特点:
1.表面贴装封装,无引脚设计。
2.无引脚焊盘设计占有更小的PCB面积。
3.组件非常薄(<1mm),可满足对空间有严格要求的应用。
4.非常低的阻抗、自感,可满足高速或者微波的应用。
5.具有优异的热性能,主要是因为底部有大面积散热焊盘。
6.重量轻,适合便携式应用。
QFN封装的小外形特点,可用于笔记本电脑、数码相机、个人数字助理(PDA)、移动电话和MP3等便携式消费电子产品。从市场的角度而言,QFN封装越来越多地受到用户的关注,考虑到成本、体积各方面的因素,QFN封装将会是未来几年的一个增长点,发展前景极为乐观。
LCC封装
LCC封装的形式是为了针对无针脚芯片封装设计的,这种封装采用贴片式封装,它的引脚在芯片边缘地步向内弯曲,紧贴芯片,减小了安装体积。但是这种芯片的缺点是使用时调试和焊接都非常麻烦,一般设计时都不直接焊接到印制线路板上,而是使用PGA封装的结构的引脚转换座焊接到印制线路板上,再将LCC封装的芯片安装到引脚转换座的LCC结构形式的安装槽中,这样的芯片就可随时拆卸,便于调试。
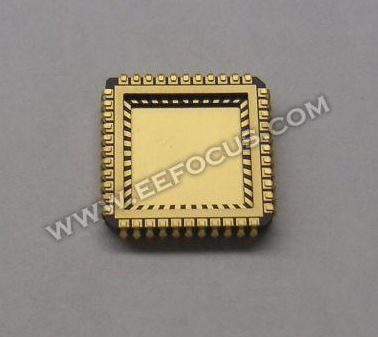
LCC封装
COB封装
COB封装全称板上芯片封装,是为了解决LED散热问题的一种技术。相比直插式和SMT其特点是节约空间、简化封装作业,具有高效的热管理方式。
COB封装是将裸芯片用导电或非导电胶粘附在互连基板上,然后进行引线键合实现其电气连接。如果裸芯片直接暴露在空气中,易受污染或人为损坏,影响或破坏芯片功能,于是就用胶把芯片和键合引线包封起来。
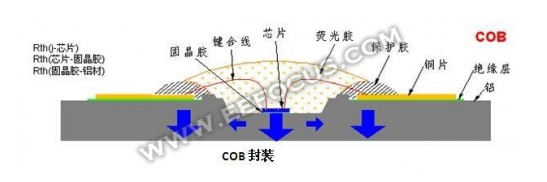
SO类型封装
SO类型封装包含有:SOP(小外形封装)、TOSP(薄小外形封装)、SSOP (缩小型SOP)、VSOP(甚小外形封装)、SOIC(小外形集成电路封装)等类似于QFP形式的封装,只是只有两边有管脚的芯片封装形式,该类型的封装是表面贴装型封装之一,引脚从封装两侧引出呈“ L” 字形。
该类型的封装的典型特点就是在封装芯片的周围做出很多引脚,封装操作方便,可靠性比较高,是目前的主流封装方式之一,目前比较常见的是应用于一些存储器类型的IC。

SOP封装
SIP封装
SIP封装是将多种功能芯片,包括处理器、存储器等功能芯片集成在一个封装内,从而实现一个基本完整的功能。与SOC相对应。不同的是系统级封装是采用不同芯片进行并排或叠加的封装方式,而SOC则是高度集成的芯片产品。从封装发展的角度来看,SIP是SOC封装实现的基础。
SiP的应用非常广泛,主要包括:无线通讯、汽车电子、医疗电子、计算机、军用电子等。

SIP封装
3D封装
3D晶圆级封装,包括CIS发射器、MEMS封装、标准器件封装。是指在不改变封装体尺寸的前提下,在同一个封装体内于垂直方向叠放两个以上芯片的封装技术,它起源于快闪存储器(NOR/NAND)及SDRAM的叠层封装。
3D封装主要特点包括:多功能、高效能;大容量高密度,单位体积上的功能及应用成倍提升以及低成本。
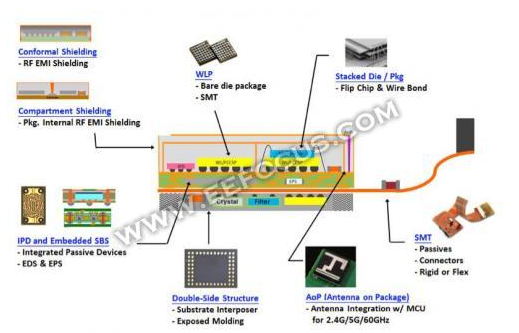
3D封装
分类:
一:封装趋势是叠层封(PoP);低产率芯片似乎倾向于PoP。
二:多芯片封装(MCP)方法,而高密度和高性能的芯片则倾向于MCP。
三:以系统级封装(SiP)技术为主,其中逻辑器件和存储器件都以各自的工艺制造,然后在一个SiP封装内结合在一起。
目前的大多数闪存都采用多芯片封装(MCP,Multichip Package),这种封装,通常把ROM和RAM封装在一块儿。多芯封装(MCP)技术是在高密度多层互连基板上,采用微焊接、封装工艺将构成电子电路的各种微型元器件(裸芯片及片式元器件)组装起来,形成高密度、高性能、高可靠性的微电子产品(包括组件、部件、子系统、系统)。
以上就是常见封装类型的汇总情况,大家对于芯片封装是否有了进一步的了解?是否还有需要补充的常见封装类型? 欢迎大家留言讨论。







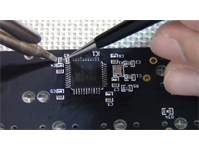





评论