高密度先进封装(HDAP)急需从设计到封装的一体化利器
作者 王莹
本文引用地址:https://www.eepw.com.cn/article/201707/362285.htmHDAP的挑战
有人认为摩尔定律在IC制程上已接近极限,但如果在封装上继续创新,例如利用叠层芯片封装,摩尔定律还可以继续走下去。因此,扩张式的摩尔定律会在封装上实现,包括手机、通信、智能设备(诸如无人机等)、自动驾驶汽车、安全(security)、网络、硬盘存储器、服务器等,都将受益于HDAP(高密度先进封装)的创新。
传统封装在基板上有引脚,现在基板上的引脚数量越来越多,诞生了各种新型封装,诸如TSMC的扇出晶圆级封装(FOWLP),interposer-based(基于中间层的) 封装(也称2.5D封装),chip-on-wafer-on-substrate(CoWoS),高引脚数的倒装,SiP(系统封装,也称3D封装)。这些新型封装技术把过去单一的die(裸片)进行连接,采用多die或多球方式,同时放进一个封装中。例如可把海力士的4个存储器和高通的逻辑芯片堆叠在一起。
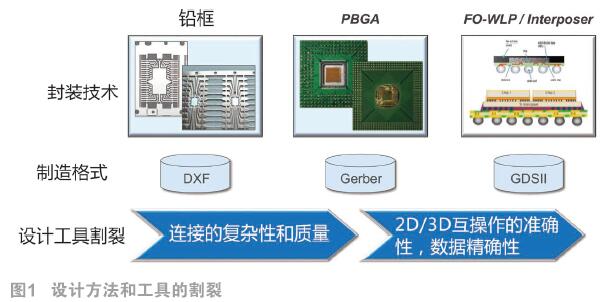
这种封装的创新也带来了技术上的巨大挑战。例如使传统的格点式的PBDA发生变化,诸如有些处理器公司在做不对称的点。另外也需要知道引脚在有限面积是否放得下。另外,Bumping(凸块)、 micro bumping(微凸块)的间距越来越近,例如bumping的最细间距已到2微米X2微米数量级,如何把如此多的凸块放在如此高的密度上,并通过验证,是一大挑战。再有,如果采用横向接interposer,细通孔如何对齐?再例如,通常最简单的是lead frame(铅框)方式,可直接接出去,通过2D软件(例如AutoCAD DXF);到了PCB阶段,排球用Gerber设计工具;到了wafer(晶圆片)级,使用GDSII(如图1)。但是Gerber和GDSII有所区别,例如Gerber只有绕线信息,GDSII有很多管理信息;Gerber有曲线、45°交互线,而GDSII只有0°和90°正交线等,因此为了流程进到生产环节,需要验证工具,以检查是否有bug(错误)。最后,设计的重要性也大为提高,过去设计失败是一个die的失败,现在由于是叠层,将是多个die同时失效。
美国市场分析公司Techsearch International的总裁Jan Vardaman预计 ,FOWLP在 2015 年至 2020 年内的增长率将达到惊人的 82%。但是FOWLP 会干扰传统的设计和制造供应链。与其他高密度先进封装技术一样,它将推动对设备与封装协同设计以及新流程的需求。
与此同时,IC 设计和封装设计领域的融合也愈发明显。例如目前从事HDAP的企业主要有两大阵营:1.从晶圆厂切入,例如TSMC(台积电);2.封测厂。以上这些就为现有的传统设计方法带来了挑战,迫切需要更为高效的全新流程、方法和设计工具。
为此,Siemens 业务部门Mentor不久前推出了一款适用于HDAP的独特端到端解决方案,满足FOWLP等高密度先进封装技术。
Mentor用Xpedition工具与OSAT联盟迎战HDAP时代
Mentor Xpedition的HDAP 流程是业内率先针对当今先进的 IC 封装设计和验证的综合解决方案。独特的Xpedition Substrate Integrator(xSI)工具可快速实现异构基底封装组件的样机制作。针对物理封装实施的新型 Xpedition Package Design(xPD)技术可确保设计 Signoff 与验证的数据同步。Integrated Mentor HyperLynx技术提供了 2.5D/3D 仿真模型和设计规则检查 (DRC),可在流片之前精确地识别和解决设计错误。Calibre 3DSTACK 技术可针对各种 2.5D 和 3D 叠层芯片组件进行完整的 Signoff 验证。
另外,为了简化HDAP设计和制造,Mentor还宣布推出 Mentor OSAT(外包装配和测试)联盟计划,帮助推动生态系统功能,以支持新型HDAP技术,如针对客户集成电路 (IC) 设计的 2.5D IC、3D IC 和FOWLP。由于这些技术要求芯片与封装具有更紧密的协同设计,推出此项计划后,Mentor 将与 OSAT 合作为无晶圆厂(fabless)公司提供设计套件、认证工具和最佳实践方案,帮助新型封装解决方案更顺利的应用于实际芯片。封测公司Amkor已成为首个 OSAT 联盟成员。
据悉,Mentor在HDAP方面已深耕多年。据Mentor亚太区PCB资深业务发展总监孙自君先生介绍,过去Mentor已有Xpedition和改进版的Xpedition Package Integrator(XPI),设计和验证的集成度很高。但实际上,即使在同一家公司,也需要在不同职务间交互,而并非一人就能全部完成。因此此次Mentor把XPI分拆成两个工具—xSI(Xpedition Substrate Integrator)和 xPD(Xpedition Package Designer),前者偏前端设计,后者偏后端验证。
本文来源于《电子产品世界》2017年第8期第81页,欢迎您写论文时引用,并注明出处。









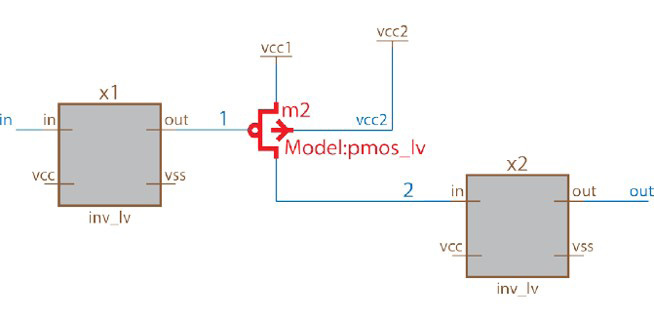
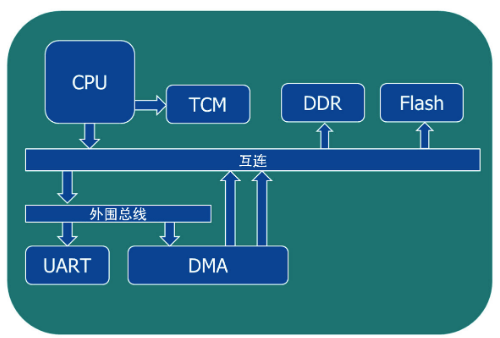

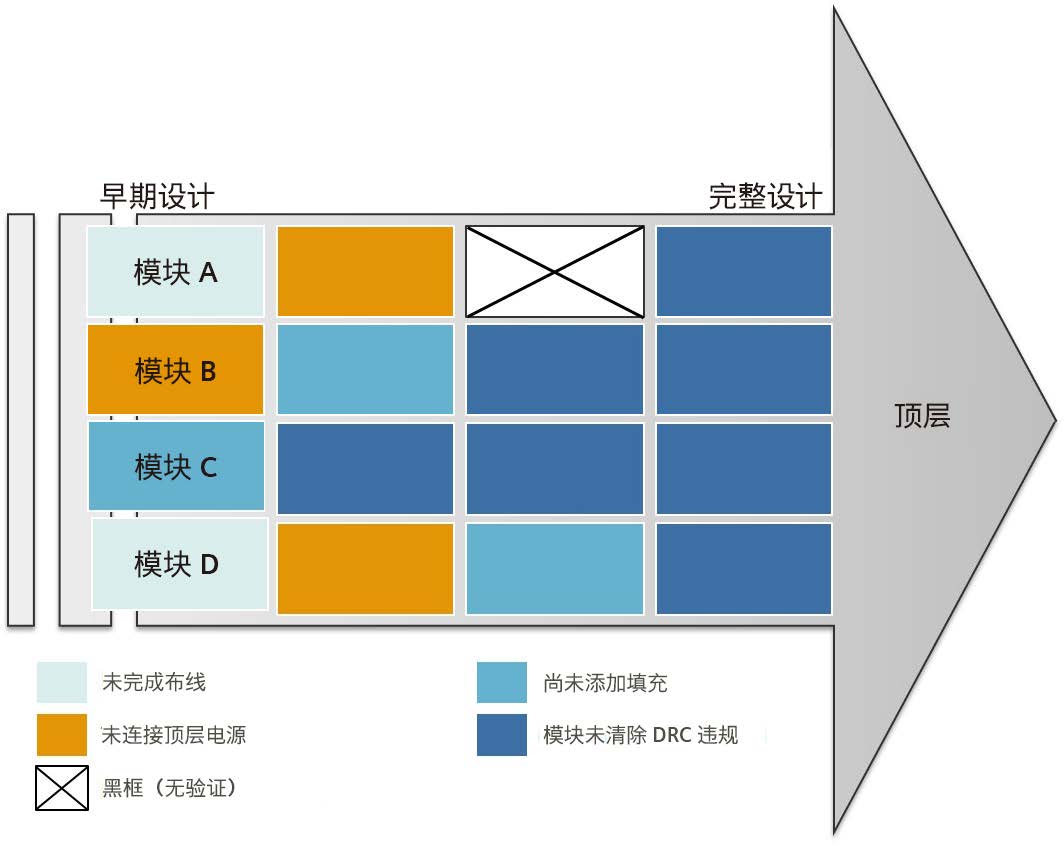



评论